摘要
通过晶体离子切片(crystal ion slicing)在硅衬底上制备的单晶钽酸锂(LiTaO₃)薄膜固有地存在注入缺陷和残余热应力,这严重限制了其器件性能。本研究采用闪光灯退火(FLA),能量密度范围为 10–50 J/cm²,对转移后的 LiTaO₃ 薄膜进行修复。通过带道分析的卢瑟福背散射谱(Rutherford backscattering spectrometry, RBS)显示,FLA 处理后 Ta 位移原子明显减少。X 射线衍射(XRD)结果表明卫星峰消失、主布拉格峰变窄,证实了应变松弛和晶体质量的改善。拉曼光谱显示 Li─O 和 Ta─O 振动模式增强,与晶体质量提升一致。LiTaO₃ 薄膜在 FLA 能量密度为 40 J/cm² 时恢复效果最佳,这是薄膜在不破裂情况下可承受的最大能量水平。这些结果表明,毫秒级 FLA 是一种快速且与晶圆兼容的方法,可消除 LiTaO₃ 薄膜中的残余缺陷和应力,为传统炉退火提供了有前景的替代方案。这一策略同样可扩展至其他异质集成薄膜体系,以提升其结构和功能性能。划重点--销售晶圆和加工SOI晶圆:--220nm薄膜/ 3um厚膜-3umSIO2-675um
ALOOI晶圆;--氧化铝薄膜晶圆,键合工艺和镀膜工艺
TAOOI晶圆--氧化钽薄膜晶圆,镀膜工艺
SINOI晶圆--超低损耗氮化硅薄膜晶圆,210nm-300nm-400nm-800nm
SICOI晶圆;新型量子光学平台500nm-700nm-1um
8寸LTOI晶圆批量供应;铌酸锂的有力的竞争对手,薄膜钽酸锂晶300600
6寸X切Z切掺镁薄膜铌酸锂晶圆 ,厚膜 3um 5um 和 薄膜 100-600nm
8寸LNOI晶圆;8寸LNOI助力更大规模薄膜铌酸锂产品量产
LN/LT-SOI/Si/SIN W2W&D2W异质集成
流片: 6寸 氮化硅 铌酸锂 硅光 超高性价比流片, 1个BLOCK的价格买一整片晶圆
划重点--全国产-超高性价比-6 寸硅光-氮化硅-铌酸锂流片白皮书
我们为客户提供晶圆(硅晶圆,玻璃晶圆,SOI晶圆,GaAs,蓝宝石,碳化硅(导电,非绝缘),Ga2O3,金刚石,GaN(外延片/衬底)),镀膜(PVD,cvd,Ald,PLD)和材料(Au Cu Ag Pt Al Cr Ti Ni Sio2 Tio2 Ti3O5,Ta2O5,ZrO2,TiN,ALN,ZnO,HfO2。。更多材料),键合(石英石英键合,蓝宝石蓝宝石键合)光刻,高精度掩模版,外延,掺杂,电子束光刻等产品及加工服务(请找小编领取我们晶圆标品库存列表,为您的科学实验加速。
请联系小编免费获取原文
 1 | 引言
1 | 引言
单晶钽酸锂(LiTaO₃,LT)是一种功能材料,具有优异的压电、热释电和非线性光学特性 [1]。在绝缘衬底上的 LT 薄膜(LTOI)已广泛应用于高性能声学器件、红外探测器、电光调制器以及集成光学电路 [2–5]。这些应用通常要求 LiTaO₃ 薄膜具有高晶体质量、特定晶向以及厚度精确控制在数百纳米量级,而传统薄膜生长技术难以实现。
LTOI 结构通常通过晶体离子切片(crystal ion slicing, CIS)方法制备 [6]。该方法主要包括三个步骤:离子注入、晶圆键合以及热剥离 [7]。在离子注入步骤中,将氢或氦离子引入供体晶圆,在可控深度形成损伤层。随后,供体晶圆与接收衬底进行键合,并通过热退火诱导离子注入末端区域附近的分裂,从而将薄 LT 层转移到衬底上。
在离子切片过程中,转移后的 LT 薄膜中可能引入残余缺陷和热应变 [8, 9]。在离子注入阶段,入射离子沿其投影路径与靶原子碰撞,产生晶格缺陷,如空位和间隙原子。薄膜转移后,这些缺陷会残留在薄膜表面及内部。此外,由于 LT 薄膜与衬底之间的热膨胀系数差异,键合和剥离过程中通常会引入热不匹配应变。这些注入缺陷和热应变会持续存在于转移后的 LT 薄膜中,进而对各类器件性能产生不利影响。例如,在表面声波器件中,残余缺陷可能降低压电常数和机电耦合系数,产生杂散声学模式,并导致频率不稳定 [10]。在电光调制器中,这类缺陷或应变可能改变折射率,降低电光系数,从而导致调制效率下降和插入损耗增加 [11]。在红外器件中,则可能增加散射噪声 [12]。因此,有效的缺陷修复和应力松弛处理对于实现高性能 LT 器件至关重要。
传统炉退火通常涉及在高温下的长时间加热循环,这可能加剧异质结构(如 LTOI)中的热不匹配应力,甚至导致薄膜开裂 [13]。此外,LT 薄膜通常集成了器件组件,例如声学器件中的电极或反射层,这些脆弱结构无法承受长时间高温处理 [2, 14]。
闪光灯退火(flash-lamp annealing, FLA)提供了毫秒级、可精确控制的热脉冲,可均匀加热整个晶圆表面 [15–17]。研究表明,它在多种材料中对缺陷恢复和再结晶均有效 [18, 19]。由于其持续时间极短,FLA 有望在显著热不匹配应力产生前修复缺陷,同时最大限度减少对已有器件结构的损伤。
本研究在 (100) 硅衬底上通过 CIS 方法制备 LT 薄膜,并对薄膜施加不同能量密度的 FLA 处理。采用随机(RBS-R)和通道分析(RBS-C)的卢瑟福背散射谱及拉曼光谱研究注入缺陷演化,并评估 FLA 在缺陷减少和晶格恢复中的效果。通过 X 射线衍射(XRD)分析退火前后 LT 薄膜的残余应变,以确定 FLA 诱导的应力松弛能力。原子力显微镜(AFM)用于表征 LT 薄膜的表面形貌。
2 | 实验与模拟方法
采用晶体离子切片方法将一片 6 英寸 LT 单晶薄膜转移至 (100) Si 衬底。在离子切片过程中,使用能量为 110 keV、剂量为 7 × 10¹⁶/cm² 的 H 离子进行薄膜转移。注入过程中,将离子束倾斜 7° 以抑制通道效应。LT 薄膜厚度约为 670 nm,LT 薄膜与 (100) Si 衬底之间沉积有 460 nm 厚的 SiO₂ 缓冲层(通过等离子增强化学气相沉积)和多晶 Si 层(通过低压化学气相沉积)。LT 薄膜的厚度和组成通过基于扫描透射电子显微镜(STEM)的能谱成像分析(EDXS)进行表征(使用横截面 TEM 样品,详见支持信息)。
晶圆被切割成 8 × 8 mm² 进行 FLA 及后续表征。FLA 处理脉冲持续时间为 20 ms,能量密度设置为 10、20、30、40 和 50 J/cm²,脉冲次数为 1 次。
通过 1.7 MeV 的 ⁴He⁺ 离子在散射角 170° 下进行 RBS 测量,以研究注入缺陷的深度分布及晶格损伤程度。样品以两种模式测量:随机模式(─R,旋转样品进行测量)和通道模式(─C,样品沿 LT 晶体 [001] 轴精确对准)。
单晶 LT 薄膜质量还通过 Brucker D8 Discovery 衍射仪(Cu Kα₁,λ = 0.15406 nm)进行 XRD 测量。
微区拉曼光谱用于表征振动模式变化,激光波长为 405 nm,实验采用 z(yy)z 配置。
原子力显微镜(AFM)用于表征 LT 薄膜表面形貌,测量采用非接触模式,扫描区域为 5 × 5 μm²,使用 XE7 AFM 控制器。
3 | 结果与讨论
3.1 | 样品对 FLA 的响应
表 1 总结了 FLA 实验结果。能量密度在 10–40 J/cm² 下退火后,样品保持完整。然而,当能量密度为 50 J/cm² 时,样品在 FLA 处理后破裂成小块。该损伤可能由热不匹配应力引起,主要源于 LT 与 Si 异质结构中的热膨胀系数差异,薄 SiO₂ 层贡献可忽略不计。当高能 FLA 下表面温度升高足够时,应力超过结构的机械承受能力。
表 1 | FLA 能量密度及退火后晶圆状态

3.2 | 转移后与 FLA 退火 LiTaO₃ 薄膜的表征
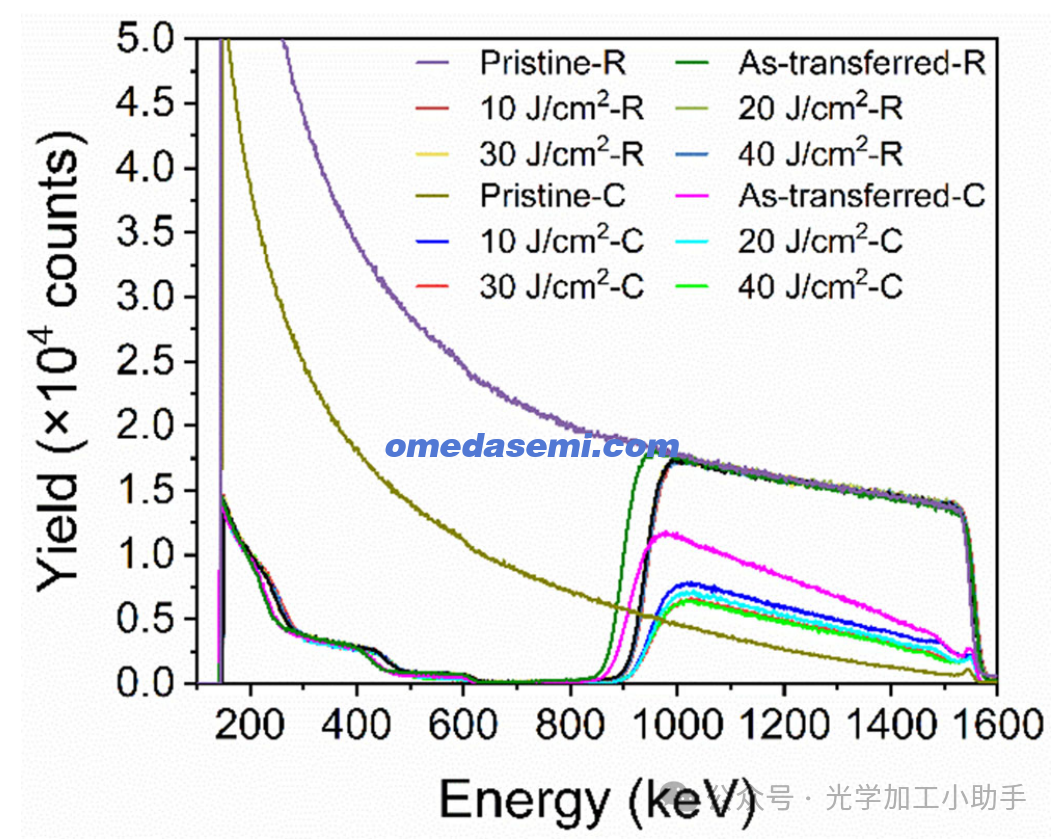
图 1 显示了原始 LT 块体、转移后薄膜以及在不同 FLA 能量密度下退火的 LT 薄膜的 RBS 通道谱。LT 薄膜中 Ta 原子产生的信号出现在约 1557 keV,并向低能方向延伸。对于转移后的薄 LT 薄膜,该信号达到 850–950 keV,表明薄膜厚度存在差异;而原始样品的 Ta 信号则与约 616 keV 的 O 原子信号重叠。在转移后的样品中,O 信号与 Ta 信号分离,并与 SiO₂ 缓冲层和 Si 衬底中的 Si 和 O 信号重叠。由于 Li 原子质量较低,其信号在谱图中几乎不可见。
原始、转移后及 FLA 处理样品的 RBS-R 谱显示约 900–1557 keV 范围内的 Ta 信号相似,表明制备和 FLA 过程对 LT 薄膜的化学成分影响不大。转移后薄膜在 Ta 区域显示最高通道产率,表明存在大量 Ta 位移原子 [20]。FLA 处理后,800–1600 keV 范围的通道产率逐渐下降,表明 Ta 原子从间隙位置迁回到平衡晶格位置,显示出注入缺陷的恢复。较高的 FLA 能量密度可实现更强的缺陷恢复效果。
所有对齐样品在约 1540 keV 处观测到的表面峰归因于 LT 薄膜表面区域 Ta 原子的背散射。该峰在转移后薄膜中强度最高,表明 FLA 处理前表面缺陷最多。在 1480 keV 处还可观测到一个峰,对应于靠近薄膜表面的缺陷丰富区。该峰在 FLA 后强度明显减弱,在 30 和 40 J/cm² 能量密度下几乎消失,进一步证实 FLA 对消除 LT 薄膜残余缺陷的高效性。
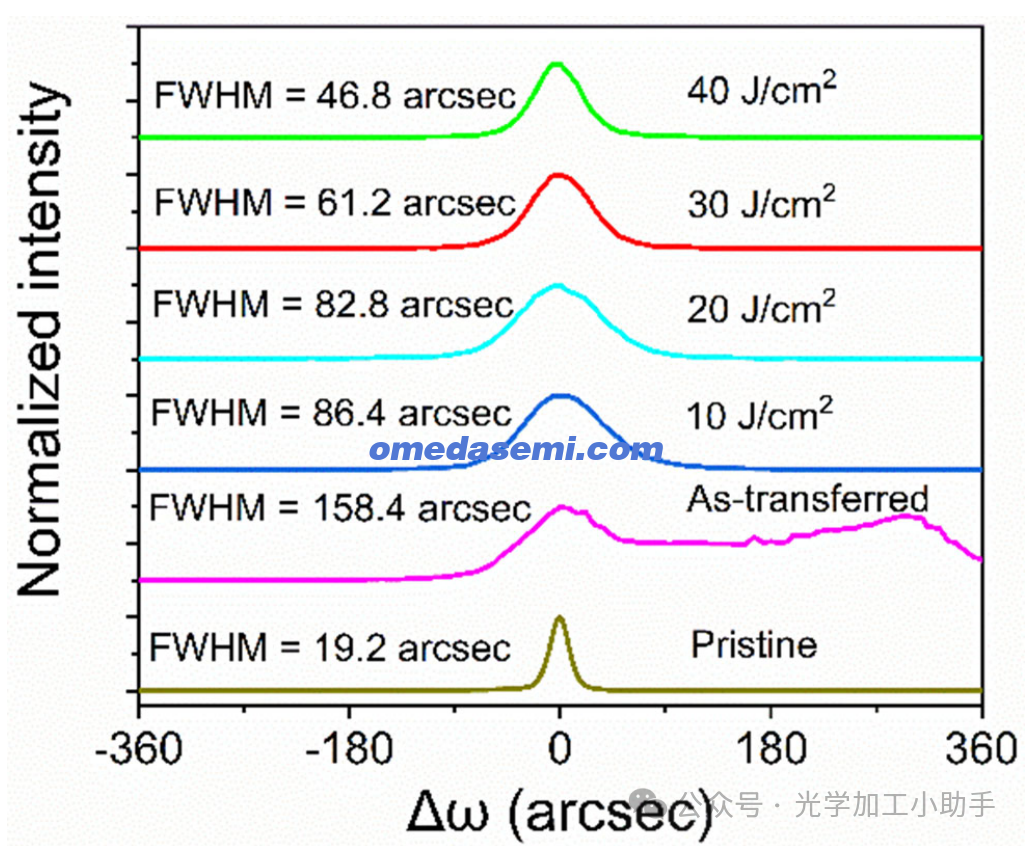
图 2 | 原始 LT 块体、转移后 LT 薄膜及在 10、20、30 和 40 J/cm² 能量密度下 FLA 退火的 LT 薄膜的 XRD 摇摆曲线
通过 XRD 表征转移后及 FLA 退火 LT 薄膜的单晶质量。图 2 显示了 0 0 6 衍射的 XRD 摇摆曲线。转移后 LT 薄膜在主布拉格峰右侧出现 Δω = 302.4 arcsec 的卫星峰,对应 (0 0 6) 面约 0.40% 的残余压应变 [21,22]。这一残余应变可能由热键合和薄膜转移过程中 LiTaO₃ 与 Si 热膨胀系数不匹配引起。值得注意的是,FLA 退火样品的摇摆曲线中卫星峰消失,表明闪光灯退火有效消除了转移薄膜的残余应变。此外,006 布拉格峰的半高宽(FWHM)在 FLA 后减小,说明晶体质量提升。转移后薄膜及 10、20、30 和 40 J/cm² FLA 处理样品的 FWHM 分别为 158.4、86.4、82.8、61.2 和 46.8 arcsec,而原始 LiTaO₃ 块体的 FWHM 为 19.2 arcsec。转移后薄膜的宽峰归因于离子注入引入的残余晶格缺陷。FLA 后 FWHM 的减小表明这些缺陷得到有效修复,能量密度越高,恢复越完全。这一趋势与 RBS 结果一致,显示 FLA 处理后 Ta 位移减少。相比传统炉退火,FLA 实现了相当的缺陷恢复效果,同时大幅缩短处理时间并减少热不匹配应变积累 [6]。
微区拉曼光谱用于研究 FLA 对 LT 薄膜结晶性的影响。

图 3 | 转移后 LT 薄膜及在 10、20、30 和 40 J/cm² 能量密度下 FLA 退火的 LT 薄膜的微区拉曼光谱
图 3 显示转移后及 FLA 退火薄膜的微区拉曼谱。在 z(yy)z 散射配置下,可观测到 144、206、317、390、467、590 和 865 cm⁻¹ 的明显声子模式,同时 251 和 661 cm⁻¹ 出现较弱肩峰 [23]。FLA 处理后,拉曼模式的整体强度显著增强,能量密度越高,增强越明显。467、590 和 865 cm⁻¹ 模式归因于 O─Ta─O 弯曲和 Ta─O 伸缩振动 [24]。这些模式强度增强表明 FLA 减少了 Ta 相关间隙缺陷的浓度,恢复了局部晶格环境。144 和 206 cm⁻¹ 模式对应 Li─O 振动 [25],随着 FLA 能量密度增加而增强,说明 FLA 有效修复了部分 Ta 和 Li 缺陷,提升了 LT 薄膜的结晶性。
综合上述 RBS-C、XRD 和拉曼结果,结构恢复程度与 FLA 能量密度正相关。在后续表征中,选择能量密度为 40 J/cm²、恢复效果最佳的 LT 薄膜与转移后薄膜进行对比。
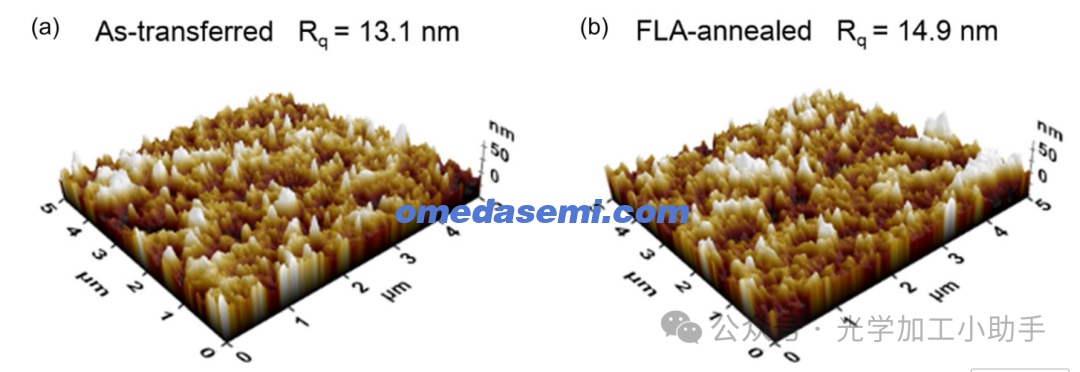
图 4 | LT 薄膜表面形貌的 AFM 图像:(a) 转移后 LT 薄膜,(b) 在 40 J/cm² 能量密度下 FLA 退火的 LT 薄膜
图 4 显示 FLA 前后 LT 薄膜表面形貌的 AFM 表征。表面特征基本保持不变,两幅图像均显示由薄膜剥离过程产生的浅坑 [26]。退火前后薄膜的均方根粗糙度(Rq)分别为 13.1 和 14.9 nm。该轻微差异可忽略不计,可能源于扫描区域的正常变化,而非表面结构的内在变化。结果表明,在有效缺陷修复的能量范围内,FLA 对 LT 薄膜表面形貌无不利影响,未观察到纳米级表面重构。
综上所述,FLA 能有效修复 LT 薄膜的残余缺陷并缓解应变,从而改善薄膜结构质量,预期可提升 LTOI 器件性能。例如,表面声波器件可获益于提高品质因子和降低声学损耗,电光调制器的光学损耗可降低。此外,FLA 可根据材料需求灵活调节能量密度、脉冲数及脉冲持续时间,因此在其他异质集成结构中同样具有应用潜力。
4 结论
本研究采用 10–50 J/cm² 能量密度的 FLA 对通过晶体离子切片制备的 LT 薄膜进行修复。研究发现 LT 薄膜可承受的最大能量密度为 40 J/cm²,在此条件下实现最佳恢复效果。RBS-C 测量显示 FLA 后 Ta 位移原子显著减少,表明注入缺陷得到有效恢复。XRD 结果显示卫星峰消失,主布拉格峰 FWHM 减小,说明 LT 薄膜应变有效松弛且晶体质量提升。拉曼光谱进一步确认结晶性改善,Li─O 和 Ta─O 振动模式增强。
总体而言,结果证实 FLA 为 LT 薄膜残余缺陷和应力恢复提供了一种高效策略,该策略同样可推广至其他异质集成结构。
文章名:Flash-Lamp Annealing for Repairing Residual Defects in Single-Crystalline LiTaO3-On-Silicon Thin Films Fabricated by Crystal Ion Slicing
作者:
Limin Wan1,2 | Xinqiang Pan1,3 | Thomas Schumann2 | Oliver Steuer2 | Fabian Ganss2 | René Hübner2 |Przemyslaw Jozwik4 | Renata Ratajczak4 | Cyprian Mieszczynski4 | Xu Wang1 | René Heller2 | Ye Yuan5 | Yao Shuai1,3 |Wenbo Luo1,3 | Chuangui Wu1,3 | Jun Zhu1,3 | Shengqiang Zhou2 | Wanli Zhang1,3
单位:电子科大&hzdr等