原子层镀膜
我们同时提供原子层镀膜设备和代工服务,
如果您对我们的设备感兴趣,请浏览此网页:原子层镀膜设备
业务流程(必读):
尊敬的客户,联系销售后,请准确提供以下信息,方便技术团队判定是否可以生产,节约沟通成本,请复制下方信息,填写完成后发给销售,感谢您的理解与支持。
1.衬底长宽厚及材质:
2.表面膜层材质和厚度(如果衬底表面已经有膜层,):
3.需要进行原子层衬底的膜层材质及厚度:
4.表面是否有结构及胶,如果有结构请提供版图及结构深度,如果有胶请告诉胶水型号及厚度:
产能说明:
目前设备配置为1台8寸Beneq TFS200,余下为自制设备7台,支持2-12寸原子层镀膜沉积,充沛的产能可以满足企业客户大批量制造加工需求。
加工能力:
可沉积薄膜:
氧化硅(SIO2)氧化铝(Al2O3),氧化锆(ZrO2),氧化铪(HfO2),氧化钛(TiO2),氧化镓(Ga2O3),氮化铝(AlN),氮化钛(TiN),氧化锌(ZnO),氧化铟(In₂O₃)
支持尺寸:2-12寸(部分材料支持12寸工艺)
备注:对于ALD工艺样品必须彻底清洗干净,需耐温,无毒,无易分解、无易扩散(如Cu),无粉末,不能用mark笔标记样品,不能有高温胶带!
我们设备能够支持的最高的物件高度是 10cm
案例展示:
8 inch ALD 30nm Al2O3 (实测膜厚均匀性+-1%)

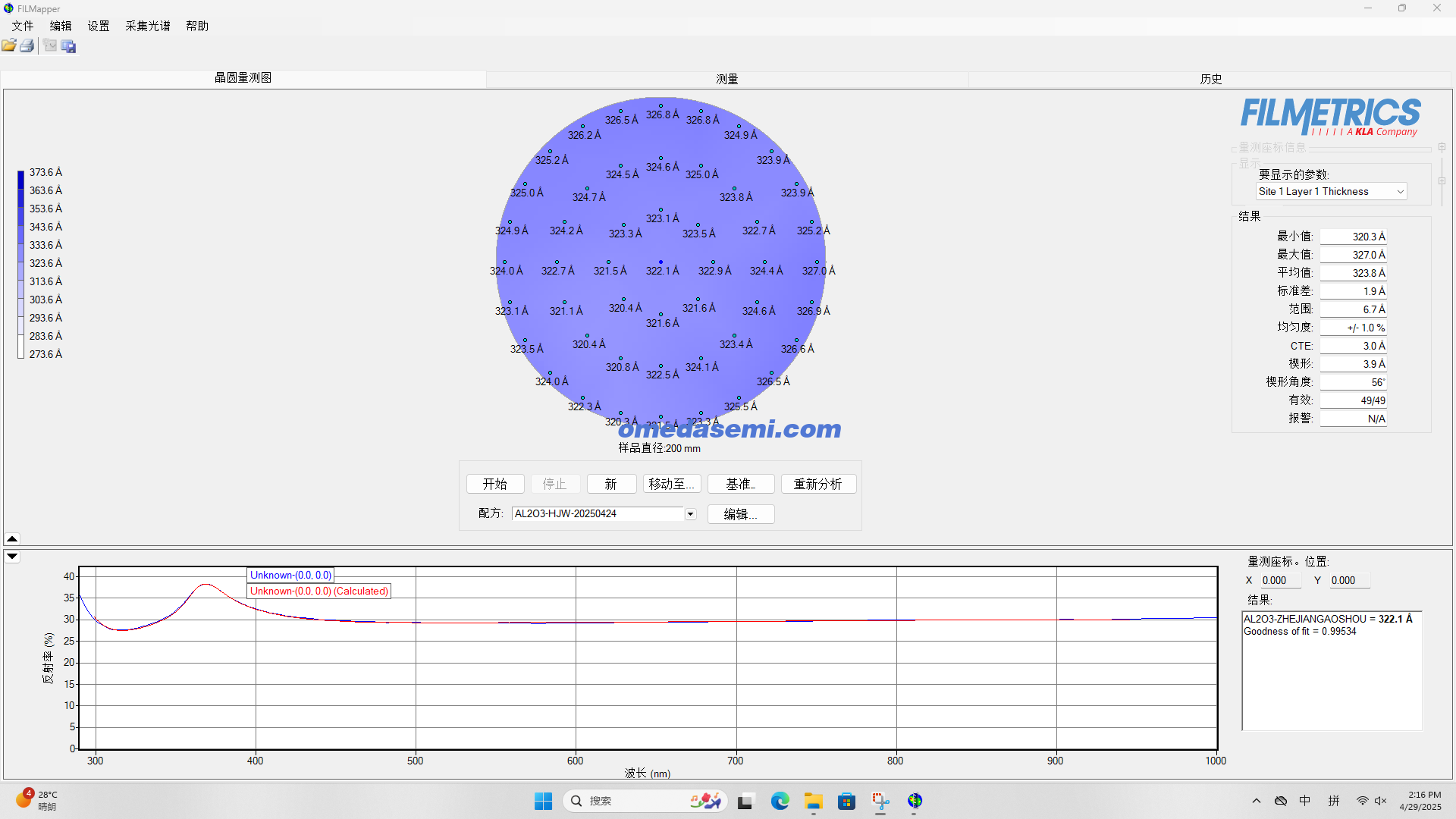
设备展示:
设备主要为Beneq TFS2000设备,同时配有部分自制设备
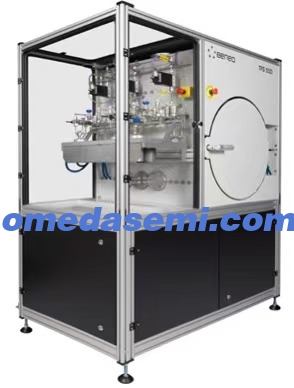
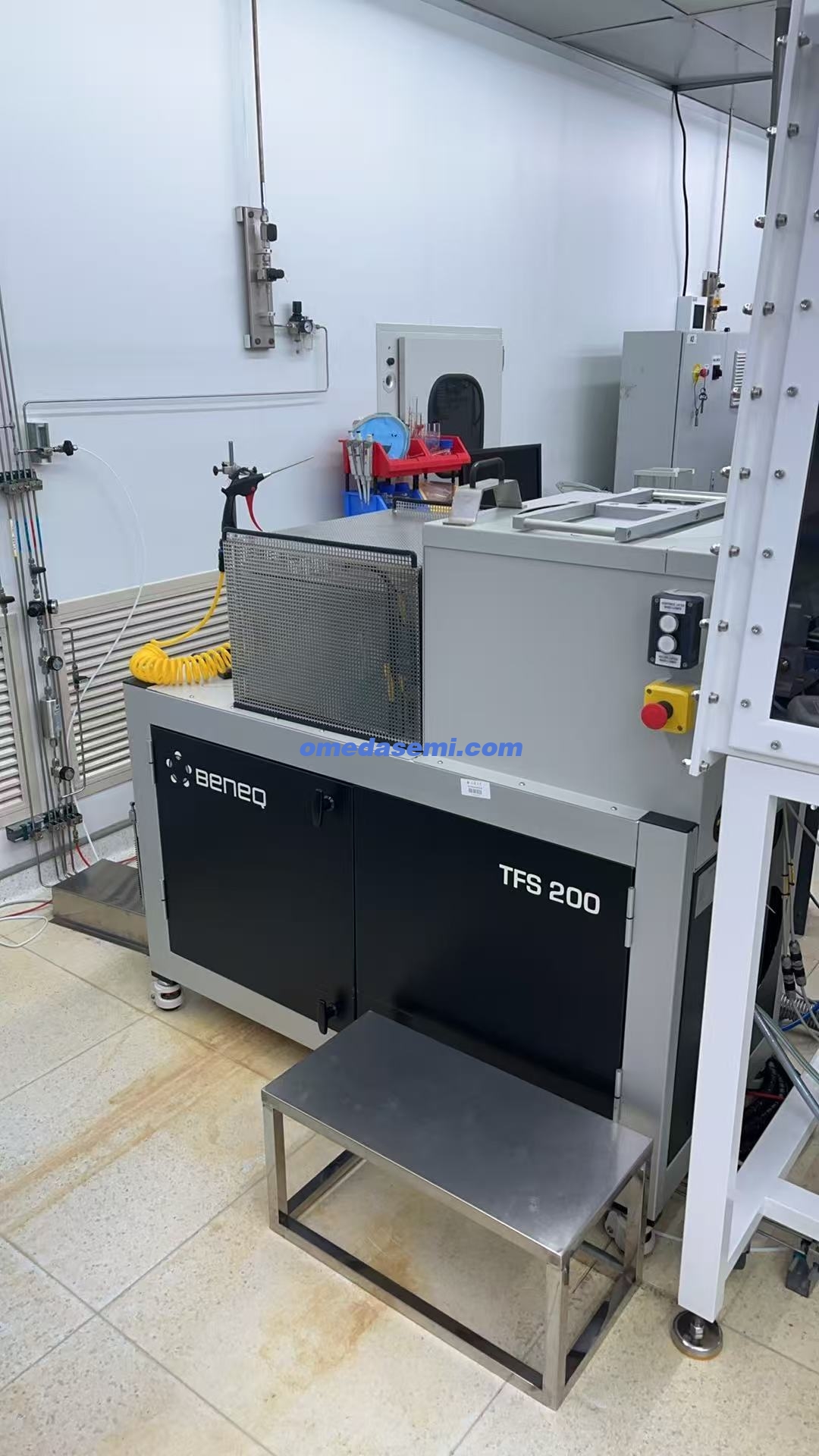
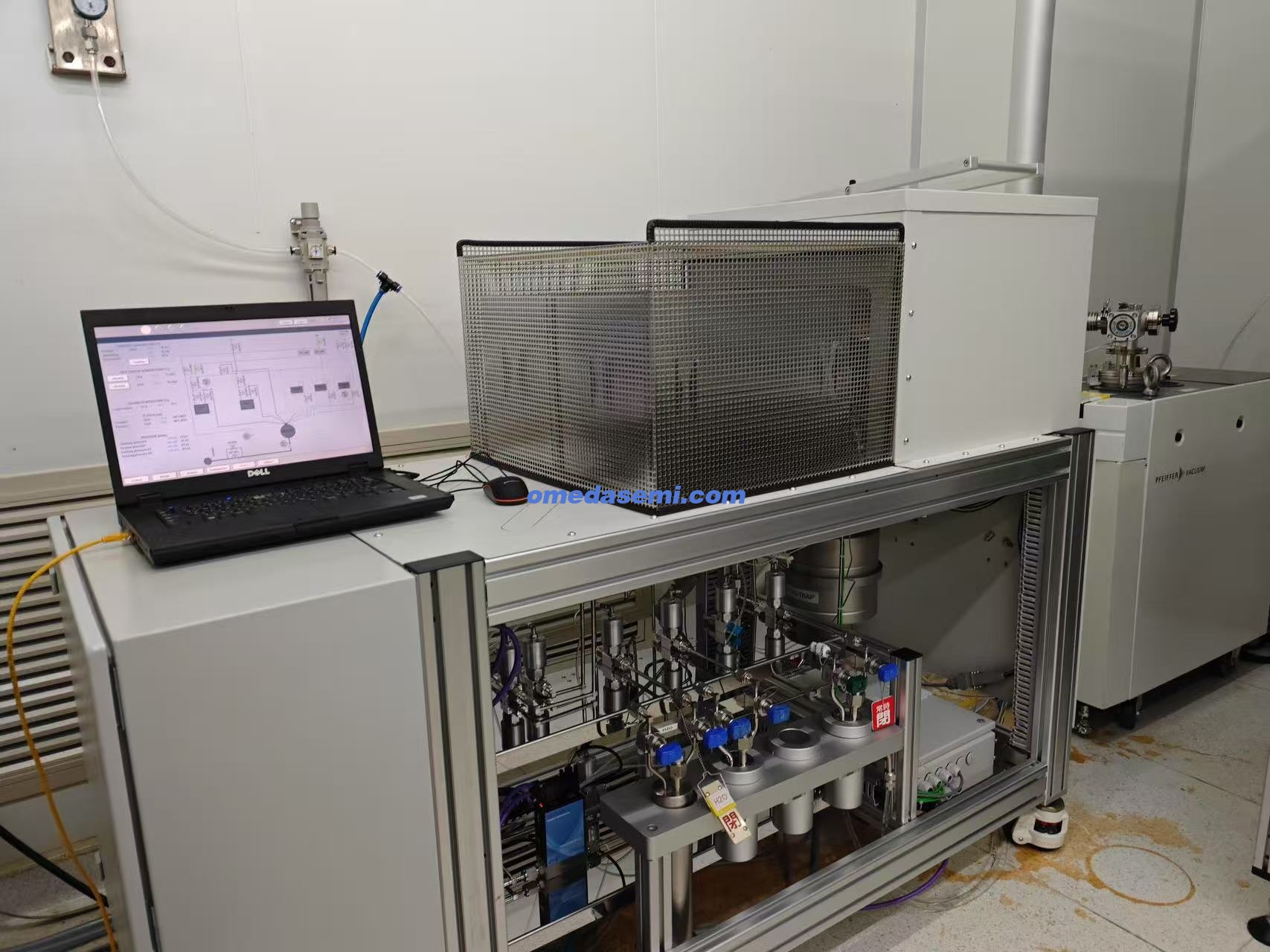
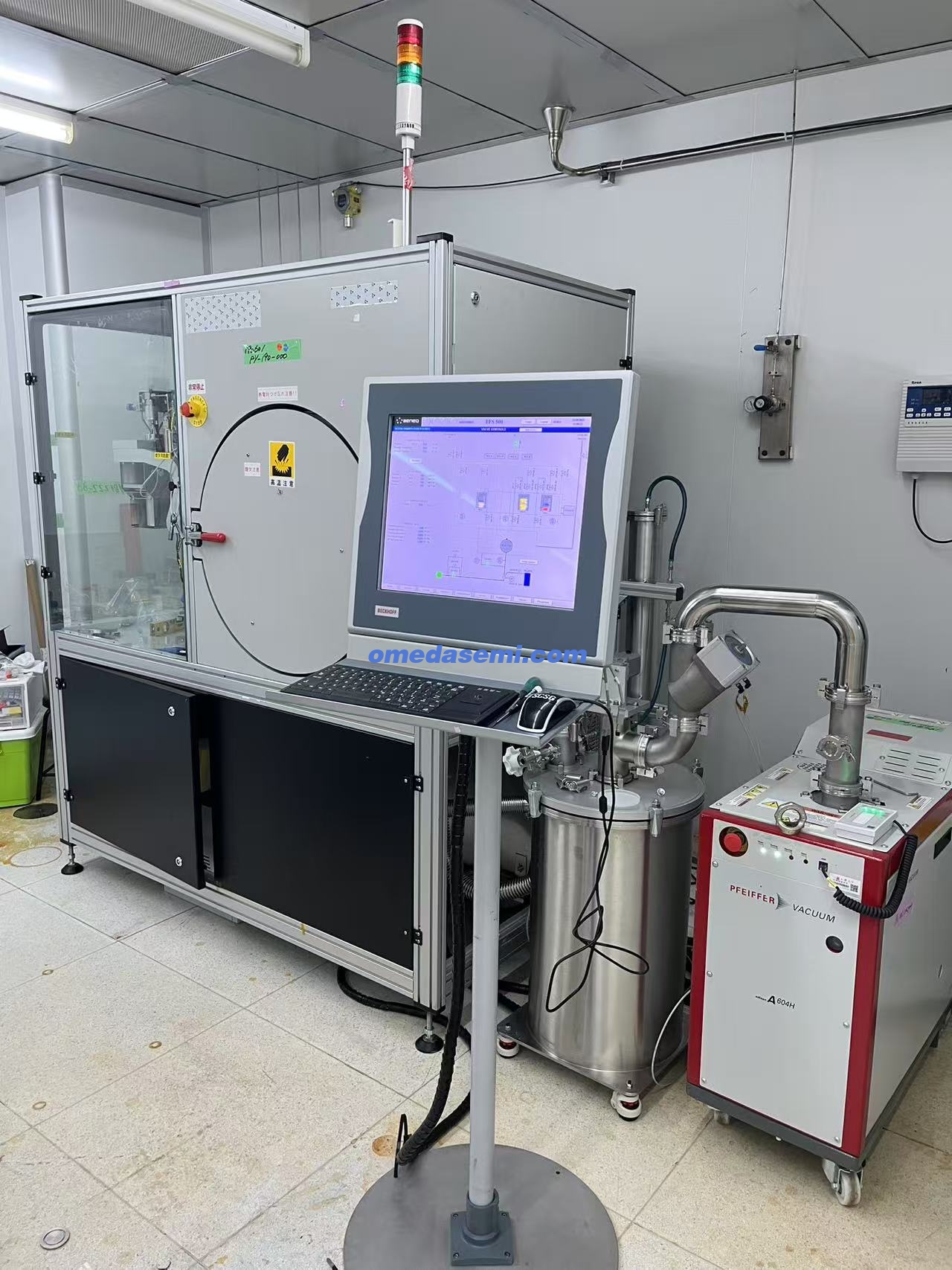
基本原理:
原子层沉积(ALD)是一种基于连续使用气相化学过程的薄膜沉积技术;它是化学气相沉积的一个子类。大多数 ALD 反应使用两种称为前体(也称为“反应物”)的化学物质。这些前体以连续、自限的方式与材料表面一次发生一个反应。通过反复暴露于单独的前体,薄膜缓慢沉积。 ALD 是制造半导体器件的关键工艺,也是合成纳米材料工具集的一部分。
优点:
A--ALD能够逐层沉积薄膜,从而对薄膜厚度进行出色的控制。这种精度在半导体等应用中尤为重要,因为在半导体应用中,纳米级的变化会显著影响器件性能。
B--传统的沉积技术难以均匀地涂覆复杂的结构,导致薄膜不均匀。原子层沉积克服了这一挑战,即使在复杂的几何形状中也能确保共形覆盖,使其适用于微电子和微机电系统(MEMS)器件。
C--ALD的自限性反应使薄膜高度均匀,没有缺陷和厚度变化。这种均匀性对于薄膜晶体管和保护涂层等应用至关重要。
D--原子层沉积适用于各种材料,从氧化物和氮化物到金属和有机化合物。这种多功能性允许创建新颖的材料组合和功能结构。
E--ALD的共形性质延伸到纳米孔和纳米管等高纵横比结构,从而实现了能量存储和催化的创新。
与传统方法相比,ALD的受控工艺减少了材料浪费和能源消耗,符合可持续制造实践。
了解我们更多的薄膜沉积加工能力:






