#CavitySOI晶圆 #SOI晶圆 #超平整SOI晶圆
摘要:腔体硅绝缘体(Cavity-SOI)为微电机械系统(MEMS)提供了显著的设计灵活性。特别地,腔体的形状和深度可以根据特定要求进行定制,从而促进复杂多层结构设计的实现。所提制造方法的创新性体现在其采用微加工工艺流程,结合干刻蚀、晶圆级Au-Si共晶键合和化学机械抛光(CMP)来制造Cavity-SOI。这种创新方法显著降低了制造的复杂性,且晶圆级金硅共晶键合和真空封装的实施,代表了相较于传统方法的一大优势。为了评估技术可行性,设计了一个MEMS共振压力传感器(RPS)。实验结果表明,在Cavity-SOI形成过程中,干刻蚀能够精确制造预定义尺寸的腔体,晶圆级Au-Si共晶键合可以实现高效封装,而CMP则能够精确调节腔体的深度,从而验证了Cavity-SOI形成过程的可行性。此外,在MEMS RPS的制造中实施Cavity-SOI,可以实现谐振器的自释放,避免了常见的氟化氢(HF)释放过程中的倒刻蚀和粘附问题。使用Cavity-SOI制造的传感器展现出100.695 Hz/kPa的灵敏度,工作温度范围为-10至60°C,压力范围为1至120 kPa,最大误差小于0.012%全尺度(FS)。所开发的Cavity-SOI微加工工艺不仅简化了制造过程,还解决了传统MEMS制造中的若干挑战。MEMS RPS的成功制造和性能验证确认了所提方法的有效性和实用性。这一突破为高性能MEMS器件的开发开辟了道路,并为不同行业的各种应用提供了新的可能性。
#全国产SOI晶圆定制加工 #468寸50nm-15um热氧片
库存片:
220nmSI高阻-3umSIO2-675umSI 6寸8寸 用于薄硅硅光
3000nmSI高阻-3umSIO2-675umSI 6寸8寸 用于厚硅硅光
#尺寸4-8寸
#最小起订量1片
#热氧层厚度范围50nm-15um
#膜厚精度最高精度+-5nm
#厚膜SOI-减薄抛光工艺600nm到微米级,加离子束精修,超级高精度膜厚均匀性
#CavitySOI-带空腔SOI晶圆,光刻显影刻蚀键合制作SOI
#超平硅片-TTV500nm
我们为客户提供晶圆(硅晶圆,玻璃晶圆,SOI晶圆,GaAs,蓝宝石,碳化硅(导电,非绝缘),Ga2O3,金刚石,GaN(外延片/衬底)),镀膜(PVD,cvd,Ald,PLD)和材料(Au Cu Ag Pt Al Cr Ti Ni Sio2 Tio2 Ti3O5,Ta2O5,ZrO2,TiN,ALN,ZnO,HfO2。。更多材料),键合(石英石英键合,蓝宝石蓝宝石键合)光刻,高精度掩模版,外延,掺杂,6寸DUVKRF电子束光刻等产品及加工服务(请找小编领取我们晶圆标品库存列表,为您的科学实验加速。
请联系小编免费获取原文

文章名:A Method for Fabricating Cavity-SOI and Its Verification Using Resonant Pressure Sensors
作者:Han Xue 1,2 , Xingyu Li 1,2, Yulan Lu 1 , Bo Xie 1,2, Deyong Chen 1,2, Junbo Wang 1,2,and Jian Chen 1,2
1. 引言
标准SOI广泛用于制造MEMS器件,如压力传感器[1,2]、惯性传感器[3,4]、微流控器件[5]和其他MEMS器件[6]。它由一个基底层作为基础,一个通常用于设备制造的设备层,以及中间的埋氧化物层组成,如图1a所示。
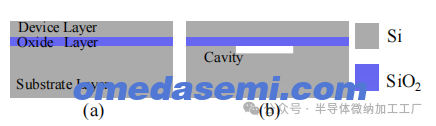
图1. 结构示意图。(a) 标准SOI,(b) 腔体-SOI。
腔体-SOI是一种定制化的SOI类型。与标准SOI类似,它的结构也包括基底层、埋氧化物层和设备层,如图1b所示。具体来说,腔体-SOI的中间包含埋藏的腔体[7]。由于基底层上存在这些腔体,腔体-SOI在MEMS器件制造过程中提供了多个优势[8-10]。例如,可以减少制造步骤的数量[11]。同时,它还可以避免在制造可动组件(如压力或惯性传感器)时,由氟化氢(HF)释放引起的倒刻蚀问题[1,12,13]。
腔体-SOI通常通过将两片硅晶圆键合在一起制造。在键合之前,通过氧化过程在晶圆表面形成硅氧化物层,作为SOI氧化物层。该层充当基底层和设备层之间的绝缘体[14,15]。腔体-SOI是一种能够满足半导体和MEMS技术的小型化和高性能要求的解决方案。Lee等人建议,腔体-SOI有助于压力传感器的封装[16]。Luoto等人则为腔体-SOI制造建立了设计规则[17]。
目前,腔体-SOI技术被广泛应用于制造各种高性能MEMS器件。该技术不仅可以生产具有更复杂结构的器件,还简化了制造过程。通过提前制造腔体,可以减少刻蚀步骤的数量,并消除可动部件的释放步骤[15,18,19]。
然而,使用Si-Si直接键合制造腔体-SOI需要在大约1000°C的高温下退火,以确保键合质量[6,14,15]。这个高温要求可能导致与MEMS工艺的兼容性问题。同时,在现有文献中,腔体-SOI的应用主要实现了机械连接,且很少实现真空封装[17,18]。
在本文中,我们采用了晶圆级Au-Si共晶键合来制造腔体-SOI。通过这种方法,键合温度可以降低到390°C,并实现了真空封装。同时,利用CMP工艺可以制造任意厚度的设备层,这为制造过程提供了更大的灵活性[12]。
为了验证所制造腔体-SOI的可行性,我们使用它来制造MEMS共振压力传感器(RPS)。实验结果表明,使用定制的腔体-SOI不仅简化了制造过程并解决了氟化氢释放引起的倒刻蚀问题,而且使得RPS在灵敏度和准确度方面与使用标准SOI制造的器件具有可比的性能[20-23]。
2. 腔体-SOI的制造
腔体-SOI是通过将两片硅晶圆进行晶圆级Au-Si共晶键合,然后将其薄化至特定厚度来制造的。图2展示了主要的制造步骤,包括腔体刻蚀、共晶键合和CMP。
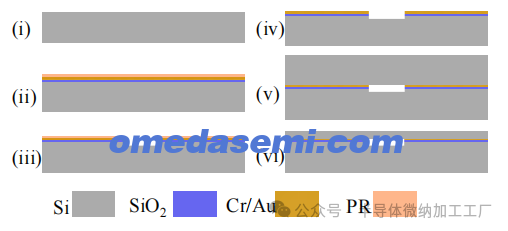
图2. 腔体-SOI的制造步骤。
(i) 清洁硅晶圆。
(ii) 在清洁的硅晶圆表面生长氧化物层作为绝缘层,然后蒸发一层50 nm厚的铬(Cr)作为粘合层,接着蒸发500 nm厚的金(Au)作为键合材料,并涂覆一层光刻胶(PR)作为图案化掩模。
(iii) 在硅晶圆表面刻蚀腔体,深度为10 µm。
(iv) 使用丙酮、酒精和去离子水清洗表面的光刻胶。
(v) 在390°C温度和2000 mbar压力下将另一片硅晶圆进行键合。
(vi) 通过CMP方法将键合后的硅晶圆薄化至预定厚度。
首先,使用浓硫酸和去离子水清洁一片双面抛光的硅晶圆(4英寸,300 µm厚,N型,<100>晶相),如图2i所示。然后,通过低压化学气相沉积(LPCVD)在晶圆表面沉积一层SiO2,作为绝缘层。接着,通过电子束蒸发沉积了一层50 nm厚的铬层和500 nm厚的金层,作为粘合层和键合层,如图2ii所示。然后,在金层表面旋涂一层光刻胶(SPR220)。接下来,使用光刻和干刻蚀工艺在硅晶圆表面制造腔体,如图2iii所示。然后,使用丙酮、无水乙醇和去离子水依次清洗晶圆,以去除光刻胶,如图2iv所示。
对于Au-Si共晶键合,首先需要在刻蚀腔体的硅晶圆上沉积金属层。通过蒸发工艺先形成用于共晶键合的铬金层。然后,在390°C、2000 mbar的压力下,将其与另一片清洁的、双面抛光的硅晶圆(4英寸,300 µm厚,N型,<100>晶相)键合,如图2v所示;该温度和压力保持30分钟。
为了实现良好的键合效果,需要仔细清洁两片晶圆,以减少表面颗粒和污染物。对于已刻蚀的晶圆,首先使用丙酮、无水乙醇和去离子水依次清洗并去除表面有机物质,然后在高温去离子水中清洗(95°C,10分钟)。对于未刻蚀的晶圆,使用浓硫酸(90°C,15分钟)清洁并去除表面颗粒,然后用高温去离子水清洗。
另一方面,为了减少水蒸气和其他气体对键合的影响,在键合过程中,在键合机的真空环境下,在施加压力之前,首先将温度升高至200°C,并保持60分钟,以彻底干燥晶圆。然后,温度进一步升高至390°C进行键合。
键合完成后,需要将键合后的硅晶圆薄化至40 µm的设备层厚度,以便制造共振器,如图2vi所示。CMP工艺包括三个阶段:首先,使用粗磨料进行初步薄化;其次,使用细磨料进行进一步薄化,直到达到所需的厚度;最后,使用抛光液进行抛光,以满足键合要求。通过上述处理步骤,成功制造了Cavity-SOI,并可用于加工RPS。
Cavity-SOI的厚度需要满足规定的值,总厚度变化不超过10 µm。通过使用厚度计测量Cavity-SOI的厚度,结果显示厚度范围为338-343 µm。
我们使用步进轮廓仪测量了CMP工艺后的样品表面。测量结果如图3a所示。我们在晶圆表面均匀选择了五个点进行测量。从这些测量中获得的表面粗糙度值均小于1 nm,表明表面光洁度极高。
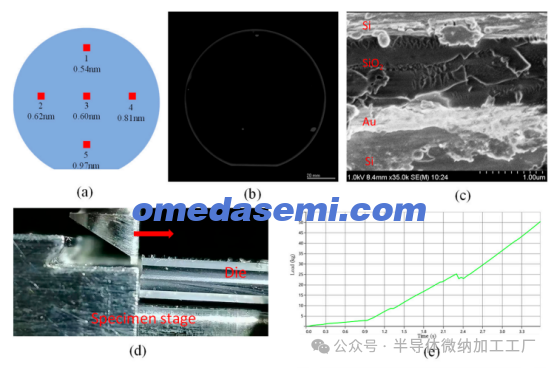
图3. CMP和键合质量的表征。
(a) 表面粗糙度的测量结果,范围从0.54到0.97 nm。
(b) 使用超声波扫描显微镜进行的键合测试结果。浅色区域表示未键合区域。
(c) 键合界面的扫描电子显微镜图像。
(d) 使用推拉试验机进行的键合剪切力测试。
(e) 剪切力测试结果。键合可以承受超过50 kgf的剪切力。
为了表征键合的硅晶圆,我们使用了超声波扫描显微镜,如图3b所示。表征结果清晰地显示,键合质量是令人满意的。尽管在一些特定区域仅有非常小的未键合区域,这些区域可以归因于键合表面在键合前存在的尘粒和污染物。在键合过程前对键合表面的适当清洁可以有效减少这种未键合区域的数量和面积。
此外,我们使用扫描电子显微镜检查了键合界面,如图3c所示。显微图像表明,键合界面没有可见的孔洞,这进一步验证了本研究中所实现的优良键合质量。
如图3d所示,键合的晶圆被切割成5 mm X 5 mm的方块。随后,使用推拉试验机测量了键合界面的剪切力。获得的测试结果如图3e所示。键合面展示了能够承受超过50 kgf的剪切力。通过计算,得出该键合能够承受超过1.96 x 10² Pa的剪切应力。这些发现为键合过程的可靠性提供了证据。
3. 验证Cavity-SOI
3.1. 传感器设计
由于Cavity-SOI是为了用于MEMS共振压力传感器(RPS)制造的,因此Cavity-SOI的设计应与传感器的设计相一致。传感器芯片由两个主要组件组成:先前制造的Cavity-SOI和由BF33玻璃(SCHOTT,苏州,中国)制成的盖子,如图4a和4b所示。
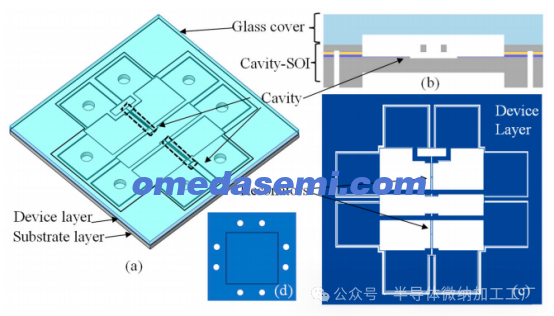
图4. 压力传感器设计。
(a) 传感器整体结构的示意图,传感器由玻璃盖板和Cavity-SOI从上到下组成。
(b) 传感器结构的示意图;腔体位于谐振器正下方。
(c) 设备层的示意图,谐振器位于设备层的不同位置,并通过硅线连接到边缘的焊盘。
(d) 基底层的示意图。
在Cavity-SOI的基底层上制造了两个腔体,谐振器则在设备层上制造,如图4c所示。同时,在基底层的背面制造了一个膜片(长度为5000 µm,宽度为5000 µm,厚度为120 µm)和电极引线孔(直径为300 µm),如图4d所示。Cavity-SOI的设备层厚度设计为40 µm,基底层厚度为300 µm。每个腔体的尺寸设计为400 µm x 1500 µm,深度为10 µm。
传感器的芯片由两个H形谐振器组成。所施加压力的大小是通过检测这两个谐振器发射的频率信号来确定的。只有在成功地进行真空封装时,谐振器才能在其最佳性能下工作。
因此,谐振器的共振频率检测和通过电路实现相对较高的品质因数(Q值)是关键指标。这些指标使我们能够确认所制造的Cavity-SOI有效地完成了真空封装。成功实现的真空封装验证了晶圆级Au-Si共晶键合过程的可靠性。最终,这一验证为所提方法在制造Cavity-SOI中的可行性提供了充分的证据。
3.2. 传感器制造
Cavity-SOI被用于制造共振压力传感器(RPS),其关键工艺步骤如图5a所示。首先,通过深反应离子刻蚀(DRIE)在Cavity-SOI的基底层上形成压力敏感膜片和电极引线孔,如图5a(i,ii)所示。接着,在设备层上制造了谐振器、焊盘和电极引线,如图5a(iii)所示。谐振器盖板由BF33玻璃制造,如图5a(iv-vii)所示,随后通过阳极键合将其与Cavity-SOI键合,如图5a(viii)所示。键合过程完成后,晶圆被切割成单个传感器芯片。如图5b所示,芯片的尺寸为10 mm x 10 mm。接下来,芯片使用Kovar基座和盖板进行了封装。
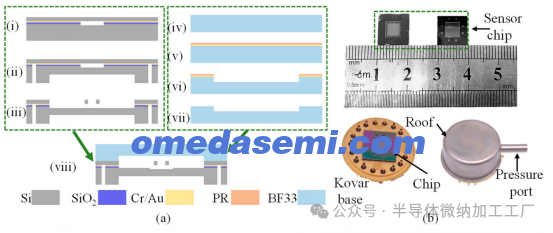
图5.(a) 传感器制造过程的示意图。
(i) 使用丙酮、无水乙醇和去离子水清洁图2中制造的Cavity-SOI。
(ii) 在Cavity-SOI基底层的中心刻蚀压力敏感膜片,深度为180 µm,并在晶圆背面的边缘刻蚀孔。
(iii) 在设备层上刻蚀谐振器和其他结构。谐振器直接位于腔体上方。
(iv) 使用浓硫酸和去离子水清洁BF33玻璃。
(v) 在清洁的玻璃表面蒸发一层Cr/Au,然后在Cr/Au表面旋涂一层光刻胶。
(vi) 使用金刻蚀溶液和铬刻蚀溶液将BF33玻璃刻蚀至5 µm的深度。
(vii) 清洁玻璃,去除光刻胶和Cr/Au层。
(viii) 通过阳极键合将步骤(iii)中制造的Cavity-SOI与步骤(vii)中制造的玻璃盖板键合。
(b) 芯片尺寸:约10 mm的长度和宽度,正面有玻璃盖,背面有压力敏感膜片和引线孔。以及传感器的封装。
SEM观察显示,谐振器直接位于腔体上方,如图6a所示。此外,使用Cavity-SOI有效避免了在释放谐振器过程中形成倒刻蚀,如图6b所示。相比之下,使用标准SOI并采用HF释放谐振器制造的RPS的SEM图像显示了倒刻蚀,如图6c所示。

图6.(a) 谐振器轮廓的SEM照片,腔体位于谐振器正下方。
(b) 在金硅共晶键合界面的边缘, 与(c)相比,没有倒刻蚀。
3.3. 传感器性能
传感器输出了两个共振频率信号,分别为64,468.02 Hz和76,224.54 Hz(在20°C和100 kPa下)。这些信号被电路收集并处理,以评估传感器的性能。我们使用网络分析仪测试了传感器的幅频特性曲线和Q值,结果如图7a所示。谐振器的Q值为18,143,表明谐振器在真空环境下工作,这验证了通过晶圆级共晶键合和阳极键合成功实现真空封装。在整个晶圆上制造的52个芯片中,41个测试芯片的Q值大于15,000,综合良品率约为78.8%。
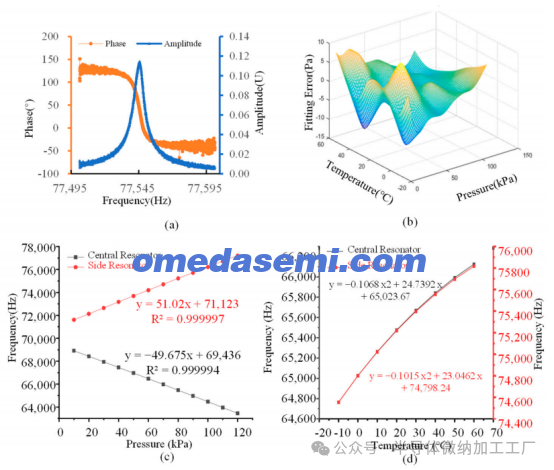
图7. 传感器的测试结果。
(a) 微传感器在室温和大气压力下的开环测试结果,谐振器的Q值为18,143。
(b) 在−10–60°C的温度范围内,在1–120 kPa的压力下,传感器在不同温度和压力下进行了标定,误差小于14 Pa。
(c) 侧谐振器的压力灵敏度为51.02 Hz/kPa,线性度为0.999997,中央谐振器的压力灵敏度为−49.675 Hz/kPa,线性度为0.999994。
(d) 侧谐振器的温度灵敏度为18.155 Hz/°C,中央谐振器的温度灵敏度为19.573 Hz/°C。
传感器在−10°C至60°C的温度范围和1 kPa至120 kPa的压力范围内进行了测试。我们使用五阶二项式拟合方法对制造的传感器进行了标定,压力p可以表示为:

其中,k是多项式系数。
如图7b所示,多项式拟合平面具有小于0.012%的拟合误差。传感器对温度和压力的灵敏度分别如图7c和7d所示。侧谐振器的压力灵敏度为51.02 Hz/kPa,线性度为0.999997。中央谐振器的压力灵敏度为−49.675 Hz/kPa,线性度为0.999994。谐振器的温度灵敏度如图7d所示。如我们所见,温度与频率之间的关系并非严格线性,主要是由于不同材料的热膨胀系数差异所导致的。传感器的温度系数受玻璃盖板以及通过共晶键合引入的不同材料类型的影响。
根据测试结果,一个谐振器表现为正压力灵敏度,而另一个则表现为负压力灵敏度。值得注意的是,两个谐振器均表现出正的温度灵敏度。因此,我们选择了差分输出模式,以增强传感器的灵敏度,同时最大限度地减少温度变化和漂移对传感器性能的影响。
4. 结论
本文提出了一种用于形成Cavity-SOI的制造方法。该方法结合了预刻蚀腔体、晶圆级低温共晶键合和CMP工艺。这使得腔体的深度和尺寸可以定制,从而为MEMS器件提供了更大的设计灵活性。
在Cavity-SOI的制造中,采用了晶圆级金硅共晶键合。该工艺的键合强度超过了1.96 × 10⁷ Pa,并成功实现了真空封装。通过对Cavity-SOI应用CMP工艺,表面粗糙度可以降低到低至1 nm。
通过制造RPS,已验证Cavity-SOI确实能够减少制造过程步骤的数量。此外,它有效解决了通常由HF释放过程中产生的倒刻蚀问题。
尽管制造Cavity-SOI的方法是一种定制化方法,需要根据具体器件进行设计考虑,但它仍为更复杂的MEMS器件设计提供了显著的可行性。此外,它可以集成到成熟的器件制造工艺中,从而有助于简化整个制造工作流程。