摘要:多家硅绝缘体(SOI)晶圆制造商目前提供带有客户定义的腔体刻蚀的手柄晶圆,这大大简化了压力传感器等MEMS器件的制造。本文介绍了一种新型的腔体埋氧化物(BOX)SOI基底(腔体-BOX),其中包含了图案化的BOX层。图案化的BOX可以形成埋藏的微通道网络,或者作为停止层和埋藏的硬刻蚀掩模,通过使用适合洁净室微加工工具和方法,从晶圆的背面精确地刻蚀设备层。通过将腔体-BOX用作埋藏的硬刻蚀掩模,本研究演示了其在深脑刺激(DBS)示范器制造中的应用。该示范器由一个大面积的柔性区域和精确定义的80 µm厚的硅岛组成,这些硅岛被卷入一个1.4 mm直径的圆柱体中。使用腔体-BOX后,硅岛的薄化和分离过程被大大简化,并且变得更加稳健。这个测试案例展示了腔体-BOX晶圆如何通过提供更多的设计自由度并简化制造过程的优化,推动各种MEMS器件的制造,特别是那些具有复杂几何形状和附加功能的器件。
#全国产SOI晶圆定制加工 #468寸50nm-15um热氧片
库存片:
220nmSI高阻-3umSIO2-675umSI 6寸8寸 用于薄硅硅光
3000nmSI高阻-3umSIO2-675umSI 6寸8寸 用于厚硅硅光
#尺寸4-8寸
#最小起订量1片
#热氧层厚度范围50nm-15um
#膜厚精度最高精度+-5nm
#厚膜SOI-减薄抛光工艺600nm到微米级,加离子束精修,超级高精度膜厚均匀性
#CavitySOI-带空腔SOI晶圆,光刻显影刻蚀键合制作SOI
#超平硅片-TTV500nm
我们为客户提供晶圆(硅晶圆,玻璃晶圆,SOI晶圆,GaAs,蓝宝石,碳化硅(导电,非绝缘),Ga2O3,金刚石,GaN(外延片/衬底)),镀膜(PVD,cvd,Ald,PLD)和材料(Au Cu Ag Pt Al Cr Ti Ni Sio2 Tio2 Ti3O5,Ta2O5,ZrO2,TiN,ALN,ZnO,HfO2。。更多材料),键合(石英石英键合,蓝宝石蓝宝石键合)光刻,高精度掩模版,外延,掺杂,6寸DUVKRF电子束光刻等产品及加工服务(请找小编领取我们晶圆标品库存列表,为您的科学实验加速。
请联系小编免费获取原文

文章名:Cavity-BOX SOI: Advanced Silicon Substrate with Pre-Patterned BOX for Monolithic MEMS Fabrication
作者:Marta Maria Kluba 1 , Jian Li 1, Katja Parkkinen 2 , Marcus Louwerse 3 , Jaap Snijder 3 and Ronald Dekker 1,4,
1.引言
标准SOI基底最初是为电子器件中的完美介电隔离而开发的。如今,SOI晶圆也成为了制造MEMS器件的重要基底材料。SOI晶圆由一个手柄晶圆组成,该晶圆在制造过程中提供机械强度,一个设备层,其中制造了设备,以及一个埋氧化物(BOX)层,BOX层将设备层与手柄晶圆隔开(见图1a)。除了电气隔离外,BOX层还允许制造具有明确定义的设备层厚度的MEMS器件,并且可以在浮动结构中作为释放层。SOI晶圆广泛应用于压力传感器[1]、谐振器和惯性传感器[2]、微通道[3]以及微型化微加工医疗器械[4,5]等多个领域。
腔体-SOI基底是从硅绝缘体家族中衍生出来的一种基底[6]。它是一种定制的SOI基底,SOI基底的制造商将客户定义的埋藏腔体集成到硅手柄晶圆中(见图1b)。已经证明,具有预制腔体的定制SOI基底可以显著简化复杂MEMS器件的制造过程,例如压力或惯性传感器[2,7–10]。腔体-SOI基底允许在后续工艺中消除在手柄层中刻蚀腔体的繁琐步骤,并允许预图案化复杂的腔体系统。然而,腔体-SOI晶圆中的腔体尺寸范围是有限的。一方面,未用支柱支撑的非常大的腔体会使晶圆变得脆弱,并可能导致晶圆或设备层的变形。另一方面,由于预制腔体与设备层上后续制造的结构的对准精度较低,腔体-SOI无法处理非常小的埋藏结构。
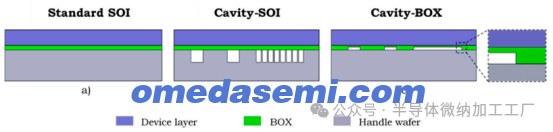
图1. 三种基底架构的比较:(a) 标准SOI基底;(b) 带腔体的Cavity-SOI基底。
Cavity-BOX是一种先进的基底,其在埋氧化物(BOX)层中刻有客户定义的腔体(见图1c)。它是SOI基底家族中的最新成员。本文介绍了其典型的制备过程和应用。腔体可以通过刻蚀整个BOX层的厚度形成,或者通过部分刻蚀BOX来创建具有阶梯的硬刻蚀掩模。在Cavity-BOX基底中,只有薄层的埋藏硅氧化物被图案化,这使得腔体的设计几乎不受限制,同时不会削弱晶圆的机械性能。通过应用新开发的标记转移策略,确保了预制腔体与后续在设备层上制造的结构的高精度对准(<500 nm)。该方法使用一组位于SOI晶圆平台上的主要对准标记,并通过前对前对准将其转移到设备层[11]。图案化的BOX可以在设备层薄化过程中作为停止层,并在从背面对设备层进行图案化时作为硬掩模。通过将由图案化BOX层形成的硬掩模直接接触设备层,维持了深反应离子刻蚀(DRIE)过程的高分辨率。这允许在设备层中精确定义微米级腔体,同时使设备层中厘米级结构的图案化成为可能。本文展示了Cavity-BOX基底的创新,并说明了这种基底如何改善各种MEMS器件的制造。通过将Cavity-BOX用作停止层和埋藏硬刻蚀掩模,本文通过应用其制造深脑刺激(DBS)示范器来进行演示。首先,介绍了这种DBS器件的设计和标准制造过程,并与使用Cavity-BOX的过程进行了比较,展示了Cavity-BOX基底如何使更多的设计自由度成为可能,并简化制造过程。接下来,描述了定制Cavity-BOX基底的制备过程以及DBS示范器的制造过程。DBS示范器是一种由仅硅岛和连接的聚合物基柔性薄膜组成的机械结构。最后,呈现并讨论了DBS示范器的制造结果。
2.深脑刺激(DBS)探针——工艺与设计
带有BOX腔体的先进SOI基底可以显著简化诸如高度集成的可折叠器件的微加工过程[4,5],或使用通孔(TSVs)在设备层中进行三维电路集成[12]。腔体-BOX应用的一个例子是可折叠深脑刺激(DBS)设备的单片制造过程。
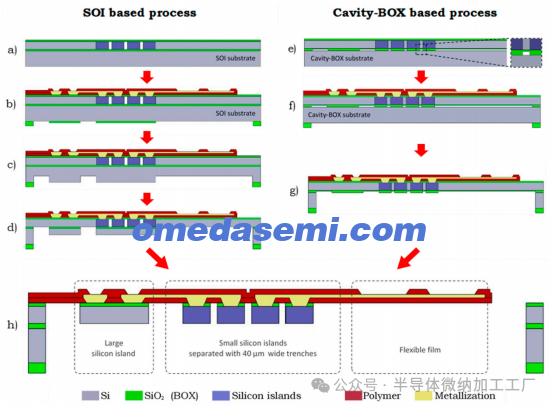
图2. 使用基于沟槽的F2R技术与使用腔体-BOX基底的半柔性DBS设备简化制造过程流程图。
左侧(a-d):基于SOI的工艺,在晶圆的正面密封沟槽,并使用两步背面刻蚀工艺。
右侧(e-g):基于腔体-BOX的工艺,使用图案化的BOX作为刻蚀停止层和硬刻蚀掩模。
底部(h):完成的设备。
最初,使用标准SOI基底和基于沟槽的F2R技术来实现器件的单片制造,其中小的80 µm厚的硅岛(以40 µm宽的沟槽分隔)可以与从晶圆背面刻蚀出的毫米级柔性区域共存[5,13]。由于背面DRIE工艺的分辨率限制,无法精确地分隔小的(210 x 2070 µm)硅岛。因此,使用基于正面刻蚀的硬刻蚀沟槽在设备层中分隔硅岛,随后用硅二氧化物膜封闭(图2a),以便进行进一步的晶圆处理(图2b)。然而,沟槽刻蚀和封闭工艺需要精确的优化,并且具有非常紧密的工艺窗口。此外,脆弱的SiO2膜的故障可能会严重阻碍后续工艺。
采用带图案化埋氧化物(BOX)的腔体-BOX基底(图2e)可以通过保持设备层在前侧处理结束之前保持完整,从而实现更加稳健的工艺(图2f)。所有结构随后通过背面DRIE刻蚀释放,使用腔体-BOX作为硬掩模。前侧处理完成后,DRIE刻蚀从晶圆背面应用于薄化并释放柔性结构。在标准SOI工艺中,这通过交替的硅二氧化物刻蚀和硅刻蚀的多个步骤实现,通过位于手柄晶圆背面的两步硬刻蚀掩模(图2c,d,h)。标准SOI晶圆的埋氧化物层作为刻蚀停止层,定义了设备的厚度。这种方法繁琐,并且在很大程度上依赖于每一步干刻蚀的均匀性。腔体-BOX可以通过将过程简化为仅三个步骤,显著简化该过程。首先,使用简单的硬刻蚀掩模在手柄晶圆的背面图案化,使用BOX作为刻蚀停止层,薄化设备至80 µm,平衡手柄晶圆刻蚀的DRIE均匀性(图2g)。其次,暴露的腔体-BOX与阶梯掩模一起被薄化,形成硬刻蚀掩模。最后,在最终的DRIE步骤中,使用在BOX中形成的硬掩模分隔80 µm厚的硅岛与40 µm宽的沟槽,同时释放柔性膜(图2h)。通过将硬掩模图案化的BOX直接接触到设备层,确保了DRIE过程的高分辨率,并确保具有广泛尺寸范围的结构能够共存,而不需要将DRIE过程优化到极限。
腔体-BOX基底的应用通过简化的18 mm长的深脑刺激(DBS)探针的制造过程得到了展示(见图3)。高度集成的DBS尖端设计为适应半膜基底上的40个圆形电极。小的硅岛可以包含预制的去耦电容器,而大的硅岛则允许在探针内进行焊线和后端集成应用特定集成电路(ASIC)(例如倒装芯片)。所有结构通过柔性互连连接。这使得能够单独激活每个电极,仅使用几根电源和信号线从探针中引出。由于由多个硅岛通过柔性膜连接而成的半柔性结构,设备可以折叠成一个1.4 mm直径的圆柱体(图4)。
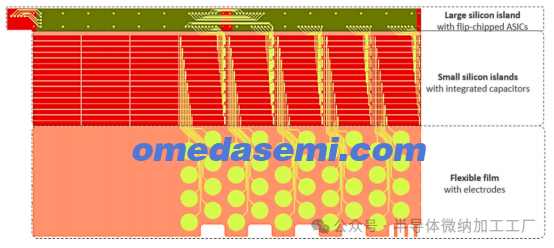
图3. 集成电子组件的40电极DBS设计的二维表示。大的硅岛(18 mm x 1 mm)可以包含倒装芯片的ASIC。小的硅岛(210 µm x 2070 µm)通过40 µm宽的沟槽分隔,可以容纳预制的去耦电容器。柔性膜包含40个柔性电极。

图4. 40电极DBS探针(直径1.4 mm)的3D模型,探针尖端内集成了电容器和ASIC。
3.制造
为了展示应用腔体-BOX在工艺中的优势,制造了DBS示范器。这里展示的DBS示范器是一个半柔性的机械结构,由硅岛和聚合物基柔性薄膜组成,没有互连或集成电子组件。
DBS示范器的制造可以分为两个部分:腔体-BOX SOI基底的制备和DBS示范器的制造。主要的技术挑战在于,必须保证埋藏腔体-BOX掩模与设备层上方结构之间的亚微米(小于1 µm)对准精度。为了克服这个问题,采用了C. Mountain等人提出并开发的对准标记转移策略[11],以确保结构的高精度对准。另一个目标是展示预图案化BOX掩模的功能性。
3.1.腔体-BOX制备
腔体-BOX基底制备的示意流程如图5所示。首先,使用380 µm厚的6英寸双面抛光(DSP)手柄晶圆作为起始材料。接下来,在晶圆的左右两侧各1.2 mm处图案化了两条140 nm深的ASML标记。然后,在晶圆的两面生长了1 µm厚的高质量热SiO2层,以用于晶圆粘接。定制的腔体-BOX图案与标记对准后,在SiO2层上进行干刻蚀,直达硅层(图5a)。然后,手柄晶圆与设备层进行融合键合,设备层上也有一层500 nm厚的热氧化层。融合键合在室温下的真空环境中进行。两个氧化物层被键合并融合成腔体-BOX,与预图案化的阶梯氧化物掩模结合(图5b)。最后,设备层被薄化至80 µm,并通过边缘修整和湿法刻蚀相结合的方式创建了一个宽度为4 mm的平台(图5c)。在此过程中,手柄晶圆上的对准标记被显现出来。
选择4 mm的平台宽度是为了确保设备层的边缘尽可能远离手柄晶圆上的对准标记,以避免在标记转移过程中可能出现的光学干扰。经过平台化工艺后,腔体-BOX基底完成制备。它包含一个图案化的阶梯埋氧化物层(其完整厚度为1.5 µm,阶梯厚度为500 nm)、一个80 µm厚的设备层,以及晶圆背面1 µm厚的热氧化物层。
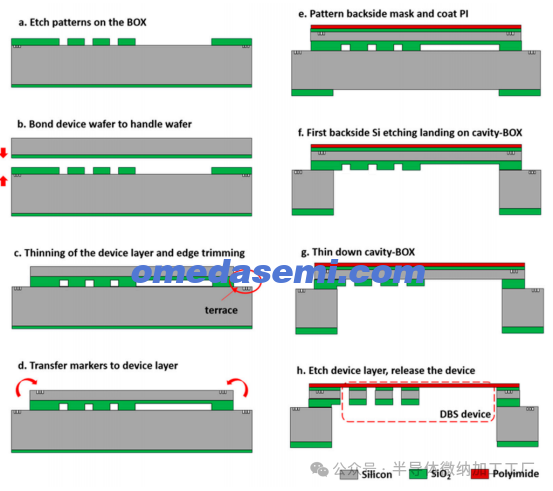
图5. 腔体-BOX基底制备和DBS示范器制造的横截面图示。
(a) 在距晶圆边缘1.2 mm的位置放置标记,并在380 µm手柄晶圆上方的BOX层中刻蚀图案。
(b) 在真空和室温下,将设备晶圆与带图案化BOX的手柄晶圆进行融合键合。
(c) 将设备层薄化至80 µm,并通过边缘修整创建一个4 mm宽的平台。
(d) 将标记从平台转移到设备层。
(e) 图案化背面刻蚀掩模,并使用硅氧化物作为粘合层,涂覆晶圆上的聚酰亚胺。
(f) 从晶圆背面刻蚀手柄晶圆并落在腔体-BOX上。
(g) 薄化腔体-BOX并暴露埋藏氧化物掩模,以便设备层刻蚀。
(h) 刻蚀设备层和硅氧化物粘合层,最终落到聚酰亚胺上。
3.2. DBS示范器制造
为了继续进行示范器的制造,首先将手柄晶圆上的标记转移到设备层,标记位置距离晶圆边缘10 mm,并在硅层中刻蚀深度为140 nm(图5d)。然后,在晶圆背面原有的1 µm厚的热氧化物层上方沉积了2 µm厚的PECVD SiO2层,并图案化为硅DRIE刻蚀掩模。接下来,在晶圆的正面沉积了500 nm厚的PECVD SiO2层,作为粘合层。随后,涂覆了3 µm厚的聚酰亚胺层(PI2610 Microsystems)在SiO2粘合层的上面(图5e),并进行固化处理。之后,应用硅DRIE刻蚀工艺,从晶圆的背面去除腔体-BOX下方的硅基底,该基底在阶梯氧化物掩模上方落下(图5f)。阶梯氧化物掩模使得硅的过刻蚀能够平衡晶圆上刻蚀的不均匀性。接下来,应用整体的SiO2干刻蚀工艺,薄化腔体-BOX层中的阶梯氧化物掩模,直到预图案化的氧化物掩模被刻开,暴露到设备层(图5g)。最后,干刻蚀80 µm厚的设备层和500 nm厚的用于聚酰亚胺粘合的SiO2层,直到设备层落到聚酰亚胺层上(图5h)。在设备层刻蚀完成后,所有硅岛被分隔开,并通过柔性聚酰亚胺膜连接。完成的示范器通过聚酰亚胺标签悬挂在硅晶圆框架中。
4.结果与讨论
基底制备和示范器制造过程都非常直接。平台边缘的对准标记成功地被检测并转移到了设备层(图5d)。然而,工艺中还有几个其他关键步骤。腔体-BOX的键合结果直接影响其功能性。在制备基底时,平台宽度引发了意外的兼容性问题。此外,背面DRIE刻蚀决定了最终设备的成型。在此,我们讨论了上述问题,并展示了已制造和组装的DBS示范器。
4.1. 腔体-BOX的制备
腔体-BOX是通过两个氧化物层的键合过程形成的:来自手柄晶圆的1 µm预图案化SiO2层和来自设备层的500 nm厚SiO2层,精度为300至500 nm(图5b)。键合过程中的潜在问题包括以下几点:
(1) 手柄晶圆上小氧化物特征的键合失败;
(2) 在大尺寸腔体区域内,手柄晶圆的硅基底与设备层的SiO2层之间发生不期望的键合;
(3) 由于BOX中的腔体,设备层表面出现凹陷。
在腔体-BOX基底制备完成后,设备层未观察到明显的凹陷表面。应用扫描声学显微镜(SAM)检查了键合质量,如图6所示。键合区域对声波的传输较强,显示为图片中的暗区,而空气间隙则对声波有较强反射,因此显示为亮区。图像表明,无腔体区域已成功键合,而大腔体区域未出现不期望的键合。在SAM图像中未观察到小氧化物特征的键合缺陷。随后,在背面刻蚀手柄晶圆并落到腔体-BOX上后(图5f),两步氧化物掩模保持完整,这也证实了优秀的键合结果。
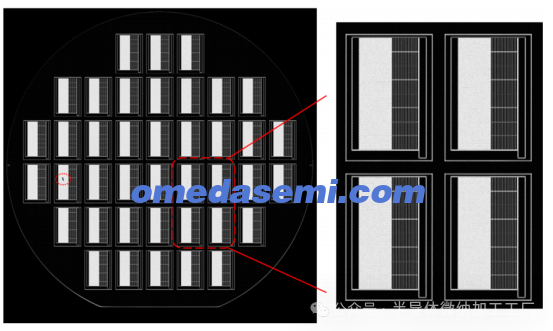
图6. 扫描声学显微镜(SAM)检查键合质量。左侧出现的一个粒子表现为黑色圆点,右侧为四个晶圆的放大SAM图像。
4.2. 平台宽度
在背面处理过程中,发现SOI晶圆正面4 mm的平台宽度导致与PAS5500 ASML晶圆步进机和SPTS Pegasus DRIE刻蚀工具的兼容性问题。在背面光刻过程中,晶圆步进机需要从正面处理晶圆。由于晶圆步进机机器人臂上几个真空垫的位置恰好位于4 mm平台区域,导致真空丧失。平台宽度过大会导致干刻蚀工具的吸盘出现氦气泄漏错误。为了继续处理4 mm平台腔体-BOX SOI晶圆,显式调整了晶圆步进机机器人的臂部,以便接受晶圆,并为硅和SiO2刻蚀开发了低氦气流的特殊干刻蚀配方。通过减少刻蚀配方中的氦气流量,导致晶圆在工艺中无法保持良好的温度控制,从而使晶圆的刻蚀速率不均匀增加。由于温度控制的丧失,刻蚀的坡度也增大。因此,平台宽度最好尽可能小,以提高洁净室兼容性。相反,平台边缘应尽可能远离标记,以避免与对准过程的干扰,这就要求较大的平台宽度。为此进行了折衷测试,以确定最佳的平台宽度。不同平台宽度的晶圆在标准6英寸洁净室工艺线上进行了测试,使用了PAS5500 ASML晶圆步进机、SPTS Pegasus、ICP和APS刻蚀工具。测试结果表明,平台宽度为1.8到2.5 mm应提供足够的兼容性。
4.3. 示范器的背面刻蚀
为了释放示范器并形成半柔性设备结构,从晶圆背面执行了几个刻蚀步骤。这些刻蚀步骤包括以下内容:
(1) 对腔体-BOX上的手柄晶圆基底进行DRIE刻蚀;
(2) 将腔体-BOX薄化以形成预图案化的氧化物掩模;
(3) 使用氧化物掩模刻蚀设备层和聚酰亚胺粘合氧化物层(图5f,h)。
图7a展示了背面硅刻蚀过程的第一步后,晶圆落在腔体-BOX上的情况。设备层被暴露的阶梯腔体-BOX保护。通过反射仪(Nanospec)测量了硅刻蚀后剩余的阶梯腔体-BOX的厚度。阶梯腔体-BOX的薄部分范围从120 nm到350 nm(原始为500 nm),较厚部分的范围为1150 nm到1380 nm(原始为1500 nm)。可以得出结论,第一次硅刻蚀成功落在腔体-BOX上,腔体-BOX作为刻蚀停止层发挥作用。图7b展示了经过第三步背面刻蚀后,刻蚀过的设备层的晶圆。由于刻蚀停留在晶圆正面涂覆的聚酰亚胺层上,较大的矩形开口是透明的。所有硅结构,包括硅岛之间的40 µm宽沟槽和定义硅框架的间隙,都得到了良好的制造。
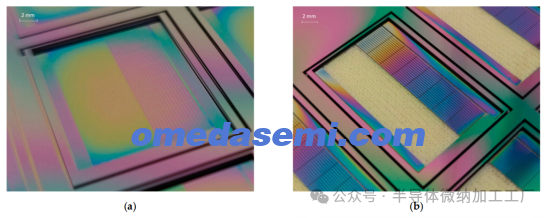
图7.(a) 背面刻蚀结果,硅基底落在腔体-BOX上。
(b) 使用图案化的腔体-BOX作为掩模刻蚀设备层,最终落在聚酰亚胺上。
图8展示了硅岛之间用40 µm宽沟槽分隔的SEM图像。小硅岛之间沟槽的顶部宽度为41.4 µm,而底部宽度为54 µm。测量结果表明,在设备层刻蚀过程中,每侧出现了6.3 µm的欠刻蚀,考虑到刻蚀深度仅为80 µm,这并不理想。大面积的欠刻蚀主要是由温度控制问题引起的,这些问题源自为在硅刻蚀机的吸盘上处理晶圆所需降低的氦气流量。对于具有兼容平台宽度的晶圆,使用标准DRIE工艺且无需修改冷却气流的情况下,可以获得更好的刻蚀轮廓。

图8.(a) 硅岛之间40 µm间隙的SEM图像。
(b) 80 µm厚设备层刻蚀轮廓的放大图,每侧有6.3 µm的欠刻蚀。
4.4. 示范器组装
制造完成后,示范器被取出并放置在硅框架外(见图9)。该示范器由一个大的硅岛组成,用于容纳ASIC,一个大柔性膜,以及128个小硅岛,这些硅岛之间有40 µm的间隙,还有一个用于处理的硅岛。在最终的DBS设备中,每个小硅岛上都放置了去耦电容器,而电极则放置在柔性聚酰亚胺膜上。在组装过程中,ASIC的硅岛通过双面胶带与一根薄金属线粘接。金属线和硅片一起缓慢旋转,将半柔性设备紧密地包裹成一个圆柱形探针。图10中,组装后的示范器长度为18 mm,直径为1.2 mm,这与DBS设计一致。
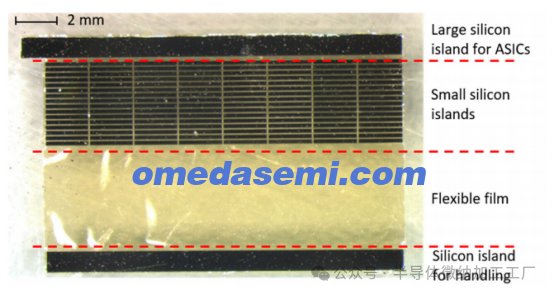
图9. 制造完成后的DBS示范器。所有80 µm厚的硅岛通过柔性膜连接。小硅岛通过40 µm宽的间隙隔离。

图10. 将DBS示范器包裹成一个圆柱形探针,长度为18 mm,直径为1.2 mm。
5. 结论
开发、制备并应用了具有埋氧化物掩模的先进腔体-BOX SOI基底,用于半柔性微制造设备的工艺。首先在手柄晶圆上制造氧化物掩模,然后与设备层上的氧化物层结合,形成腔体-BOX。通过采用前对前标记转移策略,成功实现了设备层结构与埋氧化物掩模之间的对准。将先进SOI基底应用于DBS示范器的制造中。腔体-BOX层作为刻蚀停止层和预图案化的两步DRIE掩模,用于从晶圆背面刻蚀设备层。这种两步氧化物层成功地补偿了在去除硅的过程中刻蚀速率的差异。腔体-BOX基底在DBS示范器制造中的应用证明了更稳健、显著简化的工艺,并提供了更大的设计自由度,包括高精度微米级特征和大毫米级开口的共存。成功制造并组装了长度为18 mm、直径为1.39 mm的半柔性DBS示范器。腔体-BOX SOI基底在需要设备薄化和精确硅结构分离/定义的各种MEMS设备制造中具有巨大潜力。具有1.8 mm到2.5 mm平台宽度的腔体-BOX SOI基底与标准洁净室设备兼容,可用于前后处理工艺。该平台宽度还允许应用BOX图案和设备层结构的高精度(小于500 nm)对准策略。根据设计需求,定制的腔体-BOX SOI可以由商业SOI供应商大规模提供,从而广泛地支持生产规模的扩大。