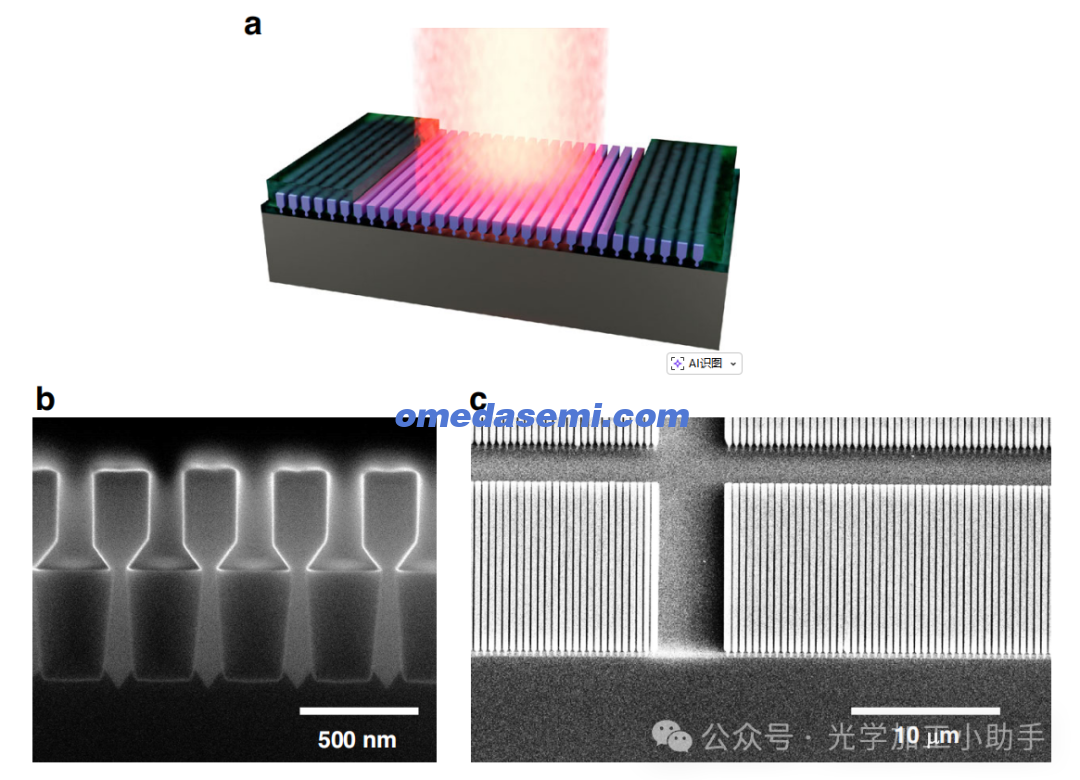
摘要
利用纵横比诱捕(ART)和纳米脊工程(NRE)在硅片上外延生长高质量的InGaAs/GaAs纳米脊为硅上激光源的单片集成开辟了道路。此项突破具有重要的潜力,推动了集成硅光子学的发展,能够支持广泛的应用并开辟新的研究方向。在这种方法中,活性材料不是作为均匀层生长,而是作为平行纳米脊(NR)阵列。通过利用NRE的这一内在特性,我们提出了一种实现表面发射激光的新方法,并展示了该设备的首次实验演示。该设备由一组纳米脊阵列组成,形成一个平面腔体,可以激光并垂直耦合光。基于广泛的设计研究,我们展示了集成在300毫米硅片上的光泵浦表面发射外延生长的纳米脊激光器(NRSEL),据我们所知,这是首个此类设备。我们通过利用对称保护的连续体束缚态(BICs)在光子晶体带边实现了激光发射。此外,我们还对远场模式进行了详细表征。这些发现为实现高密度、集成化且具有成本效益的电注入表面发射激光器在硅上的实现奠定了基础。划重点--销售晶圆和加工
SOI晶圆:--220nm薄膜/ 3um厚膜-3umSIO2-675um
ALOOI晶圆;--氧化铝薄膜晶圆,键合工艺和镀膜工艺
TAOOI晶圆--氧化钽薄膜晶圆,镀膜工艺
SINOI晶圆--超低损耗氮化硅薄膜晶圆,210nm-300nm-400nm-800nm
SICOI晶圆;新型量子光学平台500nm-700nm-1um
8寸LTOI晶圆批量供应;铌酸锂的有力的竞争对手,薄膜钽酸锂晶300600
6寸X切Z切掺镁薄膜铌酸锂晶圆 ,厚膜 3um 5um 和 薄膜 100-600nm
8寸LNOI晶圆;8寸LNOI助力更大规模薄膜铌酸锂产品量产
LN/LT-SOI/Si/SIN W2W&D2W异质集成
流片: 6寸 氮化硅 铌酸锂 硅光 超高性价比流片, 1个BLOCK的价格买一整片晶圆
划重点--全国产-超高性价比-6 寸硅光-氮化硅-铌酸锂流片白皮书
我们为客户提供晶圆(硅晶圆,玻璃晶圆,SOI晶圆,GaAs,蓝宝石,碳化硅(导电,非绝缘),Ga2O3,金刚石,GaN(外延片/衬底)),镀膜(PVD,cvd,Ald,PLD)和材料(Au Cu Ag Pt Al Cr Ti Ni Sio2 Tio2 Ti3O5,Ta2O5,ZrO2,TiN,ALN,ZnO,HfO2。。更多材料),键合(石英石英键合,蓝宝石蓝宝石键合)光刻,高精度掩模版,外延,掺杂,电子束光刻加工光子晶体等产品及加工服务(请找小编领取我们晶圆标品库存列表,为您的科学实验加速。
请联系小编免费获取原文

文章名:One-dimensional photonic crystal nano-ridge surface emitting lasers epitaxially grown on a standard 300 mm silicon wafer作者:Eslam M. B. Fahmy1, Zhongtao Ouyang1, Davide Colucci 2, Nicolas Le Thomas 1, Joris Van Campenhout 2, Bernardette Kunert 2 and Dries Van Thourhout 1单位:1.Photonics Research Group, Department of Information Technology (INTEC), Ghent University - imec, Ghent, Belgium2.imec, Kapeldreef 75, 3001 Heverlee, Belgium
引言
垂直腔面发射激光器(VCSELs)目前是最广泛使用的光电子设备之一。这些紧凑型激光器广泛应用于数据通信,也被用于消费类应用,如光学鼠标和智能手机中的面部识别和测距等。VCSELs由复杂的垂直层叠结构组成,包括底部的DBR镜面、增益区和顶部的DBR镜面。它们可以在晶圆尺度上制造和测试(通常使用GaAs基底),一般来说,成本较低。然而,它们仍然面临一系列问题。VCSELs需要复杂的外延生长。镜面通常由10到40层不同的层组成,必须以高精度生长。只能使用有限的几个波长(最常见的是850 nm和980 nm),因为这些波长是可以相对容易生长高效DBR镜面的波长。转换到其他波长(例如1300 nm、1550 nm、MIR)非常具有挑战性,并且应用不广泛。另一个挑战是,在同一晶圆上生长多波长VCSELs,因为发射波长由生长过程决定,且在晶圆上无法轻易控制地变化。与其他光子或电子设备的单片集成较为困难,通常也未进行。
纵横比诱捕(ART)和纳米脊工程(NRE)技术使得可以直接在硅基底上生长具有低缺陷密度的高质量活性材料(缺陷密度小于6×10⁴ cm⁻²),且无需厚缓冲层。之前,我们基于这项技术实现了光泵浦的DFB激光器和PIN探测器。最近,研究报道了室温下电注入连续波激光器,通过利用基模和高阶模之间的模式拍频来减轻与电接触相关的损失。活性材料不是作为均匀层生长,而是以纳米脊的形式生长,并按阵列排列(见图1)。这些阵列可以被视为一个高折射率对比的光子晶体,支持一系列光学模式。在本文中,我们展示了通过精心设计不同的设备参数,可以在纳米脊阵列上支持慢光(带边)模式,形成驻波,提供足够的反馈以实现激光发射。
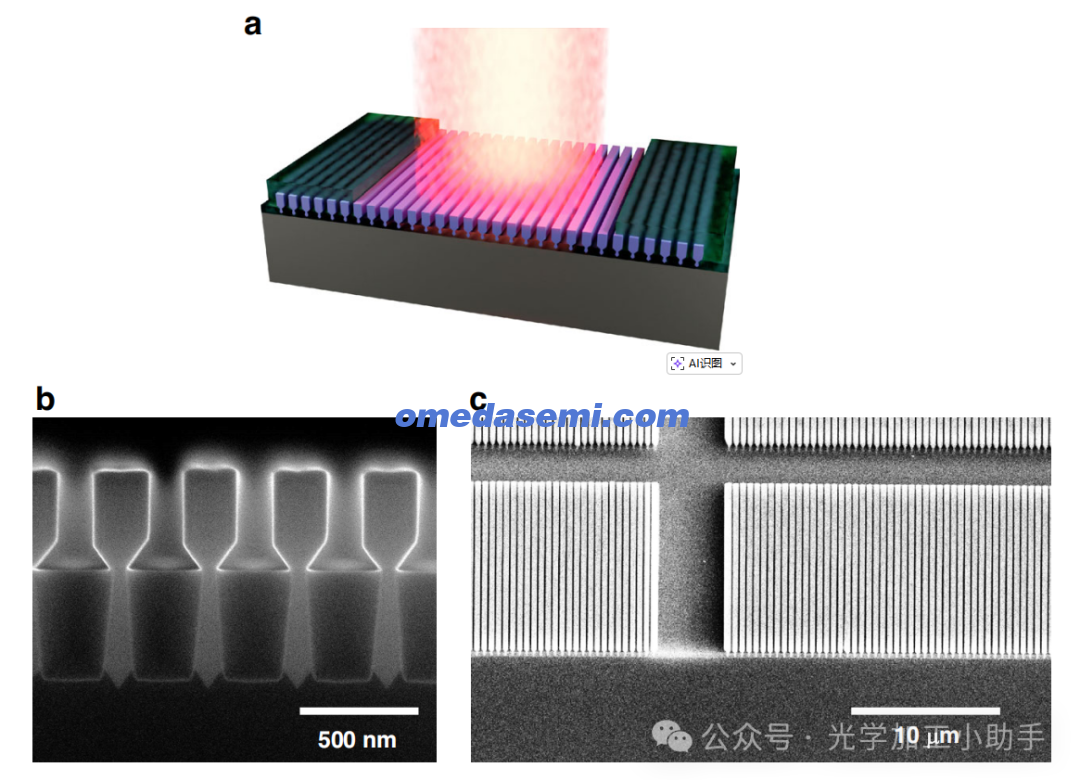
图1 硅上的NRSEL
a 提出的纳米脊表面发射激光器(NRSEL)的示意图。
b 扫描电子显微镜(SEM)图像,显示了切割后的纳米脊阵列的横截面。
c 硅片上纳米脊阵列的顶视SEM图像。
基于纳米脊的表面发射激光器(NRSEL),如图1a所示,具有许多优势。首先,与需要数微米厚度的顶部和底部DBR镜面的VCSELs相比,生长时间大大缩短。其次,发射波长可以通过改变阵列的周期、纳米脊的尺寸,或者在后处理过程中通过沉积额外的材料(例如硅氧化物、铝氧化物或铪氧化物)来调节。第三,使用具有略微变化周期的阵列使得在单个芯片或晶圆上创建多波长激光阵列成为可能,而材料成分的变化则可以针对不同的波长范围。此外,光子晶体的高折射率对比促进了模式间的分离,确保在增益带宽内主导单一模式,从而确保单模操作,不会有竞争模式。这些优势使得纳米脊技术成为实现广泛可调、成本效益高且兼容CMOS的表面发射激光器的有前景平台。
在这项工作中,我们首先解释了设备的基本工作原理。接下来,我们研究了不同设计参数及其对设备性能的影响。我们还简要讨论了纳米脊外延生长过程和激光腔体的定义。最后,我们展示了实验结果,这些结果来自光泵浦的基于纳米脊的表面发射设备。我们研究了阈值行为与腔体尺寸的关系,并讨论了光谱特性。与数值计算的比较允许我们将观察到的峰值与带图中的相应带边模式进行匹配。我们还研究了发射模式及其通过背焦平面成像的发散情况。
结果
带边激光发射
纳米脊阵列(图1b, c)可以被视为一个高折射率对比的一维光子晶体,天生支持多个光学模式。材料的折射率和折射率对比在确定带隙方面起着至关重要的作用。此外,纳米脊结构的高度决定了支持的模式数量。高度的增加会导致更多带的出现,增加带图的复杂性。光子晶体的周期性和填充因子也会影响模式的频率。值得注意的是,减少周期会使带向更高频率移动。
为了系统地跟踪感兴趣的光学模式,采用了结构化的命名约定。出现在带边的模式(带边模式)被表示为TExyz,并根据布拉格阶次(x)、带数(y)以及它们相对于带隙的位置(z)进行分类,指示它们是主要局限在介质区域(低带(L))还是空气区域(高带(H))。我们关注的是准TE模式,这些模式的电场主要沿纳米脊方向取向,因此位于量子阱(QW)的平面内。众所周知,嵌入在GaAs纳米脊中的压应变InGaAs量子阱为这种极化提供了最高的增益。
图1a, b 显示了纳米脊阵列的示意图以及为周期Λ = 380 nm、高度H = 410 nm、宽度W = 197 nm的纳米脊阵列计算的带图。这些尺寸选择是为了匹配我们制造样品中波导的平均尺寸,尺寸通过扫描电子显微镜(SEM)测量获得。关于材料和仿真细节的更多信息可以在方法部分找到。带图是使用二维有限差分时域(FDTD)仿真计算的,采用布洛赫边界条件。
带图展示了显著的模式分离,这源于光子晶体中空气和介质部分之间的折射率对比。高折射率对比的另一个结果是带的平坦化(减少了色散曲率),尤其是在带边附近。在带边,慢光布洛赫模式(SBM)在结构内部传播,群速度dω/dk趋近于零,这是由于平坦的色散曲率。这个现象可以归因于由结构中对称点处的折射率调制——GaAs和空气——所引起的反射波的叠加。
我们对高对称性Γ点(kx = 0)处的模式感兴趣,因为这些模式可能与垂直发射的辐射模式耦合。在图1c中,展示了Γ点处前两个带边模式TE21L和TE22L的模式剖面。两种模式主要局限在高折射率介质区域,因此通常被称为介质模式。通常,预期任何其色散线位于光线以上的模式——即,在频率–波矢区域中,它可以与自由空间平面波耦合——会辐射出去,因此具有有限的寿命。然而,并非所有位于光线以上的模式都会实际耦合到自由空间辐射。一些模式保持完全局限,因为它们是对称保护的。结构对称性(如镜像对称性或旋转对称性)可以禁止模式与辐射通道的耦合,有效地防止这些模式泄漏到远场。因此,尽管它们位于辐射连续体中,这些模式仍然可以表现出非常高甚至理论上无限的品质因子。这些模式被称为连续体中的束缚态(BIC模式),其特征是高Q因子。在完美且无限的纳米脊光子晶体中,TE21L被认为是BIC模式,尽管它位于光线之上,由于模式电场的非对称性(如图1c所示,电场在纳米脊中间有一个节点),它不能与辐射模式耦合。实际上,光子晶体是有限的,这导致平面内波矢的不确定性,因此会破坏对称性,允许垂直发射。对于我们高度为410 nm的纳米脊,还支持两个高阶BIC模式TE22L和TE23L。它们出现在更高的能量上,并具有与TE21L相同的场反对称性,这使得TE21L成为一个BIC模式。由于这种对称性保护仅在Γ点严格成立,因此即使是平面内波矢的微小偏移也会降低所有三个模式的局限性。因此,这些BIC模式表现出明显的平面内波矢依赖性:当从Γ点远离时,它们的Q因子急剧下降,而第一个有损(对称)模式的Q因子对平面内波矢的依赖性较弱。补充信息中展示了前三个BIC模式(TE21L、TE22L和TE23L)与第一个有损模式(TE21H)在Q因子色散和对应模式剖面的并排比较,见图S1。
无限阵列的纳米脊尺寸效应
为了优化纳米脊的设计,我们集中研究了Γ点处工作的TE21L模式,因为它与纳米脊中的量子阱具有最大的重叠。其次,纳米脊的尺寸和周期需要选择,使得该模式的共振频率与量子阱增益峰值相匹配,大约在1000 nm左右。图2a显示了该模式的共振频率如何随着周期、填充因子和高度的变化而变化。填充因子定义为纳米脊宽度与周期的比值,FF = W/Λ。带边模式的共振频率从带图中提取。仿真使用了二维有限差分时域(2D-FDTD)方法,并采用布洛赫边界条件。显然,阵列的周期对共振频率的影响最大。纳米脊宽度,因此填充因子,也有很强的影响。纳米脊高度的影响较小。高度变化0.4–0.6 μm使得共振频率仅变化约25–30 nm,而将宽度从152 nm调节到304 nm则使共振频率变化大约375 nm,变化幅度大约大一个数量级,因此,纳米脊宽度和周期性是主导参数。可用的掩模(见:制造部分)只提供了固定数量的阵列设计,其中周期为Λ= 380 nm的设计最适合我们的设备设计。图2b显示,使用该周期时,可以通过控制纳米脊的高度和宽度,在量子阱增益带宽(大约从980 nm到1060 nm)内的任何位置变化发射波长。
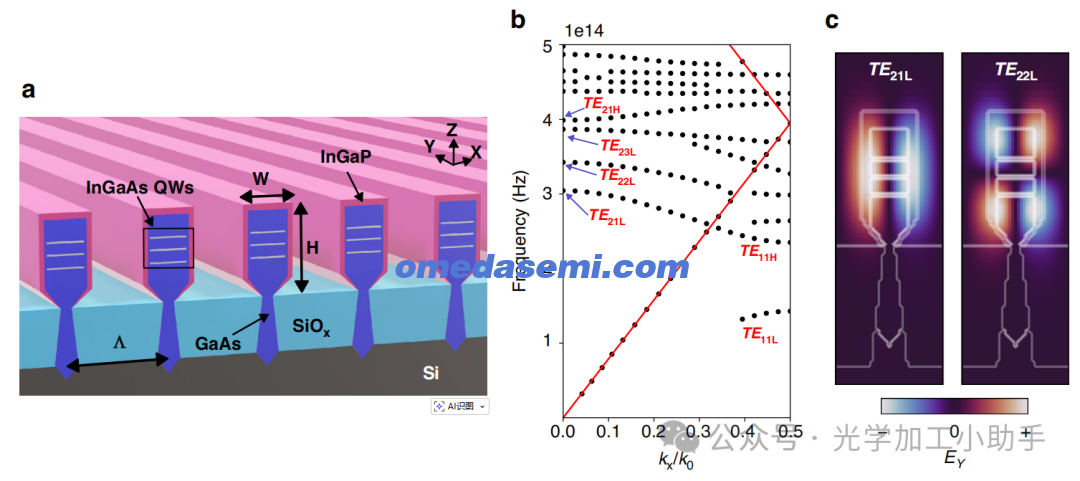
图2 纳米脊一维光子晶体
a 展示了一个纳米脊阵列的示意图,其中标出了最相关的尺寸参数。
b 使用2D-FDTD计算的纳米脊阵列的色散图。辐射连续体位于光线之上(红色)。
c 计算得到的Γ点(kx/k0 = 0)处前两个带边模式的电场。
具有有限尺寸的纳米脊表面发射激光器(NRSEL)设计
在前一部分,我们考虑了一个无限尺寸的纳米脊阵列。尽管我们确实实现了准无限阵列的激光操作(参见图8和补充信息中的图S2、S3),但在实际应用中,我们希望保持尺寸的限制。
然而,减小NRSEL阵列的尺寸会对设备性能产生不利影响。减少周期数会导致局限性减弱和平面内光的泄漏。图3b清楚地展示了这一点,图中展示了一个包含40个纳米脊的阵列(Λ = 380 nm,H = 410 nm,W = 197 nm)的TE21L模式的2D FDTD仿真结果。图3c显示了该模式的Q因子如何随着纳米脊周期数的增加而增大,并在超过90个周期时趋于饱和,此时平面内的损耗变得可以忽略不计。由于模式增益阈值与Q因子成反比(Gth ∝ 1/Q),要实现较低的阈值需要较大的设备。通过在腔体两侧引入合适的镜面,可以克服这一权衡。一种可能的方法是通过两个带隙错位的光子晶体形成异质结构,如图3a所示。如果确保中央光子晶体的目标带边模式的频率落在周围光子晶体的带隙内,那么后者将充当镜面并减少平面内损耗。这种方法可以局部化模式,同时保持足够高的Q因子,从而实现低阈值激光发射。光子晶体带隙偏移的标准方法是改变其周期。然而,由于用于刻蚀纳米脊的可用掩模的限制,我们在这里选择了另一种方法。具体来说,通过在纳米脊之间沉积折射率高于空气的材料(如SiO2)可以将带隙频率向下偏移,如图3a所示。仿真结果表明,将纳米脊阵列嵌入1.5 μm厚、折射率为1.6的光刻胶层中,可以将TE21L模式的共振波长从984 nm偏移到1012 nm。
图3d显示了由一个包含40个未覆盖纳米脊的中央阵列和嵌入SiO2中的15个纳米脊镜面形成的腔体的模拟模式剖面。减少的横向泄漏、增强的局限性以及边界处的反射显而易见。增加镜面将Q因子从40周期设备的15,000提高到26,000。垂直发射增至20.7%,而没有侧面氧化物镜面时为约14.3%。增加底面镜面可以进一步提高垂直耦合功率。需要注意的是,向上辐射的电场在中心处有一个节点,这是由于上述TE21L模式的非对称性造成的。在未来的设计中,可以使用先前报告的策略来避免这一点,但这里不再进一步考虑。
制造
纳米脊外延生长
InGaAs/GaAs纳米脊是在300毫米图案化硅晶圆上通过NRE(纳米脊工程)外延生长的。该过程结合了选择性区域生长和纳米脊形状工程,以控制纳米脊的最终形状。选择性区域生长通过窄沟槽局部生长,利用纵横比诱捕(ART)将因大晶格失配产生的放松缺陷限制在沟槽内,而纳米脊形状工程则在沟槽外的生长过程中进行。该过程首先在(001)硅基底上通过浅沟槽隔离(STI)工艺形成Si鳍,这是一种在CMOS制造中常见的技术。然后,使用四甲基铵氢氧化物湿法刻蚀这些Si鳍,以暴露出后续III-V族材料生长所需的两个{111}硅面,避免反相位错乱。接下来,使用金属有机化学气相沉积(MOVPE)技术生长InGaAs/GaAs纳米脊。非常窄的沟槽防止了螺位错穿透到活性InGaAs量子阱层中。一旦材料超出SiO2掩模,精确控制生长参数可以得到如图4b所示的盒状形状,尺寸与模拟结果一致。为了提供光学增益,三层In0.23Ga0.77As量子阱嵌入在GaAs纳米脊中。我们估算了铟含量为23 ± 1%,量子阱厚度为11 ± 1 nm。为了改善载流子局限性并减少表面复合,InGaAs/GaAs纳米脊被镀上了与晶格匹配的InGaP层。纳米脊以5 mm × 5 mm的块状生长,在这些块中,沟槽大小和周期保持不变,确保良好的均匀性,如图4b, c所示。掩模设计包括多个沟槽周期,但从图2中的模拟结果可以发现,只有380 nm的周期与纳米脊的增益带宽匹配。通过聚焦离子束(FIB)铣削,制作了纳米脊阵列的横截面,并测量得出纳米脊的尺寸为H = 410 nm和W = 197 nm。这些尺寸被用于前面展示的带图和Q因子模拟中。为了定义局部化的NRSEL器件,进一步的加工步骤是必需的,如下一节所述。
图3 几何结构依赖的共振频率偏移
a TE21L模式的共振频率随着纳米脊阵列周期(Λ)和填充因子变化的变化,以及不同纳米脊高度(H)下的变化。
b 选择设计周期Λ = 0.38 µm时,随着高度(H)变化的共振波长(λ),对于不同宽度(W)的变化。
NRSEL定义
目标是定义具有受控尺寸的局部化纳米脊表面发射激光器(NRSELs)。为了简化过程并作为原理验证,我们使用光刻胶代替SiO2来形成镜面。所用的光刻胶(AZ 5214)折射率接近n = 1.6,并且可以使用标准光学光刻轻松地进行图案化。首先,在AZ5214光刻胶层中,通过光学光刻定义具有不同宽度和高度的NRSEL设备阵列。随后,使用SiCl4/N2基的电感耦合等离子体刻蚀(ICP RIE)工艺将图案化NRSEL外部的纳米脊材料刻除,如图5a所示。接下来的步骤是通过旋涂光刻胶(AZ 5214)定义镜面,然后通过光学光刻进行图案化。图5b显示了镜面部分的横截面,说明光刻胶在纳米脊之间提供了良好的填充。图5c是NRSEL阵列的显微镜图像,展示了最终的NRSEL设备。在设计中,侧面镜的宽度保持恒定为15 μm,而腔体宽度WNRSEL从15 μm变化到40 μm。腔体高度HNRSEL从5 μm变化到45 μm。
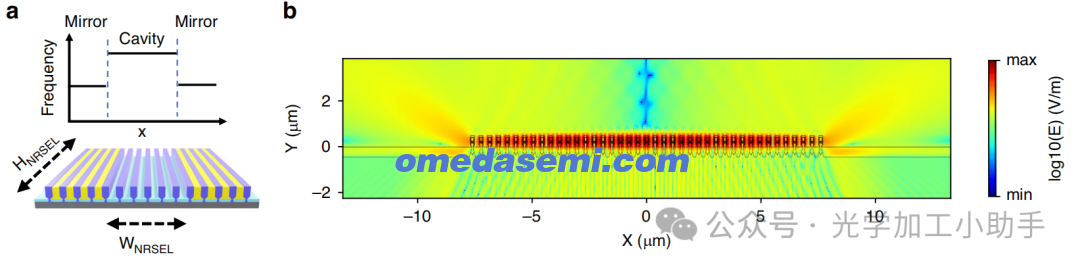
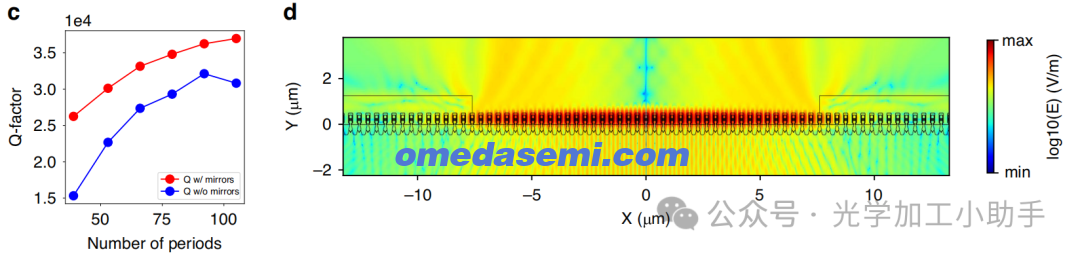 图4 布洛赫模式与侧面镜的局限性
图4 布洛赫模式与侧面镜的局限性
a 侧面镜通过局部地将慢布洛赫模式偏移到更长的波长来定义。这样在腔体中间形成一个屏障,增强腔内电场并减少横向损耗。
b, d 一维纳米脊晶体的2D FDTD仿真,展示了没有和有侧面镜的TE21L模式的横截面。侧面镜通过在纳米脊之间和顶部添加折射率为1.6的光刻胶形成。
c 计算的TE21L模式的Q因子,无侧面镜和有侧面镜情况下,作为周期数的函数。
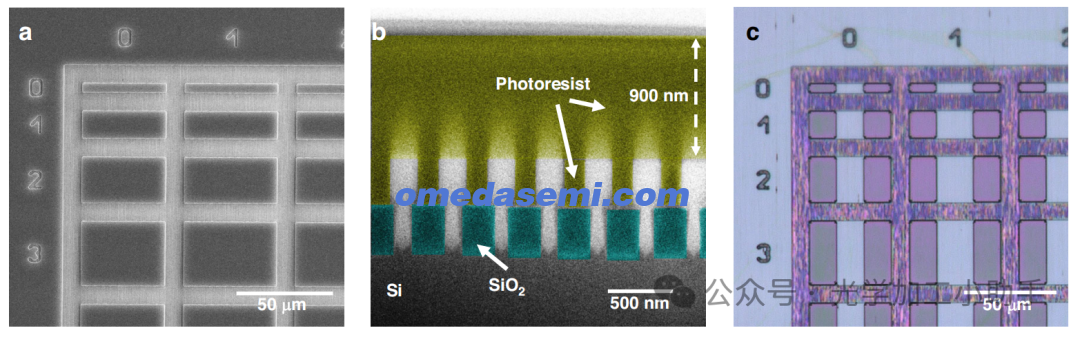
图5 NRSEL制造
a SEM图像,展示了在成功使用ICP刻蚀纳米脊材料后定义的NRSEL阵列。
b 假彩色横截面SEM图像,显示了使用光刻胶定义侧面镜后的结果,展示了成功的填充和覆盖,光刻胶高度为900 nm,位于纳米脊顶部。
c NRSEL定义和侧面镜开发后的光学图像。
测量
制造的样品使用微光致发光(μPL)光谱仪在室温下进行测量,泵浦源为532 nm纳秒脉冲Nd:YAG激光器。激光通过显微镜物镜(NA = 0.65)聚焦到300 μm直径的点上。来自器件的发射通过同一显微镜物镜收集,借助一个二向色镜,并通过光谱仪(KYMERA-328I-D2-SIL,Oxford Instruments,Andor)检测,该光谱仪配有两个传感器:一个水冷的InGaAs探测器(iDus,DU490A-1.7型,Oxford Instruments,Andor)和一个可见范围的CCD传感器(iDus 401,DU401A)。首先,我们详细表征了一个宽度WNRSEL = 20 μm、高度HNRSEL = 15 μm的NRSEL器件,测量了其在不同泵浦条件下的PL光谱,从中确定了其阈值泵浦密度和线宽。结果如图6a和b所示。然后,我们表征了31个不同腔体宽度的器件,以探索腔体宽度对激光阈值的影响,并将结果与前面展示的模拟Q因子进行比较(图6c–e)。最后,进一步研究了一个宽度WNRSEL = 35 μm的NRSEL器件和一个未图案化的区域,该区域可以视为准无限纳米脊阵列(图8c),并使用背焦平面(BFP)成像技术进行分析,这种技术也称为傅里叶平面成像(图8d, e)。
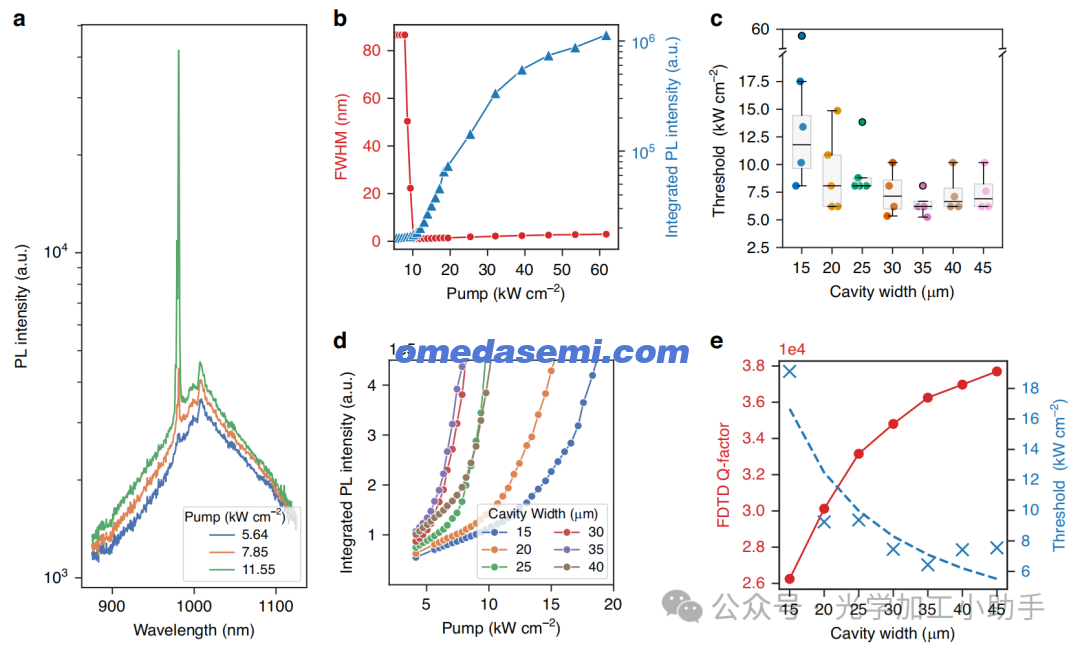
图6 室温光学表征
a 不同泵浦强度下,宽度WNRSEL = 20 µm的NRSEL的PL光谱。
b 宽度WNRSEL = 20 µm的NRSEL的积分PL和线宽作为泵浦功率的函数。线宽在阈值时达到最小值0.9 nm。
c 在同一样品中,31个设备的激光阈值与腔体宽度的关系。每个散点代表一个设备的阈值,而覆盖的箱形图总结了不同腔体宽度的阈值的统计分布。每个箱形图中的黑色实线表示数据的中位数值。
d 放大显示一组六个不同宽度的NRSEL的积分PL,展示了腔体宽度增加时阈值的降低。
e 使用倒数函数a/(WNRSEL)+b拟合阈值数据。散点(蓝色)表示平均阈值,计算得到的Q因子(红色)用于对比。
激光表征
图6a展示了在不同泵浦条件下,WNRSEL = 20 μm的NRSEL的测量光谱。在低泵浦强度下,观察到一个宽广的自发辐射光谱。随着泵浦功率的增加,激光峰值(λ = 984 nm)出现。图6b显示了在激光峰值附近测量的线宽和积分PL强度作为泵浦功率的函数。激光阈值通过在积分PL信号的线性区域拟合与下轴(泵浦功率)交点来计算。对于该设备,阈值泵浦密度为10.8 kW cm⁻²。最窄的线宽出现在阈值稍上方,测量值为0.9 nm。我们认为线宽受脉冲光泵浦的限制。
图8a展示了WNRSEL = 20 μm的NRSEL在激光阈值以上的光学泵浦下的显微镜图像。泵浦光通过二向色镜被滤除。请注意,泵浦光斑比腔体的尺寸大得多。图像清晰地显示了光模式在由光刻胶镜面定义的中央腔体内的局限,表明成功制造。发射光是高度偏振的,电场与纳米脊轴线的夹角小于20°。这确认了模式是垂直于纳米脊传播的,而不仅仅是源自纳米脊上下表面的反射。更多细节将在补充信息(S5)中讨论。对于该设备,还可以看到来自镜面区域的局部光发射。此发射出现在较高的泵浦功率下,并且是未预期的,因为镜面区域的折射率对比度较低,且与中央腔体相比宽度较小,这应该导致更高的损耗和较低的Q因子。这种效应并非在所有腔体中都观察到:例如,对于图8b中展示的WNRSEL = 25 μm的设备,仅观察到来自中央腔体的发射。因此,我们认为这与纳米脊尺寸的变化和缺陷有关,这些变化可能导致光发射在阵列的某些部分局部化。该发射的性质及其相关的SBM将在下面进一步讨论。
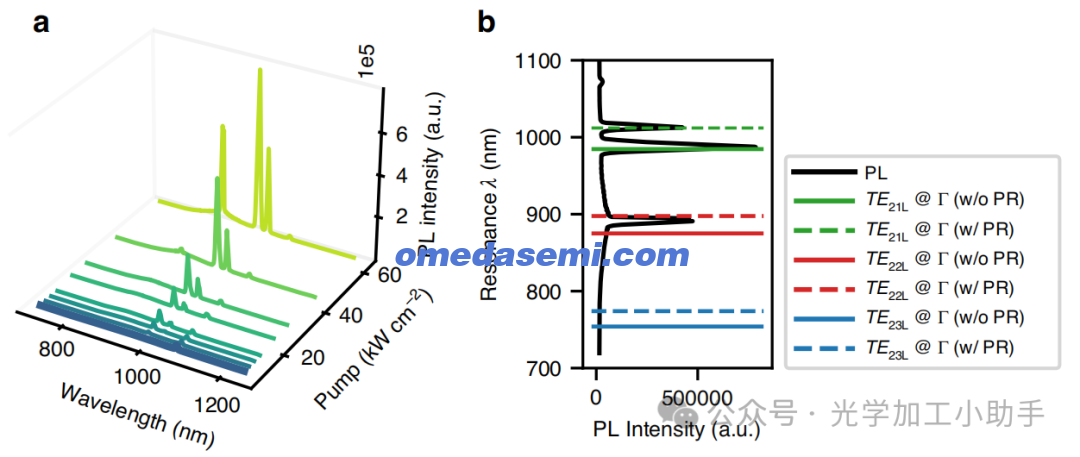 图7 NRSEL像素模式识别,WNRSEL = 20 µm
图7 NRSEL像素模式识别,WNRSEL = 20 µm
a 随着泵浦功率增加的PL光谱。在最高泵浦功率下,三个不同的峰值可见。
b 实验PL光谱与在62.4 kW cm⁻²泵浦功率密度下获得的实验结果进行比较,并与没有光刻胶和有光刻胶的纳米脊阵列在Γ点的带图中计算的TE21L、TE22L和TE23L模式的波长进行对比。
为了评估腔体宽度对器件激光阈值的影响,我们比较了一组腔体宽度从15到45 μm变化的器件。图6d显示了一组六个器件的相关光输入与光输出曲线,图6c显示了所有测量器件中阈值泵浦密度如何随腔体宽度变化。总共测量了31个设备。实验数据揭示了一个反向关系:当腔体宽度从15 μm增加到35 μm时,激光阈值急剧降低(最大下降63%)。然而,超过35 μm时,趋势略有逆转:激光阈值增加了大约14%。这一拐点似乎与模拟的Q因子饱和相吻合——尽管Q因子仍然从约36,300增加到37,700(如图6e所示),但开始趋于饱和。在这个区域,进一步增大腔体仅能带来Q因子的一些微小改进(大约增加4%)。阈值饱和可能表明随机无序效应的影响,因为较长的腔体光子晶体激光器在接近带边工作时通常会遭受更高的损耗(通常称为慢光引起的损耗)。值得注意的是,最小的激光阈值出现在腔体宽度为35 μm的器件上,并且这些器件表现出最小的阈值波动——这表明最佳的腔体尺寸最小化了制造引起的无序效应的影响。同一腔体尺寸器件的阈值波动可以归因于无序和尺寸的轻微变化。总体而言,虽然增加腔体宽度可以通过提高Q因子来降低激光阈值,但这些好处的实际实现对制造公差和无序效应非常敏感。
为了研究尺寸不均匀性,我们扫描了一个未图案化样品的700 μm区域的泵浦光斑(补充信息S3)。扫描结果显示,从样品的边缘到中心的波长发生了-35 nm的变化。单独的SEM测量显示,纳米脊宽度从边缘的216 ± 2 nm增加到中心的226 ± 5 nm。使用FDTD计算的灵敏度为每纳米宽度变化2.5 nm的光谱偏移,预计这种10 nm的尺寸变化会导致25 nm的波长变化。考虑到测量的不确定性,实验结果与模拟结果非常吻合。这些变化不仅会改变带边波长,还会影响腔体的Q因子,仿真表明变化约为34%。图8c显示了未图案化区域的实空间图像,展示了来自准无限纳米脊阵列的激光发射。
为了明确匹配激光光谱中可见的峰值与模拟带图中找到的模式,WNRSEL = 20 μm的NRSEL再次进行了表征,这次使用可见范围CCD传感器,以便测量短于900 nm的波长。结果如图7所示。如前所述,该设备显示了来自镜面区域和腔体区域的发射(见图8a),此处显示的光谱包括两个区域的光。随着泵浦功率的增加,首先在985 nm处出现一个峰值,随后在1010 nm处出现第二个峰值,最后在890 nm附近出现第三个峰值。在图7b、c中,这些实验结果与纳米脊阵列带图的FDTD仿真结果进行了比较,包括有无光刻胶的情况。图7b展示了高泵浦功率(62.4 kW cm⁻²)下测得的光谱,图7c显示了TE21L、TE22L和TE23L模式在Γ点的波长。
激光光谱中的第一个峰值(985 nm)与没有光刻胶的阵列的TE21L模式相匹配。该模式的计算Q因子为26,053(对于具有镜面的40个纳米脊的腔体)。第二个峰值(1010 nm)与带有光刻胶的纳米脊阵列的TE21L模式相匹配。通过使用光阑,我们确实可以将光谱中的这一模式与来自光刻胶区域的发射相关联。由于该模式的Q因子较低(9200),它在较高泵浦功率下出现。第三个峰值(890 nm)与较高阶的TE22L模式相匹配。该模式的Q因子相对较低,为4056。此外,其波长位于量子阱增益区之外。因此,我们怀疑该模式的增益来自GaAs纳米脊本身。需要注意的是,测量波长与模拟波长之间的小偏差可以通过纳米脊尺寸或折射率值的轻微偏差来解释。
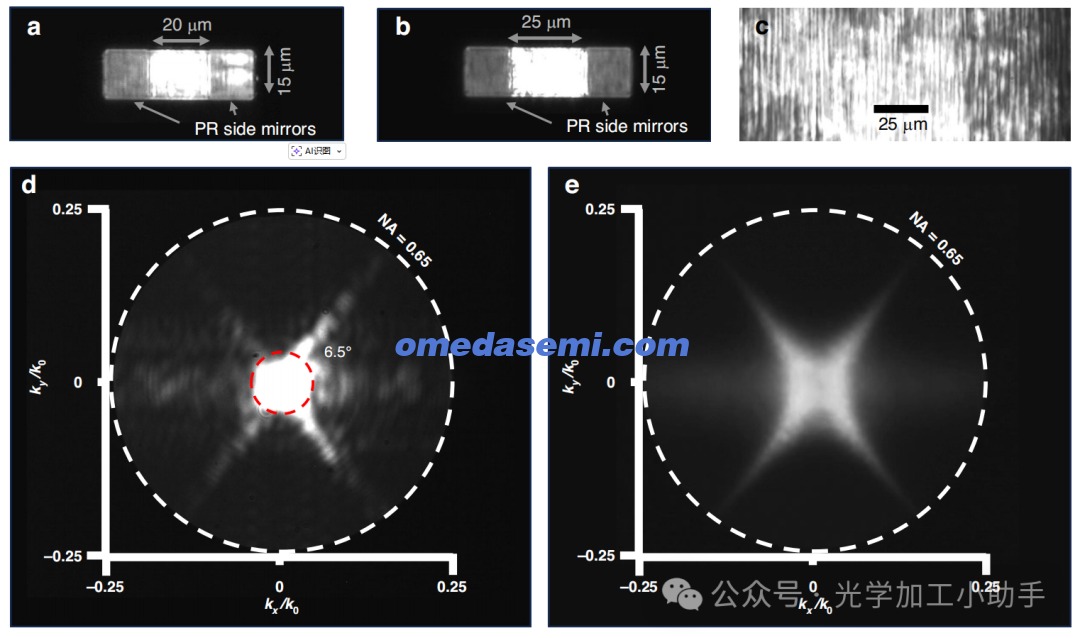
图8 实空间和傅里叶平面成像
a, b 在激光阈值以上的光学泵浦下,分别为腔体尺寸为20 µm和25 µm的器件的实空间图像。在20 µm的器件中,光主要局限于腔体内,尽管一些发射扩展到右侧的光刻胶镜面区域。相比之下,对于25 µm的器件,发射完全局限于腔体内,并在腔体与光刻胶侧面镜之间的界面处观察到明显的反射。
c 在激光阈值以上光学泵浦下的准无限阵列的实空间图像,展示了来自大面积纳米脊的发射。
d 对于25 µm器件,在激光阈值以上的背焦平面图像,显示了大约6.5°的角度发散。
e 在激光阈值以上的准无限阵列的背焦平面图像。
这些器件进一步通过背焦平面(BFP)成像进行了研究。物镜的BFP包含了关于样品平面发射光的角谱的信息。通过成像BFP,可以使用公式:k// = k₀sin(θ)将光子晶体发射光的角度分布映射到动量空间。因此,知道发射波长(k₀ = 2π/λ)和发射角度(θ)后,可以评估平面内的k矢量(k//),其中θ是表面法线与发射光传播方向之间的角度。这个映射对于理解光子晶体中的色散关系至关重要 。图8d和e分别显示了WNRSEL = 25 μm的NRSEL和图8b、c所示的准无限阵列的背焦平面图像,且均在各自的激光阈值以上。两个器件的发散角度均低于10°,反映了相对紧密的光束局限性。
图8d和e中展示的独特发射模式代表了三维色散面上的等频率等高线 (见补充信息S3)。在激光阈值以上,Γ点的强烈单色发射耦合到带图中相同频率的模式,导致观察到独特的星形发射模式。对于准无限阵列,发射模式清楚地展示了从3D带结构计算中也发现的典型星形模式(见图S3)。对于有限尺寸腔体,这种模式仍然可见,但现在由于镜面引起的散射,额外的k矢量分量被加入,如图3d所示。
讨论
我们介绍了一个新的概念,用于实现外延生长在沟槽图案化的300毫米硅晶圆上的表面发射纳米脊激光器(NRSEL)。这些器件在实验中展示了低至5 kW cm⁻²的激光阈值和单模操作。我们通过数值模拟展示了如何通过调整纳米脊宽度来调节发射波长,FDTD仿真预测其灵敏度为2.5 nm nm⁻¹。光致发光和SEM测量显示,从样品的边缘到中心,峰值波长发生了35 nm的偏移,纳米脊宽度变化了10 ± 5 nm,因此灵敏度为3.5 nm nm⁻¹,这证实了数值趋势。此外,远场模式也进行了深入表征。我们相信这些NRSELs在广泛应用中具有巨大潜力,可能克服了VCSELs在可访问波长范围和可扩展性方面面临的一些限制。由于它们直接集成在标准硅基底上,因此可以与其他光子设备甚至电子设备进行集成。通过改变材料成分,可以覆盖广泛的光谱范围。例如,我们之前已经展示了,通过修改铟含量为In0.45Ga0.55As,可以将发射波长移至1.3 μm。集成替代材料系统,如GaSb,甚至可能允许设计出在1.5 μm以上波长发射的激光器。最近,我们还展示了电注入纳米脊激光器,通过在纳米脊中引入p-i-n结。在该设备中,电流通过纳米脊顶部的钨插头和n掺杂硅基底注入,基于标准的Damascene工艺制造。从原理上讲,这种方法也应该适用于这里提出的NRSEL。然而,需要注意的是,不能扰乱模式剖面,也不能用顶部电极阻挡发射光。对于小型器件,初步仿真显示电极可以放置在侧面,同时确保均匀的电流注入。对于较大的设备,可以采用类似电注入单个纳米脊激光器的方案,其中插头位于光场的节点处,以避免过度的光学损耗。总之,我们提出并验证了一个新的、高度可扩展的垂直发射激光器概念,具有广泛的应用潜力,包括电信、激光雷达、环境传感和光谱学等领域。
材料与方法
数值仿真
带图和模式剖面是使用二维有限差分时域方法(Lumerical FDTD)计算的。为了模拟无限阵列的纳米脊,采用了一个单独的纳米脊,在周期性方向上应用布洛赫边界条件,并使用随机定向的偶极源激发。对于Q因子的计算,采用了有限阵列的纳米脊,并在两侧应用了完美匹配层(PML)边界条件,通过偶极源激发。仿真中使用的纳米脊尺寸是通过SEM测量得到的制造样品的平均尺寸:周期Λ = 380 nm,高度H = 410 ± 3.5 nm,宽度W = 197 ± 10 nm。对于GaAs和硅,使用了Lumerical材料库中的默认材料参数(E. Palik的《光学常数手册 I - III》)。对于InGaP层,使用了折射率为3.2193,侧壁的厚度为30 nm,顶部的厚度为60 nm。这些厚度包含在整体纳米脊的宽度和高度中。InGaAs的折射率为3.6339。SiO₂的折射率为1.4498。
外延生长
III-V族材料在商业化的300毫米单片MOVPE反应器中沉积,使用标准的金属有机前驱体,如三甲基镓(TMGa)、三乙基镓(TEGa)、三甲基铟(TMIn)、叔丁基砷烯(TBAs)和叔丁基磷烯(TBP)。GaAs的成核过程在360°C下进行,使用TEGa和TBAs,然后将生长温度提高到590°C,使用TMGa和TBAs进行GaAs沟槽填充。随后,温度设定为560°C,生长压应变的InGaAs/GaAs多量子阱堆叠,TMIn/TMGa+TMIn的比例经过调整,以实现大约20-22%的铟浓度。最后,温度升高到600°C,用InGaP层进行外延覆盖,铟含量为51%,确保其与GaAs晶格匹配。TBAs/III和TBP/III的比例在10到60之间变化,取决于材料和生长温度。
器件图案化
样品通过旋涂AZ 5214光刻胶制备,旋涂时加速为1000 RPM/s,旋转速度为4000 RPM,持续40秒,然后在100°C下软烘烤3分钟。烘烤后,光刻胶暴露在紫外光下30秒,定义所需的图案。暴露区域在AZ 400 K显影液中显影,显影液与水的比例为1:3,显影20秒以显现图案。此时,工艺可以继续进行ICP刻蚀以去除纳米脊,或者在此阶段停止以制造侧面镜。最后,在ICP刻蚀后,通过将样品浸泡在AZ 100光刻胶去除剂中,在80°C下处理10分钟来去除光刻胶。
光学表征
制造的样品使用室温下的微光致发光光谱仪进行表征。使用532 nm的纳秒脉冲Nd-YAG激光器作为光学泵浦源,脉冲宽度为7 ns,重复频率为1000 Hz。激光通过显微镜物镜(数值孔径NA = 0.65)聚焦到直径为300 μm的光斑上。来自器件的发射通过同一显微镜物镜收集,借助二向色镜,并通过光谱仪(KYMERA-328I-D2-SIL,Oxford Instruments,Andor)检测,该光谱仪具有两个传感器,分别位于不同的输出通道:一个水冷的InGaAs探测器(iDus,DU490A-1.7型,Oxford Instruments,Andor)和一个可见范围的CCD传感器(iDus 401,DU401A)。为了进行傅里叶成像,使用了额外的聚焦镜头,将显微镜物镜的背焦平面成像到单独的CMOS相机上。