本文小编分享一篇文章,本文介绍的是原子层镀膜在功率器件行业的应用,本文介绍了原子层镀膜技术在碳化硅功率器件和氮化镓功率器件中的应用,并介绍了原子层镀膜技术解决的问题以及这项技术的优越性。
划重点:
我们为客户提供晶圆(硅晶圆,玻璃晶圆,SOI晶圆,GaAs,蓝宝石,碳化硅(导电,半绝缘大量库存),多晶和单晶金刚石,Ga2O3,LNOI),镀膜方式(PVD,cvd,Ald,PLD)和材料(Au Cu Ag Pt Al Cr Ti Ni Sio2 Tio2 Ti3O5,Ta2O5,AlN,ZnO,TiN,HfO2,ZrO2,SrTaO3,MgF2,MgO,BaTiO3等),光刻,高精度掩模版,外延,掺杂,电子束光刻等产品及加工服务(请找小编领取我们晶圆标品库存列表,为您的科学实验加速。
ALD沉积:Al2O3,Ta2O3 HfO2,ZrO2,SiO2,TiO2,Si3N4,AlN,TaN等材料,TiO2沉积温度低至75摄氏度,8寸晶圆Uniformity1.5以内
优点:超优越的膜厚控制,超优越的保形性
PLD沉积:SrTiO3,BaTiO3,MgO
请联系小编免费获取原文,也欢迎交流半导体行业,工艺,技术,市场发展!

用于功率器件的 ALD
高电子迁移率和无与伦比的击穿场使得 GaN 和 SiC 等宽带隙半导体成为下一代功率器件的首选材料。然而,它们的界面存在一些缺点,包括界面陷阱密度高、电流泄漏和电压稳定性差。原子层沉积可以对新兴 GaN 和 SiC 器件以及传统 IGBT 进行无损伤表面处理,这对于获得最佳电气性能至关重要。
Process Options 工艺选项
Thermal ALD 热原子层沉积
Plasma-Enhanced ALD 等离子体增强原子层沉积
Materials 材料
Al2O3, AlN, SiO2, Si3N4, HfO2, Ta2O5, TiO2
Al 2 O 3 、AlN、SiO 2 、Si 3 N 4 、HfO 2 O 5 , TiO 2
Substrates 基材
GaN, SiC, Si 氮化镓、碳化硅、硅
3, 6, 8, 12″ wafers
3、6、8、12英寸晶圆
功率器件解决方案
ALD 工艺可沉积超薄且无针孔的薄膜,具有精确的厚度控制、高击穿电压和无与伦比的阶梯覆盖率。我们的批量制造集群工具具有热 ALD 和等离子 ALD 功能,为功率器件提供一系列薄膜解决方案,包括:
高k栅介质沉积
表面钝化减少界面陷阱
外延成核或种子层
晶圆级薄膜封装
GaN Power 氮化镓电源
氮化镓 (GaN) 因其高击穿强度、高电子迁移率和较低功耗而成为下一代功率器件的首选材料。在 Beneq,我们使用原子层沉积工作流程来减少界面陷阱并从 GaN 功率器件中获取最佳性能。
氮化镓 (GaN) 因其高击穿强度、高电子迁移率和较低功耗而成为下一代功率器件的首选材料。GaN 功率器件正在迅速取代低压应用中的传统硅基电子器件。高电子迁移率晶体管 (HEMT) 的电子传导效率比 Si 高出 1000 倍,并且可以制造得更小、成本更低。
降低 GaN 功率器件中界面陷阱 (Dit) 的密度
尽管GaN功率器件性能优越,但不稳定的界面GaOx会产生大量界面陷阱,从而显着降低器件性能。3 步原子层沉积工作流程,帮助您的功率器件发挥最佳性能(如下所示):
针对 GaN 表面的高效原位等离子体预清洗工艺,可去除原生氧化物并减少界面陷阱,同时将表面损伤降至最低。
氮化物界面层的 ALD 生长可创建具有改善晶格匹配的清洁 GaN-电介质界面。
通过 ALD 形成最终介电覆盖层,以防止界面层氧化。
适用于 GaN 功率器件的其他薄膜解决方案包括:
共形栅极电介质沉积
原子控制的表面钝化和封盖
高质量的成核层和缓冲层
用于封装的低温保形堆叠
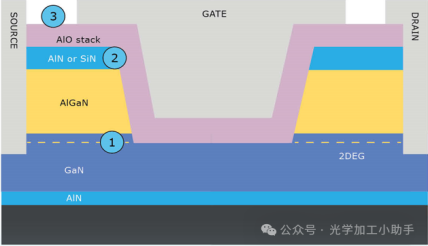
SiC Power 碳化硅电源
低导通电阻和高击穿电压以及其他性能规格使 SiC 功率器件成为高电压用途的首选材料,例如铁路和风力涡轮机的动力系统。通过 ALD,我们可以设计 SiC-氧化物界面,以提高 SiC MOSFET 器件的可靠性。
对于碳化硅功率器件,最大的可靠性问题在于与栅极氧化物的界面。目前,使用热氧化和 NO 退火来创建 SiO2 栅极电介质。然而,这个过程会导致界面充满缺陷,从而显着降低器件性能。
采用 3 步原子层沉积工作流程设计 SiC 接口,以实现 SiC MOSFET 器件的最佳性能。
针对 SiC 表面的高效原位等离子体预清洗工艺,可去除原生氧化物并减少界面陷阱,同时将表面损伤降至最低。
ALD 生长 SiO2 界面层,以创建干净、无缺陷的 SiC-电介质界面。
通过 ALD(电介质沉积)形成最终钝化层。
通过用高质量 ALD 制造的栅极电介质取代氧化工艺,所得器件具有更低的 Ron、更低的 Dit、更低的磁滞和更高的迁移率。