小编开键合专题的应用的专题 是为了广泛的调查,了解不同材料,不同键合方式的应用 ,从目前的应用来看,键合技术在mems行业是一个成熟的技术,但是新材料(si3n4-glass,Diamond-GaN,石英-石英,蓝宝石-蓝宝石等等)新工艺,新应用(光子集成线路异质集成等)的应用,层出不穷,因此分享前人做过的成熟的键合工艺,就显得十分重要,也希望能够给各位读者提供新的思路。同时,各种半导体产品的核心在于制造,pdk的p在d前面,工艺是设计的基础,能造出来的设计才是有意义的。
金-金热压键合优势:(工艺流程及细节详见下文)
a.金-金热压键合对键合表面的要求较低
b.能达到气密性封装的要求
c.且能实现引线结构
用于实现三维结构的典型键合有硅/玻璃、硅/硅、共品键合、及热压键合等,
硅-玻璃键合是在高压中(达到上千伏)作用下完成“,高电压是其应用的弊端;硅-硅键合需要1000 ℃以上的键合温度和非常清洁的表面",工艺要求很高:
共晶键合一般需要温度较低,目前常用的有AuSn、AlGe.Au-Ge、Au-n和CuSn共晶键合,共晶键合存在一些缺点,如,衬底和中间层有不同的温度系数,导致键合应力较大,会降低键合强度,需要附加的工艺过程来防止表面氧化",每一种键合工艺都有各自的优缺点,选择哪一种键合技术取决于应用领域及其要求.
金-金热压键合所需温度低,温度大于260 ℃即可,对表面要求也不高,同时不存在复杂的共熔物,控制较容易,在键合过程中,电连接和机械连接可以同时完成",金-金热压键合适合干气密性封装、圆片级键合、电气结构的连接制作,
通过金-金热压键合可以制作高宽深比的器件,对 MEMS 三维结构的加工制作具有重要意义.
其他特色键合工艺:
石英-石英玻璃键合 /蓝宝石-蓝宝石键合
玻璃与玻璃的熔融键合技术--根据时间、施加的力和热量评估玻璃与玻璃的熔接质量和强度
玻璃-Si3N4氮化硅键合
特色键合技术:氮化硅与玻璃的低温直接键合
Au-Si 金-硅共晶键合技术
键合技术--Au-Si MEMS 加速度计的金和硅共晶晶圆键合研究
关于我们:半导体微纳实验室
我们为客户提供晶圆(PI,PET,硅晶圆,玻璃晶圆,SOI晶圆,GaAs衬底,蓝宝石衬底,碳化硅衬底,金刚石衬底),镀膜方式(PVD,cvd,Ald)和材料(Au Cu Ag Pt Al Cr Ti Ni Sio2 Tio2 Ti3O5,Ta2O5。。。),光刻,高精度掩模版,外延,掺杂,电子束光刻等产品及加工服务(柔性叉指电极及微电极阵列,,掩模版等),请找小编领取我们晶圆标品库存列表,为您的科学实验加速。
请联系小编免费获取原文,也欢迎交流半导体行业,工艺,技术,市场发展!
金-金热压键合技术在MEMS中的应用
引言
微电子机械系统(MEMS)利用半导体的平面工艺从两维加工向三维加工发展,创新了微电子机械系统新的领域",在MEMS 期间的加工中,体硅工艺具有极大的灵活性,但与传统的半导体加工工艺不太兼容,利用键合技术可以克服这一缺点-31.
用于实现三维结构的典型键合有硅/玻璃、硅/硅、共品键合、及热压键合等,硅-玻璃键合是在高压中(达到上千伏)作用下完成“,高电压是其应用的弊端;硅-硅键合需要1000 ℃以上的键合温度和非常清洁的表面",工艺要求很高:共晶键合一般需要温度较低,目前常用的有AuSn、AlGe.Au-Ge、Au-n和CuSn共晶键合,共晶键合存在一些缺点,如,衬底和中间层有不同的温度系数,导致键合应力较大,会降低键合强度,需要附加的工艺过程来防止表面氧化",每一种键合工艺都有各自的优缺点,选择哪一种键合技术取决于应用领域及其要求,金-金热压键合所需温度低,温度大于260 ℃即可,对表面要求也不高,同时不存在复杂的共熔物,控制较容易,在键合过程中,电连接和机械连接可以同时完成",金-金热压键合适合干气密性封装、圆片级键合、电气结构的连接制作,本文对金-金热压键合过程及影响参数及结果进行分析,并介绍基于此键合工艺的THz波导和MEMS谐振器.
1键合原理及工艺过程分析
1.1键合原理
热压键合又称为扩散键合、压力键合、热压焊接、固态焊接等,是指两层金属,如金-金,在热和压力的同时作用下进行原子级的接触,在原子运动下,两层金属进行扩散运动,扩散的原子将两层金属连接在一起.这一扩散过程分为以下3步:1)表面扩散;2)晶界扩散;3体扩散.铜、金和铝由于具有高的扩散速率,适合于热压键合[8].在这3种金属中,铜和铝具有更好的延展性,
但铜和铝需要在高于400℃的键合温度下才能保证键合质量;同时,铜和铝表面极易氧化,在键合前需要对氧化层进行处理以保证键合效果.相对于铜和铝,金-金热压键合需要300℃左右的键合温度,同时金表面不形成氧化物,键合前的表面处理相对容易,更适合于做热压键合.
1.2金-金热压工艺过程分析
要保证金-金热压键合效果,使结构能够稳定、牢固的键合在一起以保证器件正常工作,一般需要几个步骤的处理,工艺流程图如图1.金-金热压键合的最终效果和每一步的处理过程有关,具体过程如下.
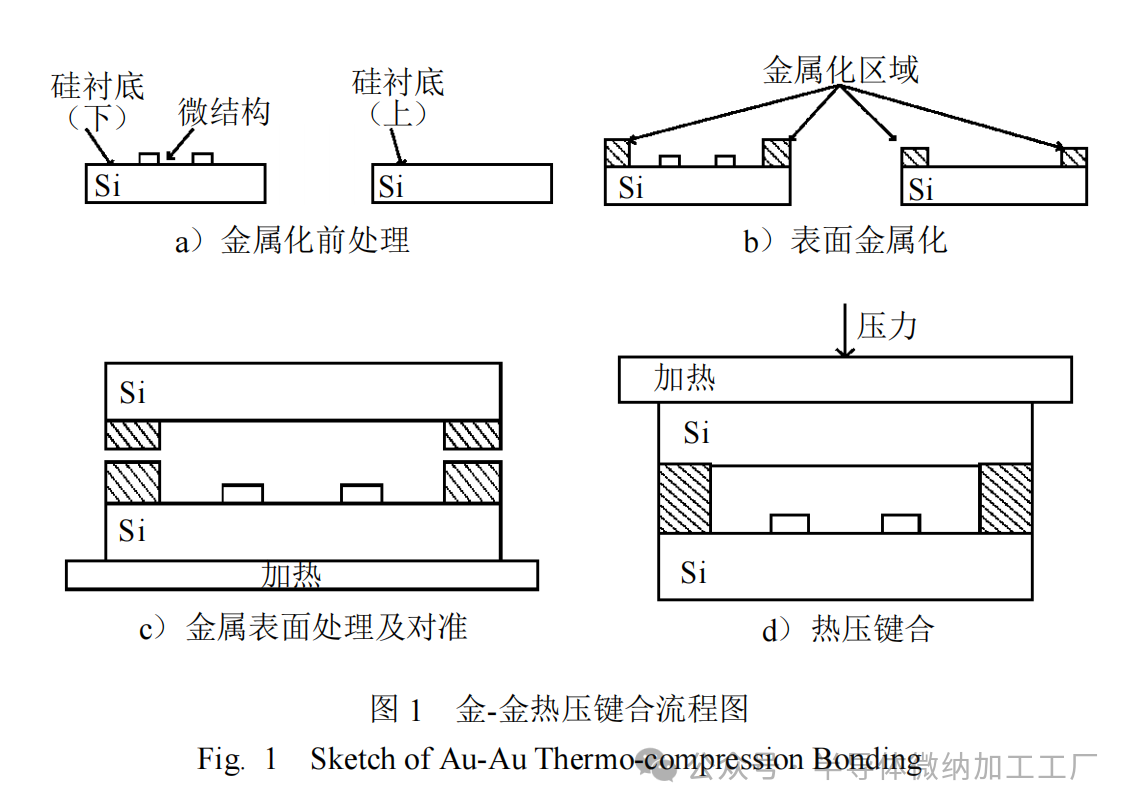
1)金属化前处理:为了使金属和硅片有较强的粘附强度,防止在后续的处理过程中金属层从硅片上脱落,硅片的表面必须干净并且有较好的界面状态.一般通过乙醇超声去除硅片表面的大颗粒及有机物等沾污,之后用去离子水冲洗;溅射前对材料进行等离子体扫射,以期达到好的界面状态,使溅射的金属和材料有良好的接触和粘附强度.
2)表面金属化:金-金热压键合的机理是金-金相互接触后在一定的压力和温度下通过扩散及熔融而结合在一起.溅射的金表面粗糙度较低,几千埃就能达到良好的键合效果.电镀的金表面粗糙度高,则需要上微米甚至更厚的金层.在金属化的过程中,由于溅射金和硅片的粘附性不好,一般以Cr或Ti作为粘附层,接着溅射Au层,根据不同的要求可以对溅射后的金再电镀加厚.若以Cr作为粘附层,需要考虑键合温度,在一定的温度下,Cr向金膜表层扩散,在高温下有多层金属膜的电阻率异常增大的现象[9],为了避免此种现象,若键合温度较高,可在Cr和Au的中间溅射一层Rt作为中间层.溅射或电镀的厚度要考虑工艺条件及器件的要求,可以根据实际情况来控制.
3)热压前表面处理及对准:金-金热压对键合表面的要求不是很高,但片子的表面质量对键合质量还是会产生很大的影响,局部颗粒的存在会是相当面积的键合失效.本文中的键合前处理分为3步:第1,硫酸和双氧水混合液的浸洗,通过这一过程可以去除片子在加工过程中引起的一些沾污,如汗液、光刻处理后的残胶等;第2,等离子体扫射,对片子表面界面有改善作用,使片子表面获得较高的表面活化能.第3,紫外光照射,紫外光中的短波紫外线能够深入材料表面细微部位,发生光敏氧化反应,生成可会发性气体,去除表面微小颗粒,达到衬底清除表面的目的[10].对于键合对准,根据键合图形的不同及对键合对准程度的要求,在版图的设计过程中可根据情况设计键合对准标记.
4)热压键合.金-金热压键合过程考虑的主要是温度和压力两个条件.温度越高,金越软,在一定的压力下,变形及扩散越强,键合效果越好;同样,在一定的温度下,施加的压力越大,表面在压力的作用下接触越好,键合效果越好.根据金属层的厚度和图形,选择一定的压力和温度,之后合理调节热压过程的升温、升压及降温、降压各个步骤的,可以达到高质量的键合,以此来实现MEMS器件的加工.
2金-金热压键合实验
金-金热压键合一般在真空或氮气环境下进行.通常的处理过程是在欲键合的两片硅片上溅射几十纳米的钛或铬作为粘附层,之后溅射一层金,根据不同的需求可以对金层电镀加厚,然后把两个硅片通过键合对准设备紧贴在一起,放入键合台中进行键合.采用无图形的两片硅片进行初步的键合实验,两片4吋硅片经过超声处理和等离子体扫射后溅射薄层铬、铂和金,之后电镀加厚金层,金属表面洁净处理后,采用苏斯公司的MA6/BA6对位及键合设备,进行对位后在真空状态下成功实现了圆片的热压键合.
2.1键合结果及分析
在键合过程中,键合温度和压力对键合效果有着重要影响,对无图形的圆片键合,通过多次试验,当采用电镀加厚的两个圆片进行键合时,在6500mbar的键合压力下,键合温度在300℃即能达到很好的键合效果.圆片键合完成后,采用破坏性的方法将两个圆片分离后观察表面状态,上下表面的状态如图2所示,键合界面的照片如图3所示.

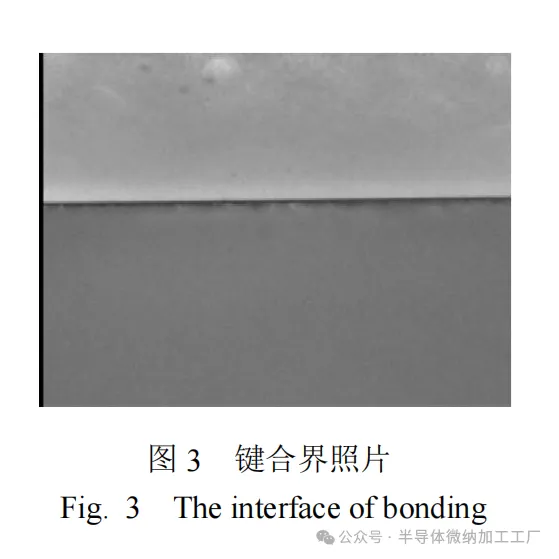
由图2分离表面的状态可以看出,拉开的两片键合硅片的断裂面为金-硅界面,从拉开的两个表面看,能明显的看出部分硅被撕扯下来粘附到金上,同样也能看到部分金被撕下来粘附到硅上,由此可见键合强度达到体硅的强度,金-金热压可以达到较好的键合效果.从图3键合界面照片可以看出,热压键合紧密不留缝隙,可以达到很好的密封效果.金-金热压键合能够达到很好的封装气密性,并能实现电气直接互联,适合于复杂三维结构的封装及互联.
2.2金-金热压键合制作MEMS器件
金-金热压键合适合于内部结构需要保护的键合封装,更适合于封装和电互联直接键合一次实现的结构.图形化的结构进行金-金热压键合对对位准确度的要求很严格,在设计版图时需要增加特殊的键合对位标志.键合对位过程分为两个步骤:将第一层硅片使用真空倒吸在天花板上,并使用显微镜对对位标记进行抓图后存储;将第二层硅片使用真空吸附在托盘上,在距第一层硅片很近处对存储图像进行对位,对准后夹在一起即完成键合对位.根据金-金热压键合的特点,采用金-金热压键合工艺分别制造了THz波导腔和微机械谐振器的电气连接.
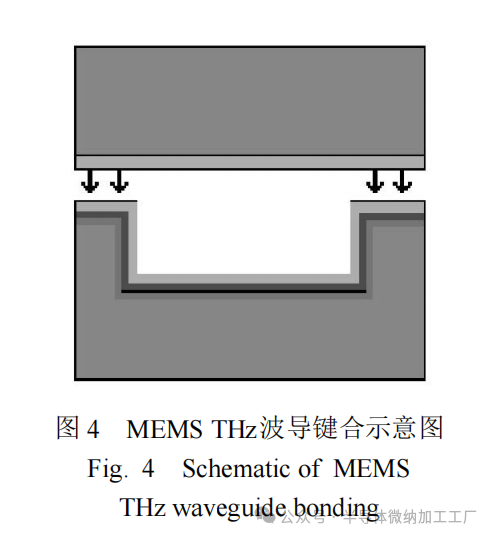

MEMSTHz波导是采用MEMS工艺实现的能够进行THz频段信号传输的矩形波导结构[11].波导结构采用MEMS体硅工艺实现,波导腔体内壁全部采用金属化工艺实现.金属化完成后,采用金-金热压键合工艺实现波导腔体,图4是MEMSTHz波导腔体实现的键合示意图.在键合的过程中,通过控制金-金热压工艺的温度、压力和时间,减少键合中的出现的缝隙和延展现象来实现高精度控制的MEMSTHz波导.图5是采用金-金热压键合实现的MEMSTHz波导扫描电镜照片.微机械谐振器是通信系统小型化、集成化的关键器件之一,采用静电驱动,以机械结构的谐振进行滤波,可以用于制作适合于现代电子通信发展的小体积滤波器、振荡器.圆盘形微机械谐振器以侧壁电容进行静电驱动,圆盘的厚度越大,静电驱动力越强,以表面加工工艺制作较厚的谐振圆盘存在一定的困难,本文中的微机械谐振圆盘以SOI硅片制作完成,之后溅射一层金,与另一片做好金电极的硅片进行键合实现电气连接,键合采用的金层厚度为200nm,键合温度350℃,压力6500mbar.工艺过程如图6所示.谐振圆盘的锚和金电极键合到一起,通过金电极加电实现静电驱动,微机械谐振器制作完成后的扫描电镜如图7所示.通过金-金热压键合制作的MEMSTHz波导和微机械谐振器在制作完成后通过拉力实验都能达到良好的键合效果,工作性能良好.工艺过程对器件的性能有着重要影响,对不同器件的制作,在采用金-金热压键合工艺时,可以根据图形键合面积的大小适当调节键合温度和压力,及温度和压力的升降过程,通过实验确定最佳键合温度和压力.
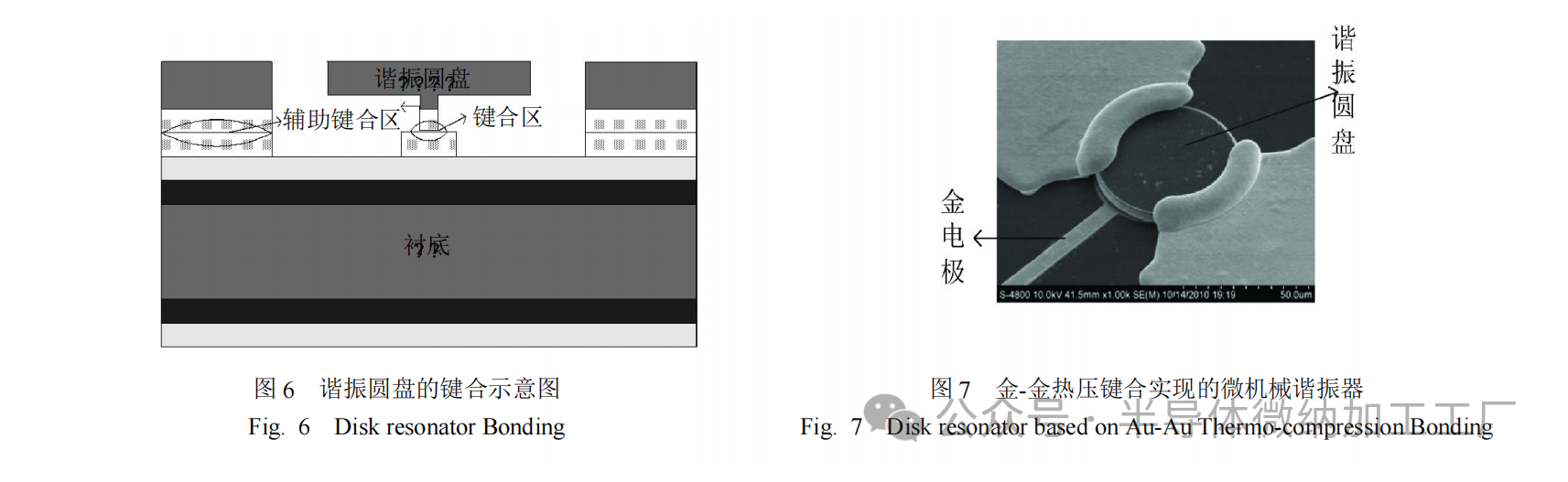
3 结论
近年来 MEMS 器件的键合技术发展迅速 , 已成为 MEMS 器件的制作、组装和封装的关键性技术之一.
金-金热压键合对键合表面的要求较低,能达到气密性封装的要求,且能实现引线结构,通过金-金热压键合可以制作高宽深比的器件,对 MEMS 三维结构的加工制作具有重要意义.随着 MEMS 技术的发展对键合工艺不断提出新的要求,对键合机理认识的不断深入,金-金热压键合技术有待于进一步提升,在 MEMS 制造中进行更广泛的应用