铌酸锂晶体的应用--SAW滤波器
铌酸锂 (LiNbO 3 ) 和钽酸锂 (LiTaO 3 ) 晶体广泛用于表面声波 (SAW) 器件、声光调制器和高功率激光源,因为其优异的机电耦合系数、声光(AO)效应和非线性光学效应。基于 LiNbO 3 和 LiTaO 3 的 SAW 滤波器在移动电话中很常见。然而,由于这些 SAW 滤波器的热特性较差,温度补偿最近引起了人们的极大兴趣,并且已经报道了一些方法来解决这个问题。将SAW滤波器器件直接键合到具有低热膨胀系数(CTE)和大杨氏模量的支撑基板上是抑制LiNbO 3 和LiTaO 3 大热膨胀的有效方法。b5> .例如,据报道,使用 LiNbO 3 直接键合到蓝宝石 [1,2]、玻璃 [[3]、[4]、[5]] 和硅 [3] 可以提高器件性能。,5]基材。
遇到的问题--大功率滤波器散热
SAW滤波器的散热将成为未来大功率应用的主要问题;因此,选择合适的基板并考虑散热是一个重要问题。碳化硅(SiC)由于其低CTE、大杨氏模量、高电阻率和高导热率而被认为是合适的支撑衬底。SiC因其热导率高于Si而被广泛用作散热基板。因此,将SAW滤波器和SiC衬底组合到单个芯片中是提高高功率应用的温度补偿和散热性能的合理策略。 此外,LiNbO 3 /SiC结构对于光子学应用也很有吸引力。例如,数值模拟表明这种结构将为生产未来光波导型器件提供可能性[6]。
解决方案--SAB
晶圆键合是制造异质基板的有力工具。传统的键合技术包括等离子体激活键合和有机粘合剂键合。前一种方法通常需要退火过程才能实现实际应用所需的牢固结合[[7]、[8]、[9]]。然而,LiNbO 3 (CTE(a,b 轴):15.4 × 10 −6 K −1 )和 LiTaO 3 (CTE:16.1 × 10 −6 K −1 ) 晶体与大多数半导体的 CTE 不匹配,例如 Si (CTE: 2.6 × 10 −6 K −1 K −1 )。因此,退火工艺使得直接粘合这些材料变得困难,因为会产生裂纹或发生晶圆翘曲[10]。尽管有机粘合剂粘合方法能够实现异种材料的低温粘合,但中间有机粘合剂层由于其低导热率而引入了大的热阻。因此,直接键合对于在设备应用中实现高效散热来说是更可取的。
表面活化直接键合 (SAB) 方法是用于 CTE 失配较大的异种材料直接室温键合的有前途的候选方法。由于原子级清洁的光滑表面之间的吸引力,表面活化工艺已用于实现牢固的室温粘合。SAB方法已成功应用于LiNbO 3 /Si [[11], [12], [13]]、SiC/SiC [14]、SiC/Si [15]的室温键合,用于功率器件应用的 GaN/金刚石 [16],以及用于光学应用的 GaAs/SiC [17]。因此认为SAB法适合于形成直接键合的LiNbO 3 /SiC。据我们所知,很少有研究关注 SAB 方法在 LiNbO 3 和 SiC 直接室温键合中的应用。
我们常见的键合技术 有硅玻璃键合 金金键合,金锡键合,金硅键合,临时键合等等 。但是当我们遇到一些需要低温键合,或者一些特殊材料时,或者应用场景时,上述键合方式很难满足一些特殊场景的应用,
因此科学家提出了表面活化键合技术,这种技术 使键合技术所覆盖的材料范围更加广泛,比如
GaAs-SiC InP-Diamond LN-SiC
Si-Si, GaN-Dlamond, Sl-Diamond,
蓝宝石-蓝宝石, 金刚石-sic, sic-inp,
sic-LN, sic-ga2o3, glass--glass
Si-SiC,Si-GaAs、GaAs- SiC、Si–SiC、SiC–SiC、Ge–Ge 、Al 2 O 3 -Al 2 O 3 ,GaP-InP, GaN-Si、LiNbO 3 -Al 2 O 3 、LiTaO 3 -Si
扩展的多材料的体系,将键合技术扩大了应用范围
*MEMS传感器 *光子集成电路 *半导体激光器
*功率器件 *3D封装 *异质集成
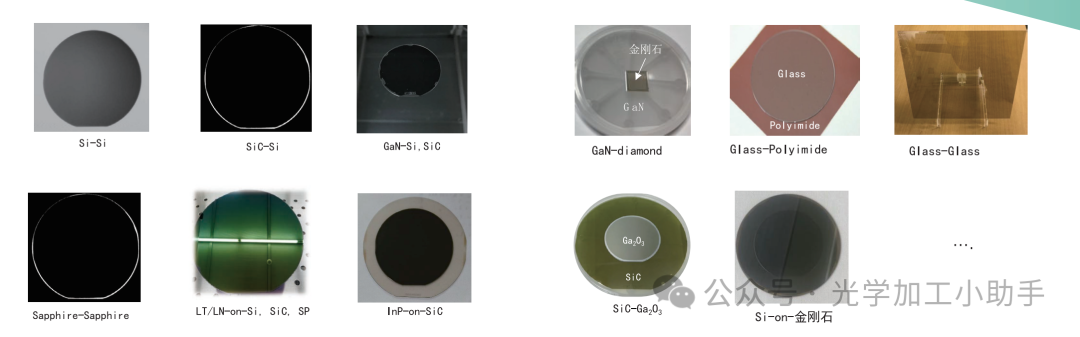
划重点--代工,代工,代工,卖设备
这种技术,小编前面分享的有些文章中有提到,但是当时小编才疏学浅,未能把握住这个技术的核心,但是最近,命运安排人咨询我
a.GaN-Diamond b.Si-Si c.恰好我在分享碳化硅集成光子学,这个技术也是核心之一。
因此小编后续的重心将会放在基于SAB的先进多材料键合技术的知识分享
划重点:小编提供基于si+sio2+sic(SAB键合)+减薄+cmp全套工艺的4H半绝缘碳化硅基片,助力碳化硅光子学发展。
我们为客户提供晶圆(硅晶圆,玻璃晶圆,SOI晶圆,GaAs,蓝宝石,碳化硅(导电,非绝缘),Ga2O3,金刚石,GaN(外延片/衬底)),镀膜方式(PVD,cvd,Ald,PLD)和材料(Au Cu Ag Pt Al Cr Ti Ni Sio2 Tio2 Ti3O5,Ta2O5,ZrO2,TiN,ALN,ZnO,HfO2。。更多材料),键合(石英石英键合,蓝宝石蓝宝石键合)光刻,高精度掩模版,外延,掺杂,电子束直写等产品及加工服务(请找小编领取我们晶圆标品库存列表,为您的科学实验加速。
激光器芯片/探测器芯片/PIC芯片封装耦合服务"
请联系小编免费获取原文,也欢迎交流半导体行业,工艺,技术,市场发展!

摘要:
研究了表面活化键合(SAB)方法在LiNbO 3 与SiC直接键合中的应用。SAB采用氩快原子束轰击首次成功形成了室温键合的LiNbO 3 /SiC晶片。横截面透射电子显微镜(TEM)观察显示原子水平上的无空隙键合界面。粘合界面有一个几纳米厚的类非晶层,这被认为是在轰击过程中形成的。由此产生的LiNbO 3 /SiC结构可用于实现各种器件的新配置,包括用于高功率应用的声表面波滤波器,可满足温度补偿和散热要求。
在这里,我们报告了 LiNbO 3 和 SiC 直接室温晶圆键合的首次试验。SAB方法采用氩(Ar)快原子束(FAB)轰击实现LiNbO 3 和SiC晶圆的直接室温键合。然后通过切割测试、拉伸测试和键合界面分析来评估键合质量。
在这项研究中,3 英寸。LiNbO 3 (Z 切割)晶片和 2 英寸。准备SiC晶片。使用SAB法进行LiNbO 3 晶片的负面与SiC晶片的Si面的室温接合。将两片晶圆放入键合室后,将室抽真空,并通过 Ar FAB 轰击激活两片晶圆。当背景压力降至 1 × 10 −5 Pa 以下时,开始对两片晶圆进行 Ar FAB 轰击。紧接着,LiNbO 3 和SiC的活化表面在室温下的压力负载下直接接触。Ar FAB轰击时间为60 s,足以去除键合表面上的有机污染物。
键合表面的表面粗糙度是直接室温键合的关键因素(通常需要亚纳米粗糙度)[18]。在 Ar FAB 轰击之前和之后,使用原子力显微镜 (AFM) 测量 LiNbO 3 和 SiC 晶片表面的粗糙度。AFM 测量的扫描区域为 1 μm × 1 μm,分辨率为 256 × 256 像素。图1显示了Ar FAB轰击后LiNbO 3 和SiC的AFM图像。Ar FAB 轰击前 LiNbO 3 和 SiC 的均方根 (RMS) 粗糙度分别为 0.22 和 0.27 nm。轰击后,值分别为0.44和0.25 nm。尽管FAB轰击期间的溅射使晶圆表面略微粗糙,但这种轰击工艺提供了具有亚纳米粗糙度的光滑晶圆表面。
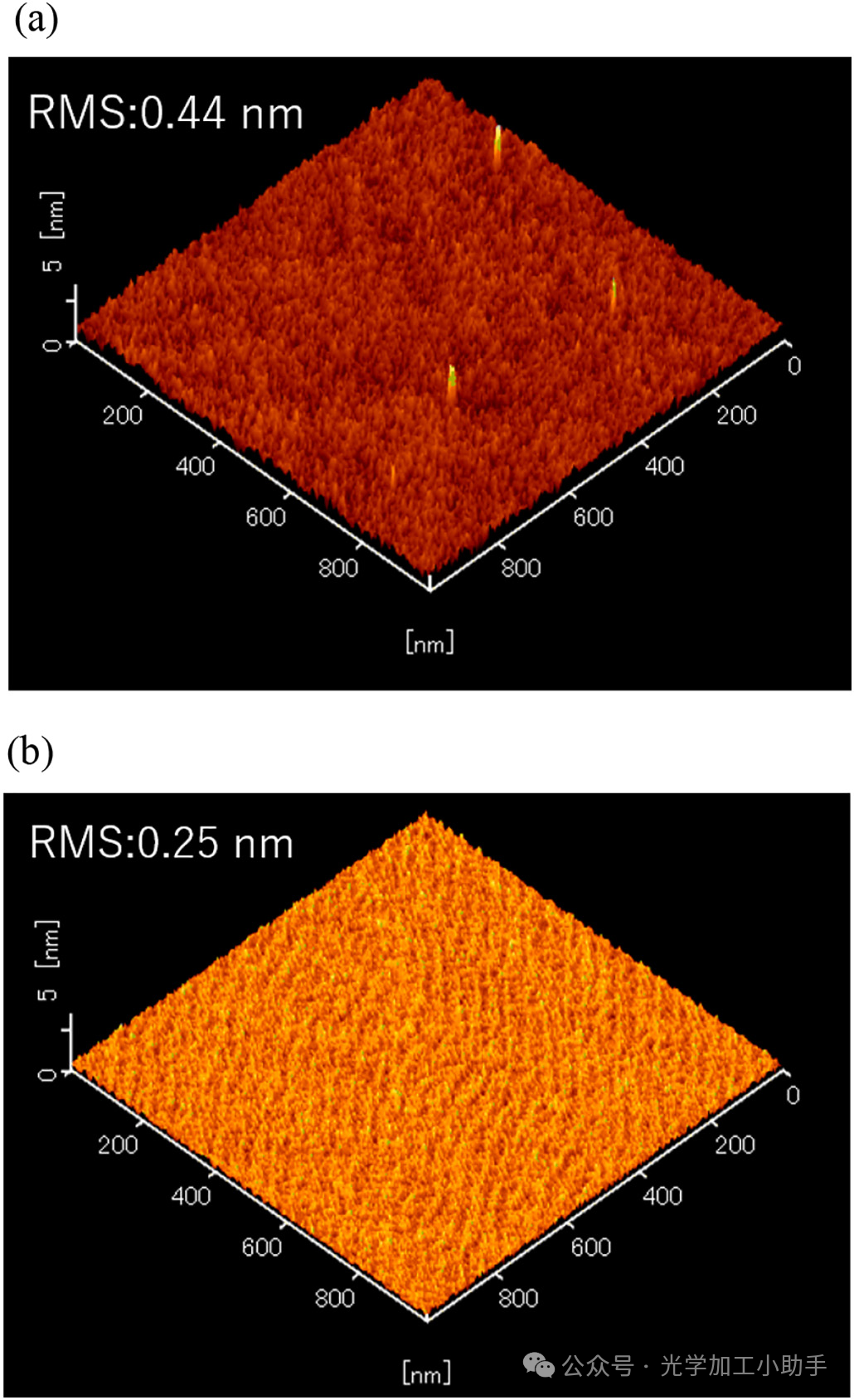
图 1 Ar FAB 轰击后的 AFM 图像 (a) LiNbO 3 (b) SiC
图 2(a) 显示了键合的 LiNbO 3 /SiC 混合晶片的照片,表明几乎无空隙键合。进行切割测试以评估粘合强度。将键合晶圆切割成 8 mm × 8 mm 芯片,然后使用划片锯切割成 1 mm × 1 mm 芯片。图 2(b) 显示了切割后的 1 × 1 mm 2 芯片的照片。这种完美的切割表明在 LiNbO 3 /SiC 键合界面处可以实现牢固的键合。使用 8 mm × 8 mm 模具进行拉伸测试。用粘合剂将模具固定到拉伸试验机的附件上。测得的拉伸强度约为 11 MPa,这表明粘合强度足以满足实际应用。在这项研究中,拉伸试验后断裂主要发生在粘结界面,而之前对粘结 LiNbO 3 /Si 的研究报道了块状材料的断裂[11]。这表明LiNbO 3 /SiC 的结合强度小于LiNbO 3 /Si 的结合强度。FAB 轰击 SiC 表面进行表面活化通常会导致 Si 原子优先溅射 [14]。通过蒙特卡罗模拟计算溅射产率,对于 1.5 keV 束流,Si 和 C 分别为 3.06 和 1.99 个原子/离子。因此,由此产生的 C 富集可能会导致 C Nb 键或者在活化的硅表面上形成类石墨结构,这会导致粘合性差[14,19]。因此,这被认为是接合强度劣化的原因。
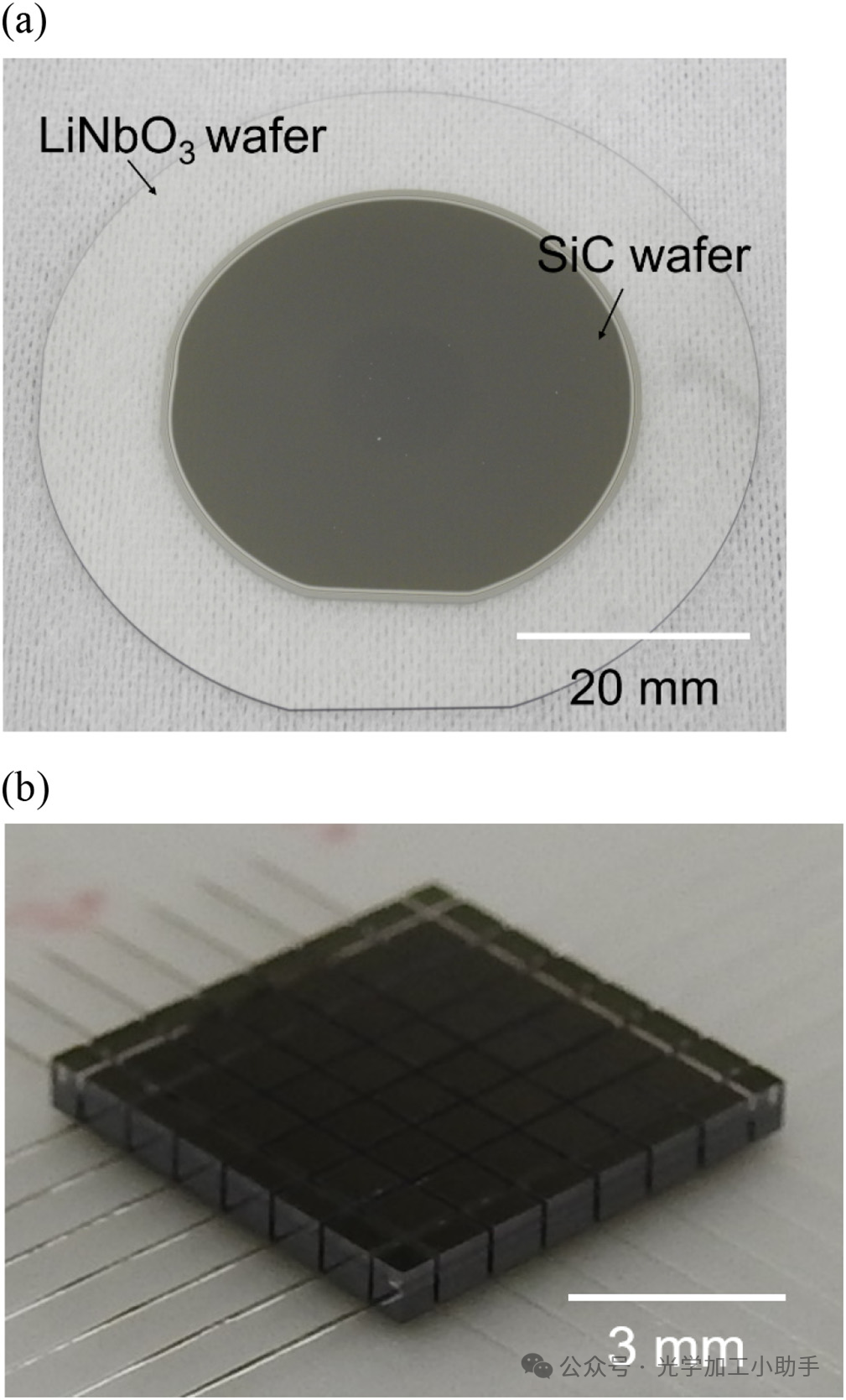
图 2. (a) 室温下键合的 LiNbO 3 /SiC 晶片的照片。(b) 切成 1 x 1 毫米 2 芯片的照片。
使用透射电子显微镜(TEM)和扫描TEM-能量色散X射线光谱(STEM-EDX)分析了键合界面的结构和成分。图3显示了LiNbO 3 /SiC键合界面的截面TEM图像。在原子水平上证实了界面处的无空隙键合。还检测到厚度为几纳米的均匀中间层,这被认为是在 Ar FAB 轰击过程中形成的。尽管原始键合表面存在于该中间层内,但没有观察到与原始表面相对应的键合界面,这表明LiNbO 3 和SiC之间存在原子接触。
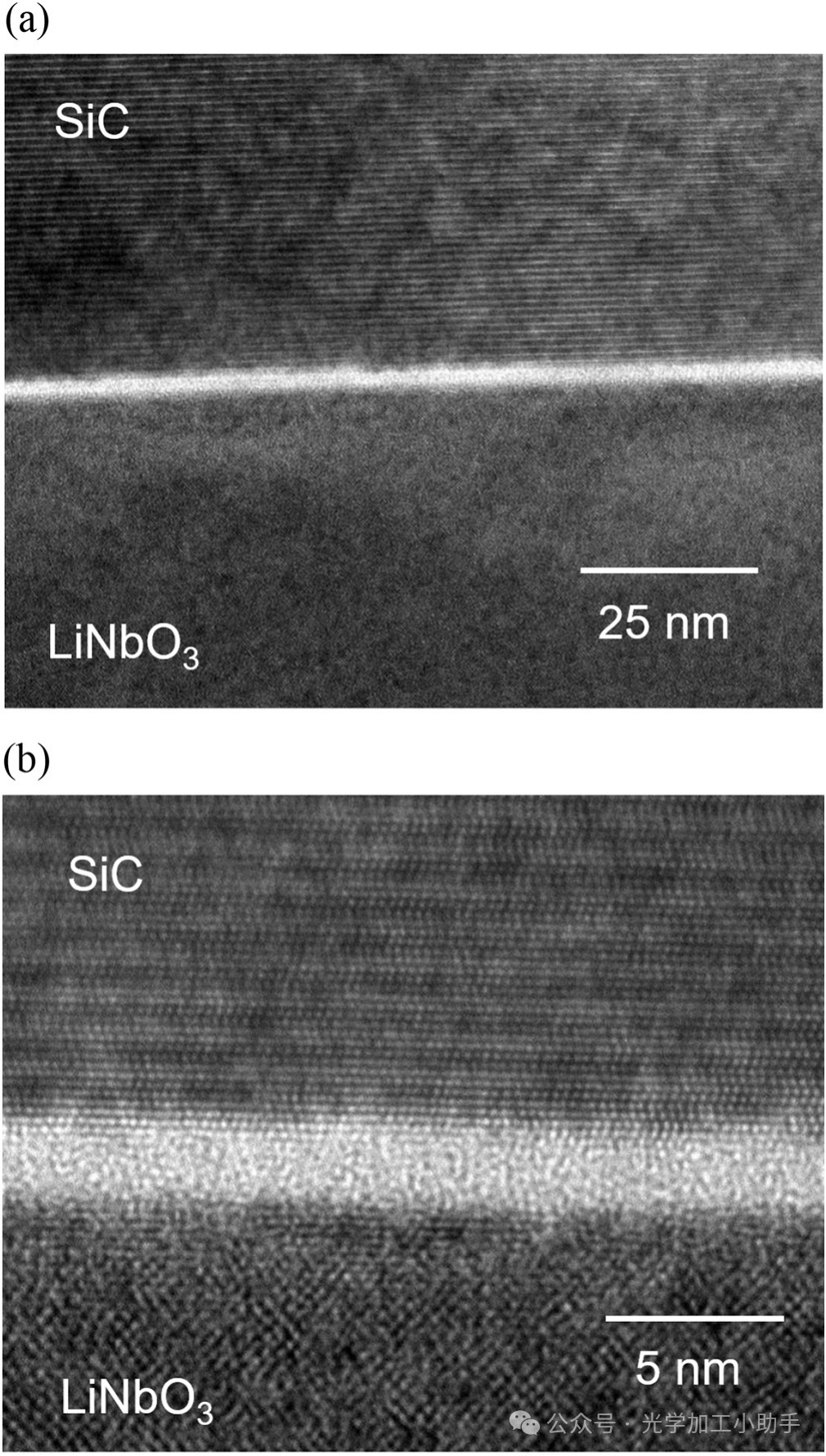
图3(a)显示LiNbO 3 和SiC键合界面横截面的TEM图像(b)(a)的放大图。
对键合界面进行 STEM-EDX 分析,检测到对应于 C、O、Si、Nb、Cu 和 Ar 的峰。没有观察到 Li 峰,因为使用 EDX 很难检测到轻元素。Cu 峰是由于铜网样品架造成的。从 SiC 晶体中准确检测 C 也很困难,因为在 TEM 观察之前,空气中的有机污染物会吸附在通过聚焦离子束制造的 TEM 样品上。因此,Li、C和Cu被排除在以下分析之外。图 4 显示了通过 EDX 分析确定的键合界面上 Nb、O、Si 和 Ar 原子的成分分布。水平轴和垂直轴分别表示键合界面上的位置和每个原子每秒的计数。初始键合界面处的类非晶层含有 Nb、O、Si 和 Ar 原子。如图4所示,该类非晶层中Si原子的减少被认为是由于Si从SiC表面优先溅射所致。Si原子在接触后扩散到LiNbO 3 块状晶体中,而Nb原子没有明显扩散到SiC块状晶体中。非晶层中存在的少量 Ar 原子源自 Ar FAB 轰击过程。
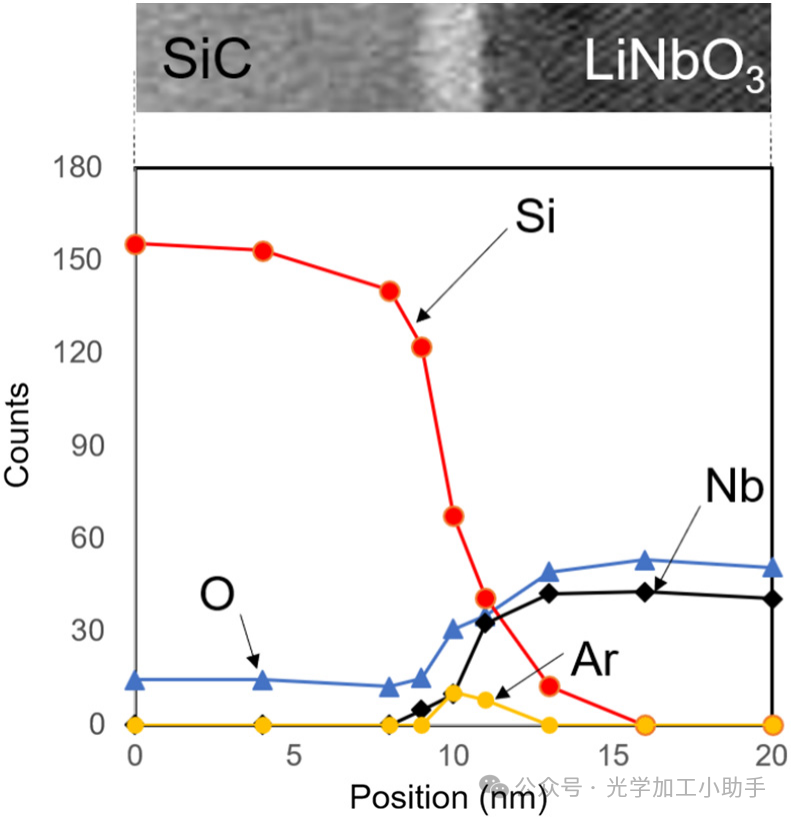
图 4. 通过 STEM-EDX 分析确定键合界面上 Nb、O、Si 和 Ar 的成分分布。
总之,首次研究了SAB在LiNbO 3 和SiC晶片直接键合中的应用。SAB 使用 Ar FAB 轰击导致在室温下形成直接键合的 LiNbO 3 /SiC 晶片。为了克服 LiNbO 3 和 SiC 之间严重的 CTE 不匹配问题,室温键合至关重要。粘合晶圆成功切割成1毫米×1毫米的芯片,切割过程中施加的应力没有导致界面脱粘,测得的拉伸强度约为11 MPa。这些结果表明 LiNbO 3 和 SiC 之间实现了牢固的结合,这足以满足器件应用的需求。横截面 TEM 观察表明,可以实现原子级的无空隙键合界面。结合界面具有厚度为几纳米的类非晶层,该层是在 Ar FAB 轰击过程中形成的。这里提出的直接键合方法预计可用于有效散热,以解决 LiNbO 3 器件(包括高功率应用中使用的 SAW 滤波器、AO 调制器和高功率激光源)的热问题。预计本工作中提出的LiNbO 3 /SiC结构可用于实现未来LiNbO 3 器件的新配置。