亚历山德罗・帕吉 *、贾科莫・特鲁皮亚诺、乔治・德・西蒙尼、奥马尔・阿里夫、露西娅・索尔巴、弗朗切斯科・贾佐托
基于混合砷化铟(InAs)约瑟夫森结(JJs)的超导电路在快速、超低功耗固态量子电子学设计以及探索新物理现象方面发挥着关键作用。传统上,人们会采用由砷化铟制成的三维衬底、二维量子阱(QWs)以及一维纳米线(NWs)来构建含混合约瑟夫森结的超导电路。每个平台都各有利弊。在此,绝缘体上砷化铟(InAsOI)被提议作为开发超导电子学的一个开创性平台。将具有不同电子密度的半导体砷化铟外延层生长在InAlAs变质缓冲层上,该缓冲层能有效充当低温绝缘体,实现相邻器件的电隔离。利用铝作为超导体以及具有不同电子密度的砷化铟制造出了各种长度和宽度的约瑟夫森结。目前已实现了7.3微安/微米的开关电流密度、50至80微伏的临界电压以及与所用超导体相等的临界温度。对于所有的约瑟夫森结而言,其开关电流随面外磁场呈现出类似夫琅禾费的模式。这些成果使得能够利用绝缘体上砷化铟(InAsOI)来设计并制造出具有高临界电流密度和优异门控特性的表面暴露约瑟夫森场效应晶体管。
其实从最近学术界发文章的趋势我们不难看出 ,最近比较火的几篇文章
Ti:Sapphire激光器(这个文章的作者的老师也是搞SICOI的)
碳化硅光子集成线路
当然包括以前大家常用的SOI,LNOI,LTOI
硅光铌酸锂异质键合
氮化硅铌酸锂异质键合
上述工艺平台都是基于一类工艺,键合+SMARTCUT/减薄抛光工艺,
这套工艺平台,可以在热氧片或者其他材料上实现多材料的键合,最终可以开发多材料的平台,对光子集成线路的发展提供了更多的自由性。
划重点
而目前国内提供绝缘体上多材料加工平台的供应严重不足,严重限制了国内科学家在这块的探索,小编为大家提供多材料(InAlAs,Inp,InGaAs,铌酸锂,晶体,碳化硅,磷化铟,砷化镓,钽酸锂,碳化硅,氮化镓,砷化镓,氮化硅,等等等等)和多材料键合加工,离子注入,抛光煎薄的全流程 全产线,自主可控复合衬底加工,您收到我们的衬底后,可以基于自己单位的平台进行后道的刻蚀工艺的开发。
同时可以提供两类工艺
键合可以亲水键合+退火或者室温表面活化键合+改性层
薄膜层的获取可以通过smartcut离子注入(厚度控制精准,膜层有损伤)+退火cmp或者机械减薄+cmp(厚度控制不精准,但是膜层没损伤)

如果想要了解更多可以联系小编

1. 引言
基于约瑟夫森结(JJs)的超导电路在快速、超低功耗固态量子电子学的设计中起着关键作用。[1,2]在过去几十年里,超导 - 半导体混合约瑟夫森结作为探索新物理现象[3 - 6]以及构建量子电子架构[7,8]的基本单元,受到了越来越多的关注。诸多应用已被记录在案,包括门可调超导[9 - 12]和安德烈耶夫[13,14]量子比特、超导晶体管[15 - 17]、二极管[18 - 20]以及干涉仪[21 - 23]。这些应用还延伸到诸如自旋相关超电流[24]、拓扑相变[25 - 27]、基态反常相移[28,29]以及宇称保护系统[30 - 32]等量子现象领域。在III - V族化合物中,砷化铟(InAs)是一种半导体,其表面自然存在电荷积累现象,能使费米能级钉扎在其导带边之上[33,34],这使得它能够与常规金属形成欧姆接触。此外,当采用超导金属时,超导特性可通过超导近邻效应传递给InAs层[35,36]。在基于InAs的各类平台中,传统上常采用3D衬底、2D量子阱(QWs)以及1D纳米线(NWs)来构建具有超导 - 半导体混合约瑟夫森结的电路。约瑟夫森结以及门可调约瑟夫森结(也被称作约瑟夫森场效应晶体管,JoFETs)最初是在具有表面二维电子气(2DEGs)的3D InAs衬底中被报道的[37 - 39]。使用铌(Nb)电极时获得了显著的临界电流密度(\(I_{C}/W\),其中\(W\)代表结的宽度),达到了20 μA μm⁻¹(图1a,蓝色点;支持信息表S1),不过由于相邻器件之间存在InAs导电通路,该平台在实际应用中面临诸多阻碍[37]。如今,掩埋式[15,40]以及最新的近表面式[16,41 - 44]InAs 2D量子阱是承载高迁移率二维电子气最常用的平台。尽管近年来材料方面有所改进,但与铝(Al)接触的InAs量子阱的临界电流密度总是比InAs 3D衬底所达到的数值至少低1到2个数量级(图1a,绿色点;支持信息表S1)。由于砷化铟(InAs)1D纳米线在纳米级量子器件中作为构建单元具有潜在应用,它也一直是深入研究的对象[9,45,46]。与InAs的2D和3D同类材料一样,InAs纳米线通过超导近邻效应来支持超导性[26,47,48]。不管其为一维形态,与铝近邻耦合的InAs纳米线所展现出的临界电流密度与量子阱中所达到的类似,不过用铝[47]或铅(Pb)引线近邻耦合的弹道纳米线除外,其实现了每微米10微安(\(I_{C}/W\))的临界电流密度(图1a,黑色点;支持信息表S1)。尽管有其电学性能表现,但基于InAs纳米线的器件实际应用受限于要将纳米线以纳米级精度放置在表面特定位置上[50 - 53]。在此,我们提出绝缘体上的砷化铟(InAsOI)可作为开发平面超导电子学的一个新平台。将一层厚度为100nm、具有不同掺杂水平的半导体InAs外延层生长在InAlAs变质缓冲层上。在我们的方案中,该变质缓冲层可有效地用作低温绝缘体,实现相邻器件的电隔离。利用铝作为超导体以及不同电子密度的InAs制造出了不同长度和宽度的约瑟夫森结。对于长度为350nm且InAs薄层电子密度为\(10^{14}cm^{-2}\)的约瑟夫森结,其临界电流密度高达每微米7.3微安,与InAs 3D衬底相当。我们强调,InAsOI与极为成功的绝缘体上硅(SOI)结构类似,是实现基于SOI制造的经典半导体电子学超导对应物的一个很有前景的候选平台。
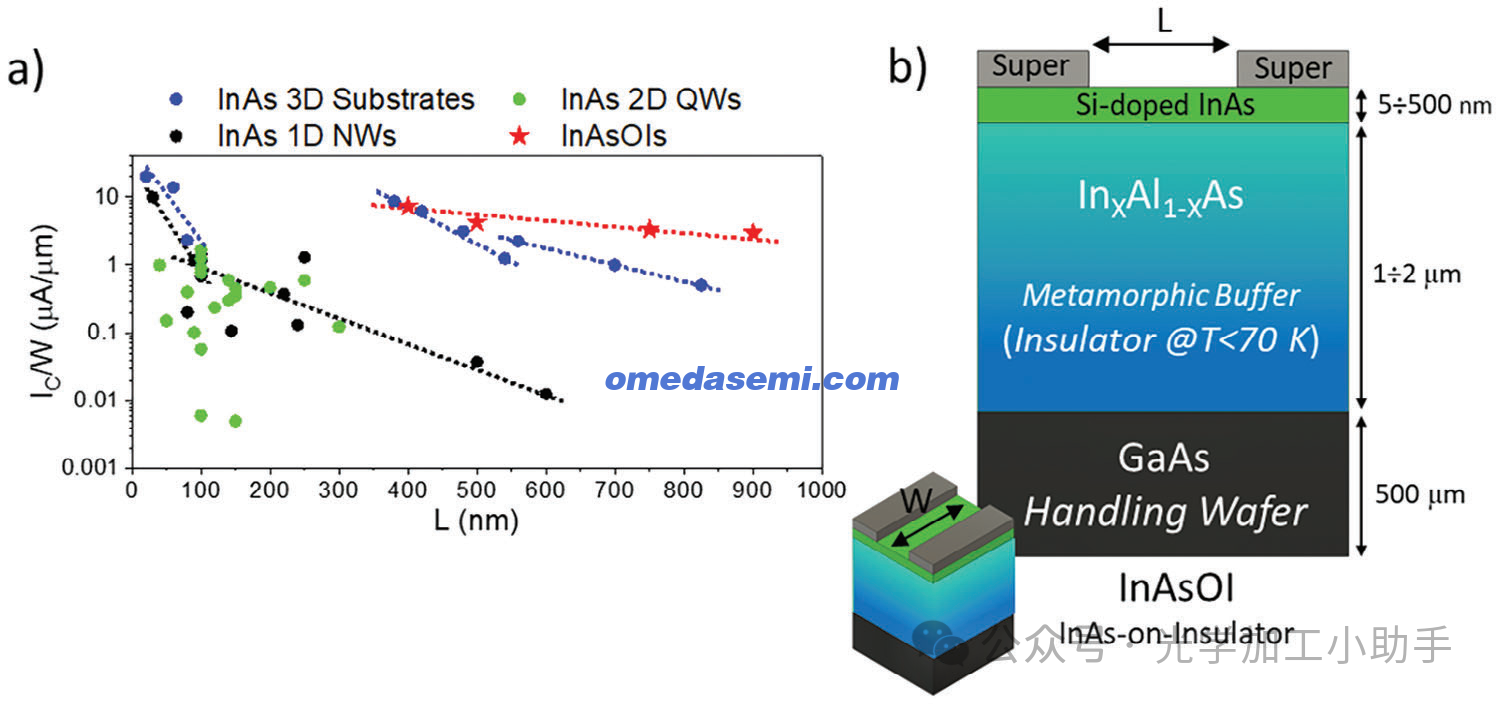
图1. 用于低温超导电子学的绝缘体上砷化铟:概念及对比。a) 基于砷化铟(InAs)的超导平台所实现的临界电流密度的现状。每个平台最具代表性的器件都用一个点来表示,即绝缘体上砷化铟(InAsOI)、InAs三维衬底、InAs二维量子阱以及InAs一维纳米线。只要有可能,我们都对比了使用铝(Al)作为超导体的InAs各平台情况。绝缘体上砷化铟(InAsOI)展现出比其他平台更高的临界电流密度(与使用铌(Nb)电极的InAs三维衬底所达到的水平相当)。而且,通过选择InAs薄层电子密度,其临界电流密度还能在数量级上进行调节。b) 绝缘体上砷化铟(InAsOI)的截面及三维结构。
2. 结果与讨论
用于低温超导电子学的绝缘体上砷化铟(InAsOI)平台如图1b所示。表面暴露的砷化铟(InAs)外延层通过超导引线(例如铝(Al)[17, 43]、铅(Pb)[49]、铌(Nb)[15, 37, 54]、铌钛(NbTi)[55]及其他[56, 57])所传递的超导近邻效应来支持无耗散电流。该结构顶部存在的InAs使得能够直接触及最终的半导体沟道,在此可通过在异质结构生长期间(通过原子掺入)或生长后(通过掺杂剂注入或热扩散)改变InAs的掺杂情况来调控其电子输运特性。厚度为微米级的InAlAs变质缓冲层避免了InAs与用于操作的砷化镓(GaAs)衬底之间的晶格失配,并且可在低温下用作绝缘体。无论采用何种制造技术(这对于基于砷化镓的异质结构来说是较为典型的),InAsOI都可看作是绝缘体上硅(SOI)结构的超导对应物,其中近邻耦合的InAs和低温绝缘的InAlAs分别取代了SOI中的硅(Si)层和二氧化硅(SiO₂)层。图2a展示了通过分子束外延(MBE)生长的InAsOI异质结构的细节。尽管我们使用的是分子束外延技术,但我们认为也可以利用化学气相沉积(CVD)生长技术来制造InAsOI,这样能够加快晶圆级制造工艺的速度,同时又不会使输运和超导特性出现明显的恶化。从底部到顶部,该结构堆叠依次由以下部分组成:厚度为500 µm的半绝缘砷化镓(100)衬底、厚度为200 nm的砷化镓层、厚度为200 nm的砷化镓/砷铝镓(GaAs/AlGaAs)超晶格、厚度为200 nm的砷化镓层、厚度为1250 µm的渐变式InₓAl₁₋ₓAs变质缓冲层(其中\(x\)从0.15递增到0.81)、厚度为400 nm的In₀.₈₄Al₀.₁₆As过冲层,最后是厚度为100 nm的砷化铟(InAs)外延层。位于InₓAl₁₋ₓAs缓冲层下方的砷化镓层以及砷化镓/砷铝镓超晶格是为了使初始的砷化镓表面平整化,并减少因氧化物解吸过程所导致的表面粗糙度而生长的。渐变式变质缓冲层和过冲层对于避免砷化镓与砷化铟之间的晶格失配是必不可少的[58]。通过设定不同的分子束外延(MBE)硅池温度,即0 °C(也就是无硅掺杂)、1230 °C和1300 °C,对InAs层进行了N型硅掺杂。图2b展示了在300 K和3 K下,MBE硅池温度与InAs薄层电子密度(\(n_{2D}\))之间的关系。在3K时,由于InAlAs过冲层和变质缓冲层呈现绝缘特性,InAsOI的输运特性完全取决于InAs层。我们观察到,从300 K到3K,\(n_{2D}\)大约恒定减少\(3.5×10^{12}cm^{-2}\),且与薄层电子密度值无关,这与InAs层和InAlAs层中的电荷冻结现象有关。当硅池温度分别为0 °C(无硅掺杂)、1230 °C和1330 °C时,InAs的\(n_{2D}\)值分别为\(1×10^{12}cm^{-2}\)(本征掺杂)、\(2×10^{13}cm^{-2}\)和\(1×10^{14}cm^{-2}\)。对于硅掺杂的InAs外延层,\(n_{2D}\)随温度的相对轻微降低表明施主实际上总是完全电离的,这也与硅掺杂的InAs纳米线所观察到的情况相符[59]。另一方面,在无硅掺杂情况下InAsOI所达到的薄层电子密度也可能与InAlAs带隙中的深施主能级有关[60]。图2c展示了\(n_{2D}≈10^{13}cm^{-2}\)的InAsOI衬底的原子力显微镜(AFM)图像,而其他衬底的原子力显微镜照片在图S1(支持信息)中给出。无论薄层电子浓度如何,其表面均方根粗糙度估算约为8 nm,在沉积用作超导体的100 nm厚的铝膜后,该粗糙度增加至约9 nm(图2d)。图2e、f展示了通过霍尔测量在300 K和3 K下评估得到的InAsOI电阻率(\(\rho\))和迁移率(\(\mu_{n}\))。正如\(n_{2D}\)所呈现的情况一样,对于\(\rho\)也观察到了类似的温度依赖趋势。低温下InAs的电阻率随着薄层电子密度从\(10^{12}cm^{-2}\)增加到\(10^{14}cm^{-2}\),从约\(60\ \mu\Omega·m\)降低至\(1\ \mu\Omega·m\)。同样地,低温下InAs的迁移率随着\(n_{2D}\)增加两个数量级,从约\(7×10^{3}cm^{2}V^{-1}s^{-1}\)降低至\(3×10^{3}cm^{2}V^{-1}s^{-1}\),这比超导电子学中常用的InAs近表面二维量子阱通常所能获得的峰值电子迁移率低1.5到5倍(支持信息表S1)。我们估算出在\(n_{2D}≈10^{12}cm^{-2}\)、\(10^{13}cm^{-2}\)和\(10^{14}cm^{-2}\)的InAs情况下,电子平均自由程分别为112 nm、177 nm和156 nm。我们还运用传输线法(TLM)评估了在300 K和3 K下铝(Al)与InAs之间的接触电阻(\(R_{C}\)),这是一种用于评估两种导体之间接触质量的标准方法[61,62]。通过对InAs自然氧化物(InAsOX)进行表面去除并同时进行表面硫钝化处理,优化了InAs与Al之间的接触,这使得接触电阻得以降低,而InAs的电阻率实际上并未受到影响(支持信息图S2)[63,64]。InAsOX的刻蚀增强了Al的超导近邻效应,从而提高了最终形成的Al - InAs - Al约瑟夫森结(JJs)的临界电流。在3 K时,获得了约6 Ω的接触电阻,且与InAs的电输运特性无关(支持信息图S3)。

图2. 绝缘体上砷化铟(InAsOI)的形貌及电学特性表征
a) 绝缘体上砷化铟(InAsOI)的截面层结构。b) 在3K和300K时,绝缘体上砷化铟(InAsOI)的薄层电子密度相对于分子束外延(MBE)硅池温度的变化情况(温度\(T = 0^{\circ}C\)表示无硅原子)。c) 具有二维电子密度(\(n_{2D}\))约为\(10^{13}cm^{-2}\)的绝缘体上砷化铟(InAsOI)衬底的原子力显微镜照片;比例尺为5μm。d) 由原子力显微镜图像推算出的砷化铟(InAs)均方根粗糙度相对于绝缘体上砷化铟(InAsOI)薄层电子密度的变化情况。e)、f) 在3K和300K时,绝缘体上砷化铟(InAsOI)的电阻率(e)和迁移率(f)相对于绝缘体上砷化铟(InAsOI)薄层电子密度的变化情况。g) InAlAs变质缓冲层的电阻率随温度的变化情况,着重显示了温度低于70K时的绝缘行为以及温度高于70K时的电阻行为。h) 对于一条InAlAs条带,InAlAs变质缓冲层在3K(上图)和300K(下图)时的电流 - 电压曲线,突出显示了其在3K时的绝缘行为以及在300K时的电阻行为。b、e、f)中的数据是针对每种绝缘体上砷化铟(InAsOI)薄层电子密度,对\(n = 3\)个样品测量所得平均值的报告,误差棒代表标准偏差。
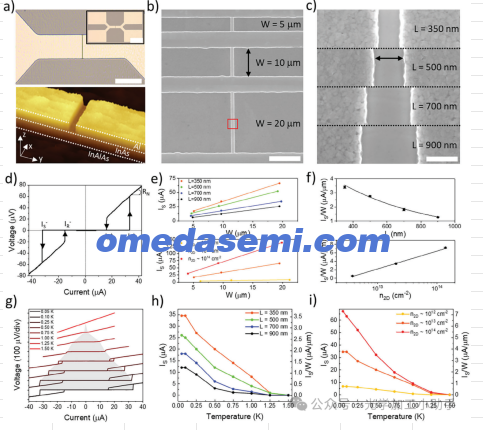
图3. 基于绝缘体上砷化铟(InAsOI)的约瑟夫森结的形貌及电学特性表征
a)(上图)一个宽度(\(W\))为20μm、长度(\(L\))为900nm的约瑟夫森结的光学显微镜图像,比例尺为25μm。插图展示了整个器件,比例尺为100μm。(下图)一个宽度(\(W\))为5μm、长度(\(L\))为900nm的约瑟夫森结在\(xy\)平面倾斜的原子力显微镜\(z\)向剖面图。b) 展示长度(\(L\))为900nm但宽度不同的约瑟夫森结的俯视扫描电子显微镜图像(放大倍数2500倍),比例尺为10μm。c) 展示宽度(\(W\))为5μm但长度不同的约瑟夫森结的俯视扫描电子显微镜图像(放大倍数5万倍),比例尺为500nm。d) 一个宽度(\(W\))为10μm、长度(\(L\))为350nm且砷化铟(InAs)二维电子密度(\(n_{2D}\))约为\(10^{13}cm^{-2}\)的约瑟夫森结在50mK下测量得到的正向和反向电压 - 电流特性。e) 在50mK下测量得到的不同长度(上图)以及不同砷化铟(InAs)薄层电子密度(下图)对应的开关电流与宽度的关系。(上图)这些约瑟夫森结的砷化铟(InAs)\(n_{2D}\)约为\(10^{13}cm^{-2}\);(下图)这些约瑟夫森结的长度(\(L\))为350nm。f) 在50mK下测量得到的开关电流密度与长度(上图)以及与砷化铟(InAs)薄层电子密度(下图)的关系。(上图)这些约瑟夫森结的砷化铟(InAs)\(n_{2D}\)约为\(10^{13}cm^{-2}\);(下图)这些约瑟夫森结的长度(\(L\))为350nm。数据是针对每个约瑟夫森结长度和砷化铟(InAs)薄层电子密度,对\(n = 3\)个样品测量所得平均值的报告,误差棒代表标准偏差。g) 一个宽度(\(W\))为10μm、长度(\(L\))为350nm且砷化铟(InAs)二维电子密度(\(n_{2D}\))约为\(10^{13}cm^{-2}\)的约瑟夫森结在温度从0.05K变化到1.5K时测量得到的正向和反向电压 - 电流特性。h) 不同长度的约瑟夫森结对应的开关电流和开关电流密度随温度的变化情况。这些约瑟夫森结的砷化铟(InAs)\(n_{2D}\)约为\(10^{13}cm^{-2}\)且宽度(\(W\))为10μm。i) 不同砷化铟(InAs)薄层电子密度对应的开关电流和开关电流密度随温度的变化情况。这些约瑟夫森结的长度(\(L\))为350nm且宽度(\(W\))为10μm。

图4. 基于绝缘体上砷化铟(InAsOI)的约瑟夫森结的类夫琅禾费衍射图样。具有不同长度(a)、宽度(b)、砷化铟(InAs)薄层电子密度(c)以及温度(d)的约瑟夫森结的开关电流随面外磁场的变化情况。各图板中都给出了约瑟夫森结的具体特性。
随后,我们通过测量InAlAs变质缓冲层的电阻率来评估其随温度变化的电学行为。如图2g所示,电阻率(\(\rho\))从300 K时的约100 mΩ·m增加到70 K时的10 GΩ·m,在70 K以下其阻值保持不变。图2h展示了一条InAlAs条带(宽度为200 μm、长度为5 μm)在300 K和3 K时记录的电流 - 电压(\(I - V\))曲线。在室温下,InAlAs呈现电阻特性(见支持信息中的图S4),具有线性的\(I - V\)特性,电阻约为2 kΩ。另一方面,在3 K时,该变质缓冲层表现出绝缘特性,具有30 V的明显击穿电压(\(V_{BD}\)),且在雪崩击穿前的并联电阻为140 TΩ。后一结果表明,该变质缓冲层在低于70 K的温度下可有效地用作绝缘体,而70 K这一温度远高于所有BCS超导体的临界温度(\(T_{C}\))。我们利用具有不同薄层电子密度的绝缘体上砷化铟(InAsOI)制作了超导 - 半导体 - 超导结构的铝 - 砷化铟 - 铝(Al - InAs - Al)约瑟夫森结(JJs),其具有多种宽度(\(W = 5\)、10、20 μm)和电极间距(长度,\(L = 350\)、500、700、900 nm)。器件是通过两个对准的光刻步骤制造的:首先,通过紫外光刻定义铝(Al)和砷化铟(InAs)台面,并通过连续的铝和砷化铟湿法刻蚀进行制作,确定约瑟夫森结的宽度,使低温绝缘的InAlAs层暴露出来;然后,通过电子束光刻和铝湿法刻蚀来确定约瑟夫森结的长度,使下方的砷化铟不受影响。图3a上图展示了一个宽度为20 μm、长度为900 nm(选择此尺寸是为了突出电极间距)的约瑟夫森结的光学显微镜图像,而插图展示了整个器件。在图片中可以观察到浅灰色区域(铝区域)和深灰色区域(台面刻蚀区域)之间有明显的分隔,器件加工过程中精细控制的刻蚀使得边缘笔直。约瑟夫森结的形状可从图3a下图看到,该图展示了通过原子力显微镜(AFM)对器件进行扫描所获得的结表面(\(xy\)平面)沿\(z\)轴倾斜的剖面图(另见支持信息中的图S5a)。\(xz\)平面和\(yz\)平面中的约瑟夫森结轮廓展示在支持信息的图S5b中,从中可以看出铝(Al)层和砷化铟(InAs)层的厚度均约为100 nm。图3b和图3c分别展示了不同宽度和不同长度的约瑟夫森结的扫描电子显微镜(SEM)图像。同样,在这种情况下,可以看到台面笔直的边缘,以及约瑟夫森结与铝湿法刻蚀残留物之间清晰的分隔情况。样品是在配备有\(z\)轴超导磁体和直流测量装置的稀释制冷机中进行测量的;除非另有说明,电学特性表征是在50 mK下进行的。图3d展示了一个长度(\(L\))为350 nm、宽度(\(W\))为10 μm且二维电子密度(\(n_{2D}\))约为\(10^{13}cm^{-2}\)的约瑟夫森结的正向和反向电流 - 电压(\(V - I\))特性,而具有不同长度、宽度以及不同砷化铟(InAs)薄层电子密度的约瑟夫森结的\(V - I\)曲线在图S6(支持信息)中给出。该约瑟夫森结呈现出非对称的\(V - I\)曲线,并且在开关电流(\(I_{S}\))处,从无耗散状态切换到有耗散状态,展现出正常态电阻(\(R_{N} = \frac{dV}{dI}\vert_{I > I_{S}}\))。这证明了\(InAs\)层的有效近邻化,并确认形成了期望的超导 - 半导体 - 超导约瑟夫森结。一旦进入有耗散状态,当偏置电流降低到再捕获电流(\(I_{R} \leq I_{S}\))以下时,约瑟夫森结会恢复到无耗散状态。值得注意的是,对于正向和负向偏置电流,\(I_{S}\)和\(I_{R}\)都具有相同的值(\(I_{S} = I_{S +} = I_{S -}\)且\(I_{R} = I_{R +} = I_{R -}\))。开关电流值随约瑟夫森结的宽度呈线性增加,与长度以及\(InAs\)薄层电子密度无关,由此可将开关电流密度(\(I_{S} / W\))定义为开关电流除以约瑟夫森结的宽度(图3e)。如图3f上图所示,\(I_{S} / W\)随约瑟夫森结长度呈指数下降,在\(n_{2D} \approx 10^{13}cm^{-2}\)的情况下,观察到开关电流密度从长度(\(L\))为350 nm时的3.4 μA/μm单调递减至长度(\(L\))为900 nm时的1.27 μA/μm。对于具有不同薄层电子密度的\(InAs\)样品,也观察到了类似的趋势。\(I_{S} / W\)与\(L\)的变化趋势表明,所有长度\(L \geq 350nm\)的约瑟夫森结都不处于有效长度(\(L_{eff}\))远小于相干长度(\(\xi_{N}\))的短结状态,其中\(L_{eff}\)是约瑟夫森结的有效长度,\(\xi_{N}\)是\(InAs\)的相干长度[65]。在50 mK下,我们估算出当\(n_{2D} \approx 10^{12}cm^{-2}\)、\(10^{13}cm^{-2}\)和\(10^{14}cm^{-2}\)时,\(\xi_{N}\)的值分别约为1.0 μm、1.7 μm和2.2 μm。这些计算结果以及实验结果表明,约瑟夫森结的有效长度明显长于电极间距,这可以通过源极到漏极路径的超电流贡献来解释,该路径长度比电极间距更长。这源于铝(\(Al\))引线下方\(InAs\)外延层的超导近邻化,导致结的范围并非严格由电极间距来界定[66]。图3f下图展示了长度为350 nm的约瑟夫森结的\(I_{S} / W\)与\(InAs\)薄层电子密度之间的关系。开关电流密度从\(n_{2D} \approx 10^{12}cm^{-2}\)时的0.5 μA/μm对数增加到\(n_{2D} \approx 10^{14}cm^{-2}\)时的7.3 μA/μm。后一个数值明显高于通过铝对\(InAs\)二维量子阱(\(2D QWs\))和\(InAs\)一维纳米线(\(1D NWs\))产生近邻效应所形成的约瑟夫森结的相关报道数值,接近采用铌(\(Nb\))作为超导体的\(InAs\)三维衬底所通常达到的水平(图1a,红星;表S1,支持信息)。此外,通过改变约瑟夫森结的形貌特性以及\(InAs\)外延层的薄层电子密度,\(I_{S} / W\)能够轻易地在数量级上进行调节。图S7a(支持信息)展示了不同\(n_{2D}\)和\(W\)(长度\(L \approx 350nm\))的约瑟夫森结的正常态电阻。无论\(InAs\)薄层电子密度如何,随着约瑟夫森结宽度的增加,都观察到正常态电阻(\(R_{N}\))呈双曲线式降低,这与关系式\(R_{N} = \rho \times \frac{t}{W}\)相符,其中\(t\)是\(InAs\)外延层的厚度。正常态电阻(\(R_{N}\))随着\(n_{2D}\)从\(10^{14}cm^{-2}\)降低到\(10^{12}cm^{-2}\)大约增加了十倍,这一趋势与图2e中所报道的电阻率增加情况相符(微小偏差可能与实际长度并非严格为350 nm有关)。基于所获得的开关电流和正常态电阻,约瑟夫森结显示出的临界电压(\(V_{C} = I_{S} \times R_{N}\))范围在50到80 μV之间,与长度、宽度以及\(InAs\)薄层电子密度无关(图S7b,支持信息)。在未来对基于绝缘体上砷化铟(InAsOI)的约瑟夫森结进行改进时,包括通过使用具有更高临界温度的超导引线来减小长度以达到短结状态,有可能像其他基于\(InAs\)的平台所报道的那样,将临界电压提高到毫伏(\(mV\))范围[39, 42]。现在我们来讨论约瑟夫森结(JJs)随温度变化的行为特性。图3g展示了一个长度(\(L\))为350 nm、宽度(\(W\))为10 μm且二维电子密度(\(n_{2D}\))约为\(10^{13}cm^{-2}\)的约瑟夫森结在0.05 K至1.5 K温度范围内的正向和反向电流 - 电压(\(V - I\))特性。正如所预期的那样,无论约瑟夫森结的长度(图3h)以及砷化铟(\(InAs\))薄层电子密度(图3i)如何,其开关电流和电流密度都随温度升高而单调递减。具体而言,随着约瑟夫森结长度增加以及\(InAs\)薄层电子密度降低,观察到开关电流(\(I_{S}\))随温度升高受到强烈的抑制作用。关于\(I_{S}\)与温度(\(T\))曲线的更多深入见解可在支持信息中找到。在\(n_{2D} \approx 10^{13}cm^{-2}\)的情况下(图3h),长度(\(L\))大于500 nm的约瑟夫森结在温度高于1 K时呈现出完全的耗散行为,而长度(\(L\))小于等于500 nm的约瑟夫森结在温度高达1.25 K时仍能观察到超电流。另一方面,就本工作所测试的最小电极间距(即350 nm)而言,采用\(n_{2D} \geq 10^{13}cm^{-2}\)制作的约瑟夫森结在温度高达1.25 K时仍存在开关电流(\(I_{S}\)),而采用\(n_{2D} \approx 10^{12}cm^{-2}\)制作的约瑟夫森结在温度高于1 K时呈现出完全的耗散行为(图3i)。后一结果与图S8(支持信息)中所示的电阻随温度变化的行为相符。在采用\(n_{2D} \geq 10^{13}cm^{-2}\)的绝缘体上砷化铟(InAsOI)上制作、长度(\(L\))为350 nm的约瑟夫森结呈现出的临界温度(\(T_{C}\))与铝(\(Al\))的临界温度相等,即1.22 K。另一方面,采用\(n_{2D} = 10^{12}cm^{-2}\)样品制作的约瑟夫森结其临界温度(\(T_{C}\))为0.93 K。所获得的这些临界温度表明,使用具有更高临界温度的超导体(例如铌(\(Nb\)))能够使基于\(InAsOI\)的器件在液氦温度下运行,从而无需使用稀释制冷机。我们还通过收集再捕获电流随温度变化的行为并评估百分比比率\((I_{S} - I_{R}) / I_{S}\)来评估约瑟夫森结的热惯性[67]:该比率越低,约瑟夫森结的热惯性就越低,反之亦然。图S9(支持信息)展示了针对具有不同长度、宽度以及\(InAs\)薄层电子密度的约瑟夫森结所计算出的\((I_{S} - I_{R}) / I_{S}\)。在50 mK时,约瑟夫森结的该比率处于50% - 75%之间,且无论约瑟夫森结的长度、宽度以及\(InAs\)薄层电子密度如何,该比率在750 mK时逐渐降至0%。接下来,我们评估了约瑟夫森结(JJ)在不同面外磁场(\(B_{\perp}\))值下的行为,因为通过面外磁场介导的量子干涉对开关电流进行调制是约瑟夫森效应的一个重要特征。图4以及支持信息中的图S10展示了具有不同长度、宽度、砷化铟(InAs)薄层电子密度以及温度的不同约瑟夫森结的开关电流随面外磁场变化的趋势。无论约瑟夫森结的形貌、砷化铟(InAs)薄层电子密度以及温度如何,当对约瑟夫森结施加面外磁场(\(B_{\perp}\))时,开关电流都会遵循一种类似夫琅禾费(Fraunhofer)的特征模式:\[I_{S}(B_{\perp}) = I_{S}\vert_{B_{\perp}=0} \times \left|\frac{\sin(\pi B_{\perp}A_{eff} / \Phi_{0})}{\pi B_{\perp}A_{eff} / \Phi_{0}}\right|\]
其中,\(A_{eff} = \gamma \times W \times L\)是约瑟夫森结的有效面积,\(\Phi_{0} = \frac{h}{2e}\)是磁通量子(\(h\)为普朗克常数,\(e\)为电子电荷量)。\(\gamma\)是一个比例因子,它考虑了磁场聚焦以及与电极间距相比约瑟夫森结有效磁长度的增大情况。对于宽度(\(W\))远大于相干长度(\(\xi_{0}\))的超导 - 正常金属 - 超导(SNS)结,预计会出现类似正弦函数(\(sinc\))的夫琅禾费模式行为,这里的\(\xi_{0}\)是用于对SNS约瑟夫森结内涡旋态进行建模时与砷化铟(InAs)相关的相干长度[68, 69]。对于\(n_{2D} \approx 10^{12}cm^{-2}\)、\(10^{13}cm^{-2}\)和\(10^{14}cm^{-2}\)的砷化铟外延层,\(\xi_{0}\)分别估算为372 nm、619 nm和800 nm。这也与在砷化铟二维量子阱约瑟夫森结中的观测结果相符[17, 41, 43, 70, 71]。干涉图样的幅度会随着约瑟夫森结长度的减小(图4a)、温度的降低(图4d)以及约瑟夫森结宽度的增加(图4b)和砷化铟薄层电子密度的增加(图4c)而增大。另一方面,与有效面积(\(A_{eff}\))相关的干涉图样周期性会随着约瑟夫森结长度(图4a)和宽度(图4b)的增大而增大。在我们的观测中发现,夫琅禾费图样的周期性偏离了预期的理论值\(B_{\perp} = \Phi_{0} / (W \times L)\)。就所施加的磁场而言,观测到的周期性明显小于预期值。如前文所述,这种差异可归因于\(\gamma > 1\)[72, 73]。图S11(支持信息)给出了\(\gamma\)作为约瑟夫森结宽长比(\(W/L\))函数的计算结果。正如所预期的那样[74],\(\gamma\)与\(W/L\)呈线性关系,当\(W/L = 0\)时,其估计值为1(即不存在磁场聚焦)。我们还注意到,在中心瓣附近夫琅禾费图样的极小值略有增加,这在扩散型SNS结中较为典型,在这种结中,极小值处的开关电流值遵循高斯包络分布[75, 76]。最后,我们扩展了图4a底部所示的类夫琅禾费衍射图样的面外磁场范围,以获取干涉极小值(图S12,支持信息)。我们定义开关电流抑制因子(\(SF\%\))为:\[SF\% = 100 \times \frac{I_{S,\text{max}} - I_{S,\text{min}}}{I_{S,\text{max}}}\]
并且我们发现,在面外磁场扫描范围为960 μT时,开关电流抑制因子(\(SF\%\))为99.55%
3. 结论
在这项工作中,我们提出绝缘体上砷化铟(InAsOI)可作为开发超导电子学的一个开创性平台。将具有不同电子密度的半导体砷化铟(InAs)外延层生长在InAlAs变质缓冲层上,该缓冲层能有效地充当低温绝缘体,实现相邻器件的电隔离。利用铝作为超导体以及具有不同电子密度的绝缘体上砷化铟(InAsOI)制造出了不同长度和宽度的约瑟夫森结(Josephson Junctions)。通过改变约瑟夫森结的形貌特性以及InAs的电子密度,能够轻易地在数量级上对开关电流和超导电流密度进行调节。我们实现了7.3微安/微米的开关电流密度、50至80微伏的临界电压以及与所用超导体相等的临界温度。可以设想使用具有更高临界温度的超导体,以便让绝缘体上砷化铟(InAsOI)能在液氦温度下使用。对于所有的约瑟夫森结而言,其开关电流随面外磁场呈现出一种典型的类夫琅禾费(Fraunhofer)模式,据此计算出的开关电流抑制因子可达99.95%。这些成果为利用InAsOI平台来设计和制造具有高临界电流密度及优异门控特性的表面暴露约瑟夫森场效应晶体管开辟了道路。此外,InAs外延层的电子密度可在异质结构生长后通过掺杂剂注入或热扩散进行局部调节,从而在同一衬底上获得具有不同特性的量子器件。