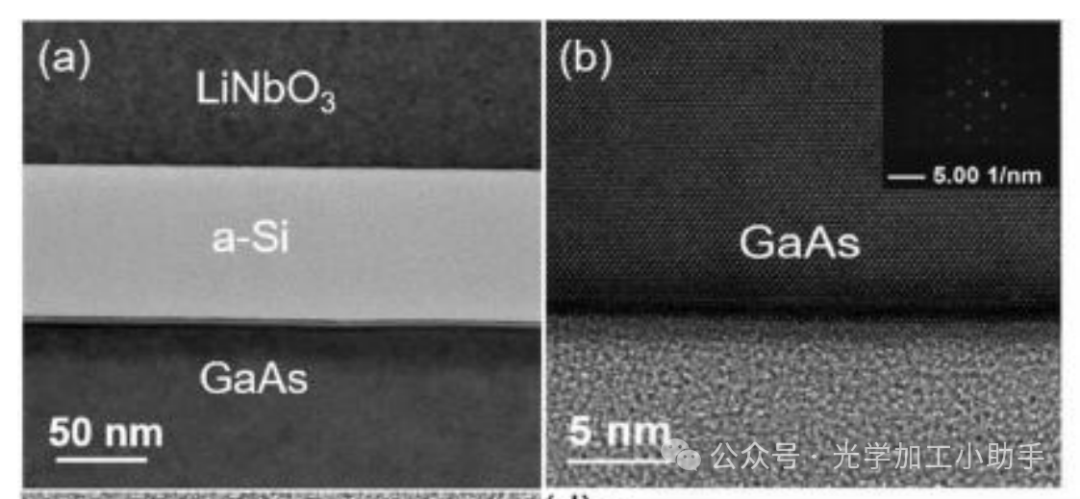
本文小编分享一篇文章,文章讲述的是铌酸锂 LiNbO3和GaAs的键合。
我们常见的键合技术 有硅玻璃键合 金金键合,金锡键合,金硅键合,临时键合等等 。但是当我们遇到一些需要低温键合,或者一些特殊材料时,或者应用场景时,上述键合方式很难满足一些特殊场景的应用,
因此科学家提出了表面活化键合技术,这种技术 使键合技术所覆盖的材料范围更加广泛,比如
GaAs-SiC,InP-Diamond, LN-SiC,Si-Si,GaN-Dlamond,Sl-Diamond,蓝宝石-蓝宝石,金刚石-sic, sic-inp,sic-LN, ic-ga2o3,glass--glass,Si-SiC,Si-GaAs、GaAs- SiC、Si–SiC、SiC–SiC、Ge–Ge 、Al 2 O 3 -Al 2 O 3 ,GaP-InP, GaN-Si、LiNbO 3 -Al 2 O 3 、LiTaO 3 -Si and more(晶体,陶瓷,等等)
扩展的多材料的体系,将键合技术扩大了应用范围
*MEMS传感器 *光子集成电路 *半导体激光器
*功率器件 *3D封装 *异质集成
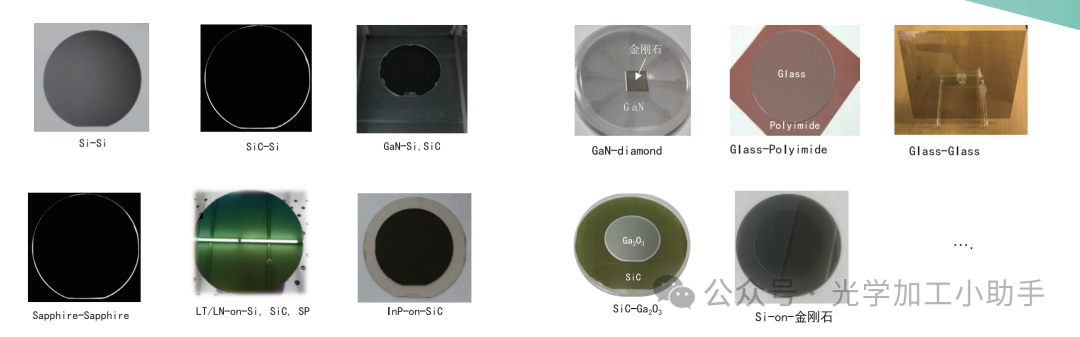
划重点--代工,代工,代工,卖设备
我们为客户提供晶圆(硅晶圆,玻璃晶圆,SOI晶圆,GaAs,蓝宝石,碳化硅(导电,非绝缘),Ga2O3,金刚石,GaN(外延片/衬底)),镀膜方式(PVD,cvd,Ald,PLD)和材料(Au Cu Ag Pt Al Cr Ti Ni Sio2 Tio2 Ti3O5,Ta2O5,ZrO2,TiN,ALN,ZnO,HfO2。。更多材料),键合(石英石英键合,蓝宝石蓝宝石键合)光刻,高精度掩模版,外延,掺杂,电子束直写等产品及加工服务(请找小编领取我们晶圆标品库存列表,为您的科学实验加速。
激光器芯片/探测器芯片/PIC芯片封装耦合服务"
请联系小编免费获取原文,也欢迎交流半导体行业,工艺,技术,市场发展

利用活化Si原子中间层实现了室温下LiNbO3与GaAs的异质集成,证明了其在GaAs基LiNbO3晶片制备中的有效性。利用活化Si原子中间层作为黏结层,成功将4英寸LiNbO3晶片直接键合到GaAs晶片表面,晶片键合率达到95%以上。键合后将LiNbO3/GaAs键合对切割成10×10 mm2的方形键合芯片,退火处理后方形键合芯片的最大键合强度超过22 MPa,这意味着LiNbO3/GaAs晶片的键合强度可以与块体材料相媲美。键合界面的表征结果证实了中间非晶Si层对于提高LiNbO3/GaAs异质结的键合强度和质量的有效方法。LiNbO3与GaAs等III-V族化合物半导体材料的异质集成有利于减少光通信平台的占用面积,提高器件整体效率。
1. 引言
铌酸锂 (LiNbO3) 晶体是一种优良的光折变材料。它是一种集电光、声光、非线性、光折变和激光活性于一体的晶体材料。因此,它被广泛应用于表面波滤波器、电光调制、电光开关、光波导和激光器、倍频、高密度信息存储等领域 [1–4]。LiNbO3 的宽带隙使其在紫外和中红外 (0.35–5 μm) 具有宽的透明窗口,可在很宽的波段范围内实现广泛的光学应用 [5]。同时,LiNbO3 晶体是一种双折射单轴晶体,在通信波段的寻常光折射率 no 为 2.21,非常光折射率 ne 为 2.14 [6]。较高的折射率能提供较强的光限制作用,因此LiNbO3晶体被广泛应用于各种光波导器件的制作[7–10]。在非线性光学应用方面,LiNbO3具有较高的二阶非线性极化率张量χ(2),其中最大分量d33为27p.m./V。此外,LiNbO3晶体还表现出优异的三阶非线性光学性能[11]。将LiNbO3优异的二阶和三阶非线性光学性能与相位匹配技术相结合,可以在LiNbO3平台上制备微型高效的光子器件,如电光调制、频率转换器、光频梳等光子器件[12–16]。此外,准相位匹配周期极化LiNbO3(PPLN)已成为成熟的集成光学平台。该光学平台在非线性光学、量子技术[17–19]等领域得到广泛应用。与LiNbO3晶体相比,GaAs晶体作为衬底材料可以为微波集成电路提供大面积的晶圆衬底,在电子器件领域得到广泛应用且提供较高的制造成品率[20–25]。但将光电探测器、光波导、激光光源等不同的器件集成在一起,需要不同的有源区来工作在通信波长下。LiNbO3晶体与GaAs等III-V族化合物半导体材料的集成有利于减少光通信系统的占用面积,提高器件的整体效率,因此实现LiNbO3与GaAs晶体的异质集成具有重要意义。
然而通过直接键合技术将LiNbO3与GaAs结合在一起是一个巨大的挑战,目前还没有相关研究的报道。LiNbO3的热膨胀系数(CTE)为14.4(a,b轴)-7.5(c轴)×10 − 6/K。GaAs晶体的CTE为6.4×10 − 6/K。LiNbO3和GaAs晶体之间巨大的CTE失配不可避免地会导致较大的热应力。因此,LiNbO3 / GaAs键合对由于键合强度不足而在退火过程中容易发生断裂。为了实现LiNbO3到GaAs衬底的集成,必须增加键合强度以抵抗退火过程中产生的热应力。K Watanabe等人。[26]利用活化的Si(a-Si)原子层作为黏合层,实现了4英寸LiNbO3/玻璃和LiNbO3/蓝宝石晶片的键合,晶片对的键合强度达到了23MPa。最终证明了a-Si原子层在提高键合强度方面的有效性。此外,等离子活化键合是一种非常有前途的异质材料集成方法。由于原子清洁光滑表面之间的吸引力,等离子活化工艺已成功实现了LiN-bO3/Si[27]、SiC/Si[28]、GaAs/Si[29,30]和金刚石/Si[31]的键合。因此,可以认为等离子活化键合法适用于形成直接键合的LiNbO3/GaAs晶片对。
本文首次报道了室温(RT)下LiNbO3/GaA异质结的制备。表面活化工艺采用氩气快原子束(Ar-FAB)轰击Sitarget,在两片晶圆表面沉积Si原子层,然后通过a-Si粘结层将LiNbO3与GaAs晶圆在室温下直接键合,通过切割测试、抗拉强度测试和键合界面形貌分析评估键合质量,LiNbO3/GaAs晶圆键合强度达到22MPa,据我们所知,这是迄今为止首次在室温下实现4英寸LiNbO3/GaAs复合晶圆的键合。
2.实验方法
实验采用X-cut精密抛光的LiNbO3和双面抛光的GaAs(100)单晶衬底,4英寸LiNbO3和GaAs晶片厚度分别为250μm和500μm。先后使用酒精和丙酮溶剂去除两片衬底表面的污染颗粒和有机物,再用HF和H2O比例为1:20的HF溶液腐蚀两片晶片表面的自然氧化物。两片晶片处理完毕后,依次与Si靶材一起放入磁控溅射室,关闭溅射室,待真空度降至1.0×10−5Pa,用Ar-FAB在2kV的加速电压下辐照Si靶材表面。在GaAs晶片表面沉积一层厚度为40nm的a-Si原子层。用同样的方法在LiNbO3晶片表面也制备一层厚度为40nm的a-Si层。该a-Si层可使两片晶片在室温下键合在一起,如图1所示。

图 1. 在室温下使用 a-Si 中间层制备 LiNbO3/GaAs 异质结的工艺示意图。
4英寸LiNbO3/GaAs晶片键合后,用扫描声学显微镜(SAM、SAM 301、PVA TePla)测量晶片键合速率。然后将键合对在退火炉的腔室中退火。LiNbO3/GaAs预键合晶片的退火温度为200◦C。退火时间保持在12小时。退火后,再次用SAM测试晶片。将预键合的LiNbO3/GaAs晶片切割成10×10 mm2的方形键合芯片。采用拉伸试验定量检测LiNbO3/GaAs晶片的键合强度,测试过程中采用环氧树脂胶将方形键合芯片固定于金属夹具上。
采用ESCALAB 250Xi X射线光电子能谱(XPS)检测LiNbO3和GaAs晶片的表面化学成分。采用单色Al Kα源,发射电压为20 kV,电子发射角为30°。分析区域直径为50 μm。系统使用400 nm大小的X射线束(12 kV/6 mA)。使用快照采集模式(150 eV通过能量)收集狭窄区域的信号,以便可以快速收集数据(每个区域5 s)。分析前,样品在真空室中溅射和蚀刻。Ar+的能量为1.5 keV,入射角为45°,样品分析时的基本压力为1×10 −9 Pa。测试期间不使用电荷中和剂。使用Shirley方法进行背景处理[32]。采用Dimension Icon原子力显微镜(AFM)测试两片晶圆的表面粗糙度平均值(Ra)。每次测量范围为10×10μm2。模式选择为轻敲模式。利用Titan Themis 200透射电子显微镜(TEM)表征LiNbO3/GaAs键合芯片的界面形貌。在观察之前,用Helios 450s聚焦离子束(FIB)系统将LiNbO3/GaAs样品的厚度减薄至100nm以下。然后,在200-300kV的加速电压下以不同的放大倍数观察界面形貌。用X射线衍射(XRD)校准界面处的晶格条纹。利用能量色散X射线(EDX)光谱定量测量界面元素的分布率。
3. 结果与讨论
3.结果与讨论
亲水性是表面活化键合的重要参数之一[33]。在待键合晶圆表面沉积a-Si层后,表面亲水功能团(如羟基、氨基等)的密度将显著增加。在晶圆直接键合过程中,界面处的亲水功能团会自发发生脱水反应,这是实现共价键合所必需的。因此,采用表面接触角测量仪来表征a-Si层沉积前后亲水基团的密度。亲水基团密度越大,亲水角越小。图2给出了沉积不同厚度a-Si层后LiNbO3和GaAs晶圆表面润湿角的统计结果。当没有a-Si层时,LiNbO3和GaAs裸晶圆的表面接触角分别为38.1°和84.9°。当表面逐渐沉积a-Si原子层时,两种晶片表面的接触角均明显减小,当a-Si原子层沉积厚度为0~2nm时,LiNbO3的表面接触角由38.1°逐渐减小至16.2°,GaAs的表面接触角由84.9°逐渐减小至14.3°。当厚度进一步增加到5nm以上时,两种晶片的表面接触角稳定在2°左右,此时液滴在晶片表面已经完全铺开,表面接触角尺寸已减小到测试仪的测量极限,说明两种晶片表面存在的亲水功能团已达到饱和状态,亲水功能团主要为羟基。
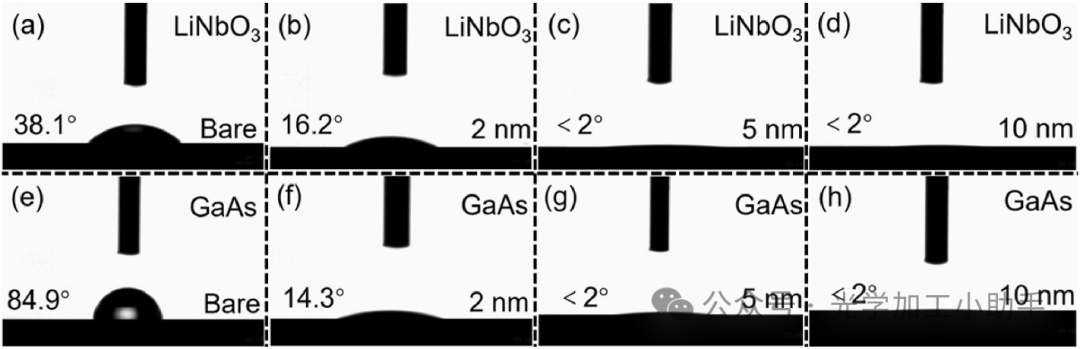
图2. 不同Si原子层沉积厚度下LiNbO3和GaAs表面的润湿角,(a)和(e)为未沉积Si原子层的LiNbO3和GaAs表面;(b)和(f)为2nm厚的Si原子层沉积表面;(c)和(g)为5nm厚的Si原子层沉积表面;(d)和(h)为10nm厚的Si原子层沉积表面。
待键合两片晶片的表面Ra对键合质量的影响也至关重要[34]。图3为a-Si原子层沉积对LiNbO3和GaAs晶片表面形貌影响的示意图。沉积前,LiNbO3和GaAs晶片的Ra分别为0.310nm和0.210nm,如图3(a)和(c)所示。相比之下,在Si原子沉积之后,LiNbO3和GaAs晶片的Ra变为0.390nm和0.372nm,如图3(b)和(d)所示。虽然Si原子沉积后LiNbO3和GaAs晶片的表面粗糙度略有降低,但晶片表面仍然保持光滑平整,满足晶片键合的要求。在LiNbO3和GaAs晶片表面沉积Si原子层后,在室温下将LiNbO3晶片与GaAs衬底键合。预键合完成后,用SAM表征键合质量,结果如图4(a)所示。扫描频率为250 MHz,焦距为7 μm。扫描模式选择为C模式,相当于对样品进行非物理横截面扫描。图4(a)显示,LiNbO3/GaAs晶片的整体键合率大于95%,仅在边缘处存在一小部分白色未键合区域。预键合后,将晶片对放入退火炉中进行退火。LiNbO3/GaAs晶片的退火温度缓慢升至200 ◦ C,并在200 ◦ C下维持12 h。为防止快速升温引起明显的热应力,升温速率设定为1◦C/min。退火过程中,以8L/h的速率向炉中陆续通入N2。退火结束后取出晶圆,对其表面进行超声波扫描,扫描结果如图4(b)所示,退火后整片LiNbO3/GaAs晶圆未出现明显的脱键合现象。与退火前的扫描结果相比,退火后边缘处未键合面积略有增加。为了揭示上述现象的原因,基于有限元分析建立了LiNbO3/GaAs键合模型。LiNbO3 和 GaAs 晶片厚度分别为 250 μm 和 500 μm,晶格常数分别为 0.5147 nm 和 0.565 nm,热膨胀系数分别为 14.4×10 −6/K 和 6.4×10 −6/K。图 5(a) 为键合结构 z 方向位移云图。不同温度下晶片模型的热应力分布和总变形如图 5(b)和(c)所示。随着退火温度从 100 ◦ C 升高到 400 ◦ C,4 英寸 LiNbO3/GaAs 晶片对的最大变形从 2.142 mm 增大到 10.381 mm。图 5(c) 为 LiNbO3/GaAs 晶片键合界面处产生的等效应力分布。从晶圆中心向两侧,应力始终均匀分布,但在距边缘2mm附近,应力增大至最大值后急剧减小,说明边缘附近的热应力很大,导致边缘键合困难。另外,退火温度的升高只会增加界面处的应力,而不会改变应力分布。
对LiNbO3/GaAs晶片进行SAM成像后,需要测定晶片的键合强度。首先,将4英寸的LiNbO3/GaAs晶片切割成10×10 mm2的方形键合芯片。然后将切割好的方形键合芯片分别在100 ◦ C,200 ◦ C,300 ◦ C和400 ◦ C下退火12 h。退火后,用环氧树脂粘合剂将方形键合芯片固定在金属夹具上。金属夹具以1 mm/min的速率缓慢移动。测量方形键合芯片的键合强度。图6给出了芯片的键合强度测量值。未经退火的LiNbO3/GaAs晶片的键合强度为5.7 MPa。当样品在200 ◦ C退火时,LiNbO3/GaAs键合对达到其最大键合强度22 MPa。当退火温度进一步升高时,键合强度开始下降。因此,最佳退火温度确定为200 ◦ C。
图7(a)为LiNbO3/GaAs晶片的实物图。采用a-Si原子层作为中间层制备的LiNbO3/GaAs晶片的键合强度也用刀片插入法进行表征,如图7(b)所示。将刀片插入LiNbO3/GaAs晶片中间的a-Si层。通过测量LiNbO3表面裂纹扩展长度,可以计算出LiNbO3/GaAs晶片的键合强度。计算LiNbO3/GaAs键合能的公式如下[26,35,36]:

其中γ为LiNbO3/GaAs晶片的键合强度;tb为刀片厚度(1mm);tLiNbO3和tGaAs分别为LiNbO3和GaAs晶片的厚度;ELiNbO3和EGaAs分别为LiNbO3和GaAs晶片的杨氏模量;L为裂纹扩展长度。在此测试过程中,刀片插入过程是在大气环境中进行的。通过刀片插入法计算出的键合能可以作为键合强度测试的补充。刀片插入和拉伸强度测试都可以衡量LiNbO3/GaAs晶片的键合质量。
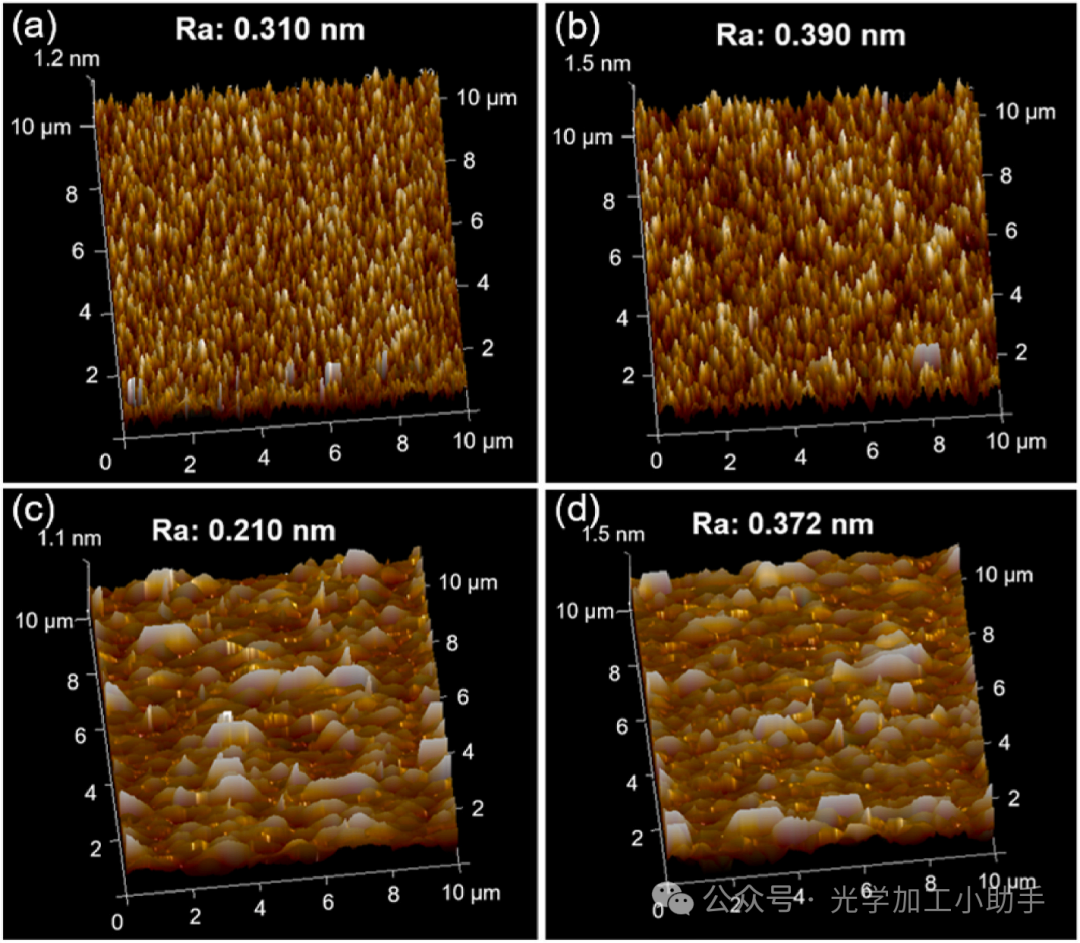
图3. (a)和(c)分别是沉积a-Si层之前LiNbO3和GaAs晶片的Ra;(b)和(d)分别是沉积a-Si层之后LiNbO3和GaAs晶片的Ra。
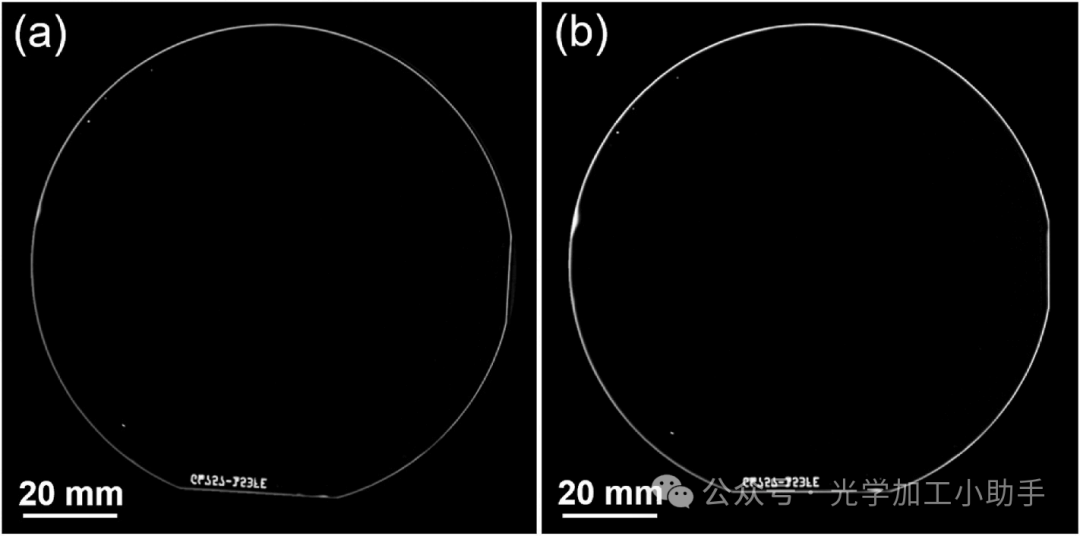
图 4. LiNbO3/GaAs 键合对的 SAM 图像,(a) 退火前的 LiNbO3/GaAs 键合对;(b) 退火后的 LiNbO3/GaAs 键合对。
在测试完LiNbO3/GaAs晶片的键合强度后,利用TEM研究了LiNbO3/GaAs键合界面的纳米结构状态。图8(a)为高分辨率的LiNbO3/GaAs键合界面结构,界面处没有原子级的裂纹或空洞。在LiNbO3/GaAs界面处可以观察到80nm厚的a-Si原子层。该a-Si层是通过用Ar-FAB轰击Si靶材沉积在LiNbO3和GaAs晶片表面的。此外,通过观察图8(b)-8(f),非晶态Si原子层中含有少量的氧元素,这是由于Si靶材表面自然氧化所致。同时,在LiNbO3晶片表面还观察到少量的Ga和As元素的聚集。这是由于高能Ar原子轰击Si靶,Ar原子将自身的能量转移给Si原子,Si原子获得能量后与GaAs表面的Ga和As原子发生碰撞,Si原子又将自身的能量转移给Ga和As原子。由于GaAs与LiNbO3晶片并排摆放,少量的Ga和As原子会积聚能量并沉积在LiNbO3晶片表面,这个过程被称为原子级联碰撞运动。图9为界面的STEM-EDS分析结果,主要检测界面处Ga、As、Si、O和Nb的元素分布情况,确定各原子的原子比例,具体分布情况如图9(d)所示。图9(a)进一步证实了非晶Si纳米粘附层中不存在裂纹和空洞。图 9(b) 为 GaAs 侧与非晶 Si 层界面,Ga 原子与 As 原子紧密结合,达到原子级接触。图 9(c) 为 LiNbO3 侧与非晶 Si 原子层界面,可确认 Si、O、Nb 原子间无间隙。以上结果显示键合界面的原子结构状态可提供足够强的键合强度,以承受 FIB 制程减薄晶圆的条件。

图5. 4英寸LiNbO3/GaAs晶片键合模型,(a)键合结构z方向位移云图;(b)不同退火温度下LiNbO3/GaAs晶片z方向总变形;(c)不同退火温度下LiNbO3/GaAs晶片界面热应力。

图6. LiNbO3/GaAs晶片键合强度随退火温度变化示意图。
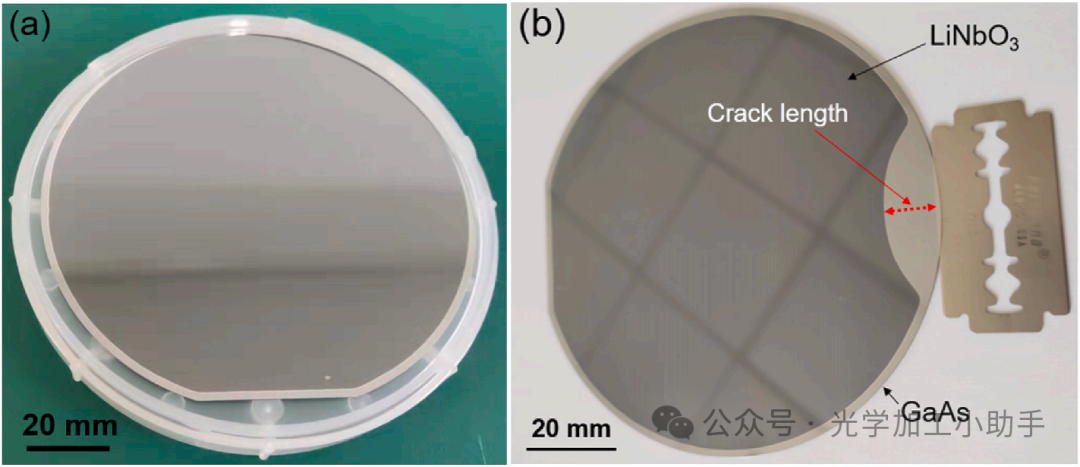
图7. (a) 键合LiNbO3/GaAs晶片的物理图;(b) 通过刀片插入对LiNbO3/GaAs进行键合能测量。
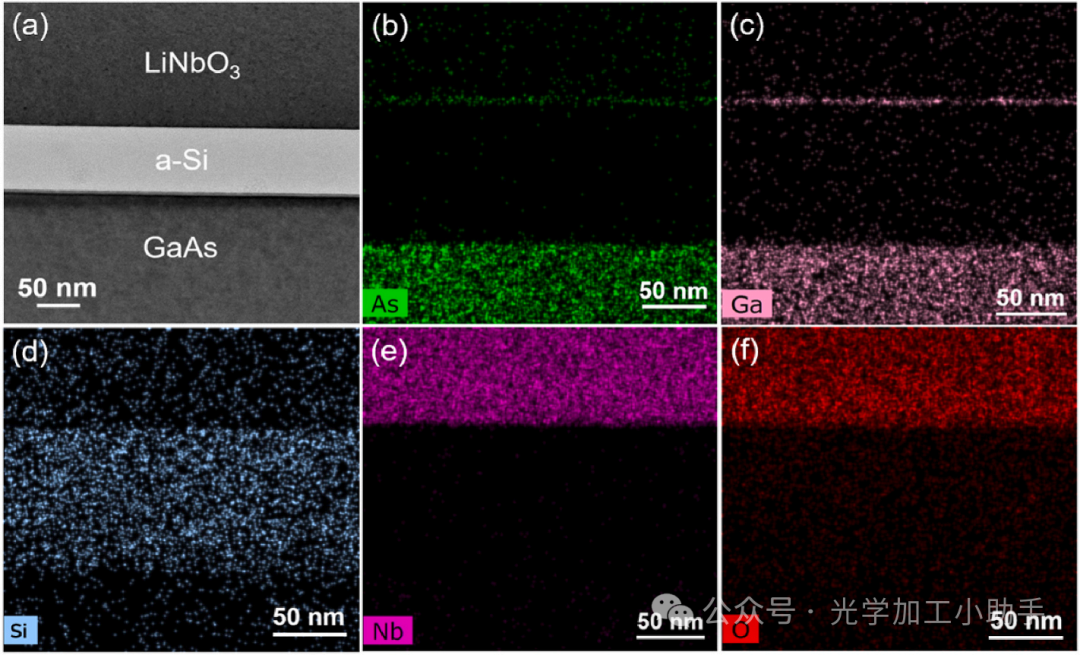
图8. LiNbO3/GaAs键合界面示意图,(a)界面TEM图像,(b)–(f)界面元素As、Ga、Si、Nb和O的分布。
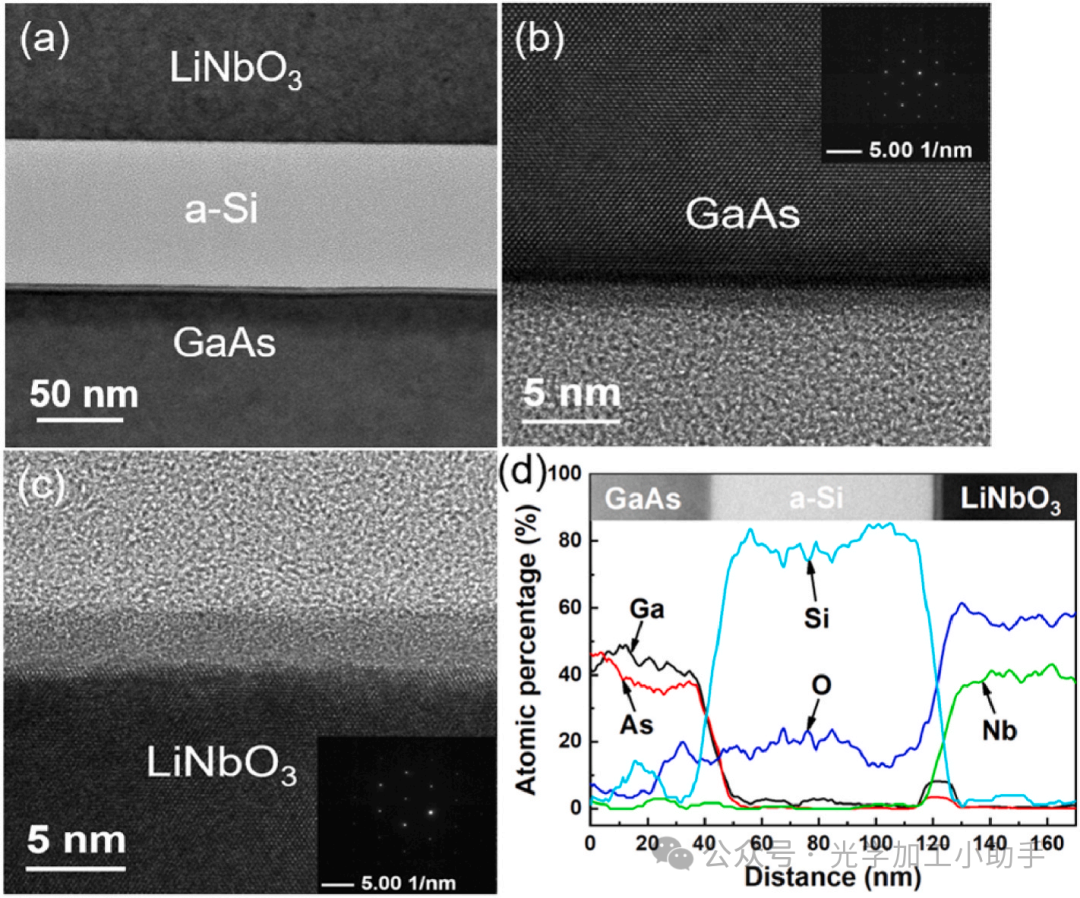
图 9. LiNbO3/GaAs 键合界面的 TEM 图像,(a) 界面概览,(b) GaAs/a-Si 侧界面图像,(c) LiNbO3/a-Si 侧界面图像,以及(d) 界面元素的百分比分布。
LiNbO3样品表面的校正峰位置为EB=289.58–6.2=283.38eV;GaAs样品表面C1s校正峰位置为EB=289.58–4.55=285.03eV。图10中,初始LiNbO3和GaAs样品表面均未检测到Si元素,存在的主要元素为Nb、O、Ga、As等元素。当Si原子层沉积完成后,表面主要由Si和O元素组成,此时O元素的信号峰强度较弱。当将键合好的样品脱键合后,再次测试样品表面的元素组成,从图中可以确定O元素的信号峰有所增强,说明Si原子层受到了进一步的氧化。我们还对4种不同条件下样品表面主要元素进行了表征,得到了图11所示的结果。如图11(a)~11(c)所示,初始LiNbO3表面主要由Nb、NbO和Li–O等元素结构组成,表面含有一定的亲水基团(–OH)。图11(d)~11(f)为初始GaAs表面的元素组成。从图中可以看出,GaAs表面主要由GaAs、Ga2O3和As2O3组成,不存在Si元素。沉积Si原子层之后,样品表面主要以Si–O等形式存在,如图11(g)~11(i)所示。
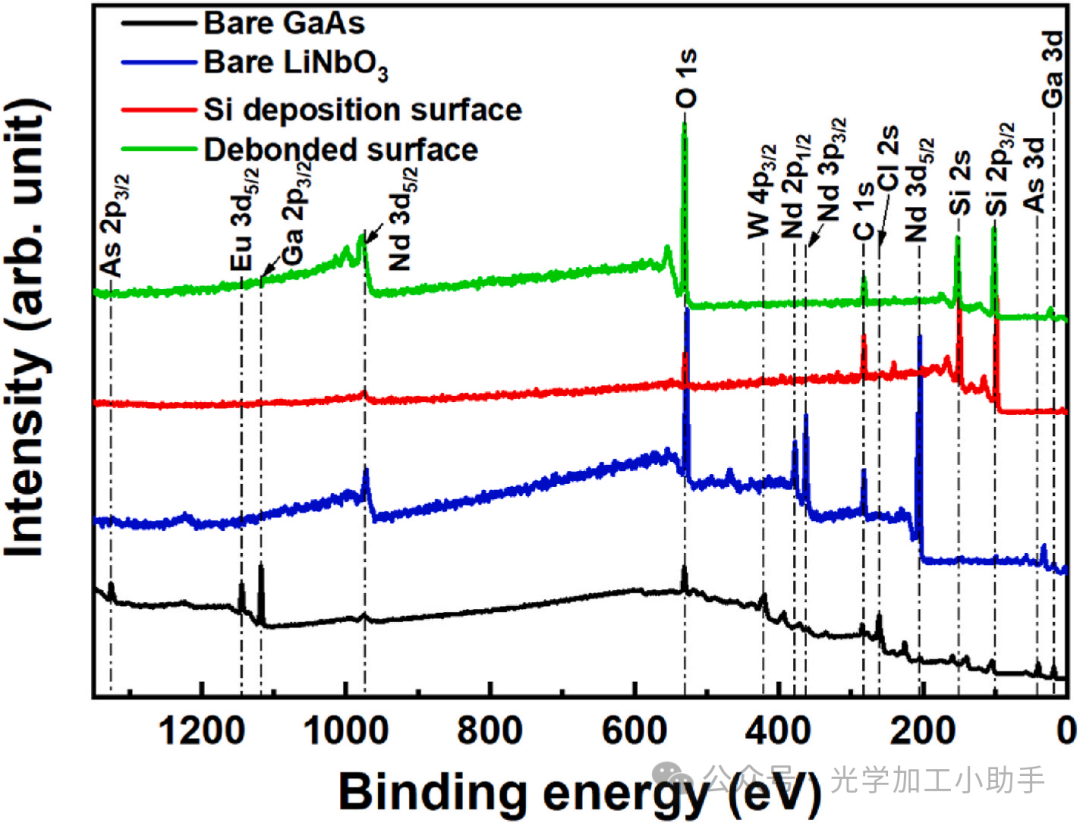
图 10. 初始 LiNbO3 样品、初始 GaAs 样品、Si 沉积表面和脱粘表面的 XPS 全光谱曲线。

图11. 各元素XPS能谱曲线。(a)~(c)分别为初始LiNbO3表面Nb、Li、O元素的XPS能谱曲线;(d)~(f)分别为GaAs表面As、Ga、O元素的初始XPS能谱曲线;(g)~(i)分别为Si沉积表面C、O、Si元素的XPS谱;(j)~(l)分别为脱粘表面C、O、Si元素的XPS谱。
表面O元素信号峰不强,说明真空溅射过程中表面未被氧化,O元素的引入主要由Si靶表面的自然氧化层引起[47]。键合晶片脱键后,再次对表面进行XPS测试,如图11(j)-11(l)所示,相对于表面Si的沉积,O元素的信号峰进一步加强,说明在大气环境键合过程中以及随后的键合强度和XPS测试中,Si原子层表面被进一步氧化。同时,在LiNbO3和GaAs侧均检测到Si和O元素信号峰,LiNbO3/GaAs键合对的高键合强度主要是通过Si原子层实现的。此外,在LiNbO3/a-Si侧,图8(f)显示了LiNbO3中的氧向a-Si层中的扩散。但图8(e)中Nb元素并未发生扩散,说明键合过程中氧元素以LiO2-的形式扩散到了a-Si层中。在GaAs/a-Si侧,图9(d)中可以看到Ga和As原子向a-Si层方向的扩散,同时Si和O原子也扩散到了GaAs晶片内部。以上实验结果可以说明,LiNbO3/a-Si界面处Li和O元素的扩散以及GaAs/a-Si界面处Ga、As、Si和O元素的扩散有助于LiNbO3/GaAs键合过程中形成强键合界面。由于Nb元素的存在形式比较稳定,未发现任何扩散现象,因此Nb的存在对键合强度几乎没有影响。通过表面亲水性实验得知,在LiNbO3和GaAs晶片表面沉积Si原子层可以大大改善表面亲水性,为增强LiNbO3/GaAs异质结的键合强度奠定了基础。另外,基于有限元分析建立了LiNbO3/GaAs热应力模型,得到了退火温度100 ◦ C~400 ◦ C范围内界面热应力和晶片翘曲的变化曲线。整体来看,随着退火温度的升高,界面热应力和晶片翘曲增大。因此,一味提高退火温度来增强晶片的键合强度是不可取的。随后,我们通过拉力测量和刀片插入实验测量了不同温度下晶片的键合强度。在退火温度200 ◦ C时,我们获得了最大的键合强度。对键合晶片进行退火处理后,为了分析LiNbO3/GaAs异质结的键合机理,我们基于TEM和XPS分析了晶片界面和表面的纳米结构和化学成分。首先,从界面形貌可以看出,界面键合比较紧密,不存在缝隙。此外,对LiNbO3/a-Si和a-Si/GaAs界面的EDS测量发现,界面处存在元素的相互扩散,可以进一步增强界面的键合强度。为了验证上述解释,我们利用XPS测量了初始GaAs、初始LiNbO3以及沉积和脱键后Si的表面元素组成。在初始GaAs和LiNbO3表面均未检测到Si元素,而在脱键后的GaAs和LiNbO3表面均检测到了Si及其氧化物形式。以上结果表明LiNbO3/a-Si和a-Si/GaAs界面比较致密,且LiNbO3/GaAs异质结的分离主要通过Si原子层的分裂实现,有效地证明了Si原子层在连接LiNbO3与GaAs晶片方面的有效性。
4. 结论
本文通过a-Si层对4英寸LiNbO3与GaAs晶片进行了室温键合,采用Si原子层作为黏合层,通过拉伸强度和刀片插入法测量,实现了键合强度超过22MPa的LiNbO3/GaAs异质结,该键合强度足以满足GaAs基LiNbO3器件的要求。a-Si层的沉积可以提高LiNbO3和GaAs晶片的亲水性。TEM照片显示键合界面致密,无裂纹和空洞。通过STEM-EDX和XPS的表征可以得到键合界面元素的成分行为,有助于阐明a-Si层作为黏合层的LiNbO3/GaAs室温键合机理。采用a-Si层作为粘结层的RT键合方法,可以实现激光光源、LiNbO3光波导、LiNbO3电光调制器等的集成,减少光通信系统的占用面积,提高器件整体效率。