本文分享一篇文章,关于表面活化键合技术的应用 。本文介绍了 碳化硅和砷化镓材料的键合技术,我们都知道砷化镓材料可以被用来制造vcsel激光器,碳化硅具有极好的热导率,将砷化镓材料键合在碳化硅材料上,可以制造出高功率的,具有极高热导率的vcsel激光器芯片。
本文展示了通过室温 SAB 方法在晶圆级制造 GaAs/SiC 结构,以实现直接键合在 SiC 基板上的薄膜半导体激光器。SiC 的热导率是 Si 的三倍,并且在室温下高于铜。首先,通过有限元法评估焊料材料及其厚度对热阻的影响。然后,通过实验研究了 GaAs 和 SiC 的晶圆键合。
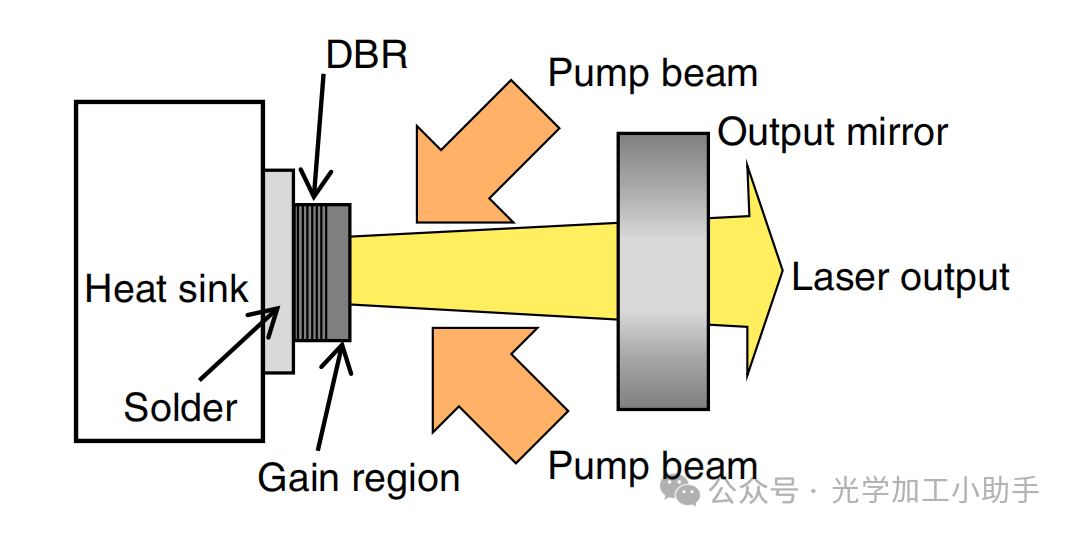
我们常见的键合技术 有硅玻璃键合 金金键合,金锡键合,金硅键合,临时键合等等 。但是当我们遇到一些需要低温键合,或者一些特殊材料时,或者应用场景时,上述键合方式很难满足一些特殊场景的应用,
因此科学家提出了表面活化键合技术,这种技术 使键合技术所覆盖的材料范围更加广泛,比如
GaAs-SiC InP-Diamond LN-SiC
Si-Si, GaN-Dlamond, Sl-Diamond,
蓝宝石-蓝宝石, 金刚石-sic, sic-inp,
sic-LN, sic-ga2o3, glass--glass
Si-SiC,Si-GaAs、GaAs- SiC、Si–SiC、SiC–SiC、Ge–Ge 、Al 2 O 3 -Al 2 O 3 ,GaP-InP, GaN-Si、LiNbO 3 -Al 2 O 3 、LiTaO 3 -Si
扩展的多材料的体系,将键合技术扩大了应用范围
*MEMS传感器 *光子集成电路 *半导体激光器
*功率器件 *3D封装 *异质集成
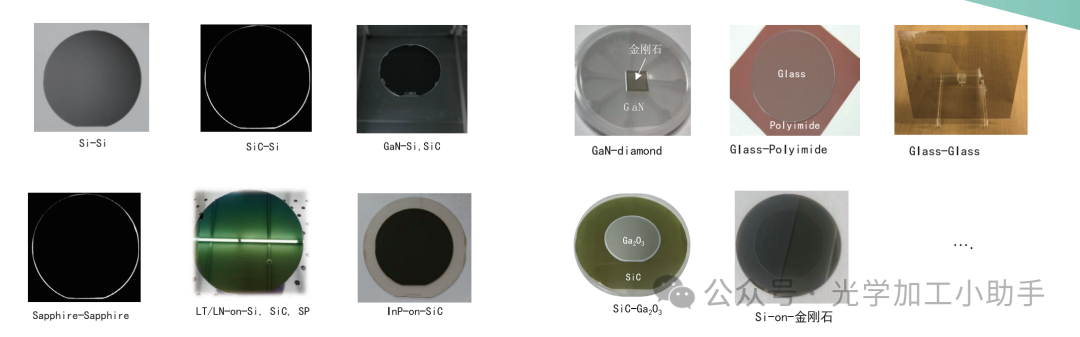
划重点--代工,代工,代工,卖设备
这种技术,小编前面分享的有些文章中有提到,但是当时小编才疏学浅,未能把握住这个技术的核心,但是最近,命运安排人咨询我
a.GaN-Diamond b.Si-Si c.恰好我在分享碳化硅集成光子学,这个技术也是核心之一。
因此小编后续的重心将会放在基于SAB的先进多材料键合技术的知识分享
划重点:小编提供基于si+sio2+sic(SAB键合)+减薄+cmp全套工艺的4H半绝缘碳化硅基片,助力碳化硅光子学发展。
我们为客户提供晶圆(硅晶圆,玻璃晶圆,SOI晶圆,GaAs,蓝宝石,碳化硅(导电,非绝缘),Ga2O3,金刚石,GaN(外延片/衬底)),镀膜方式(PVD,cvd,Ald,PLD)和材料(Au Cu Ag Pt Al Cr Ti Ni Sio2 Tio2 Ti3O5,Ta2O5,ZrO2,TiN,ALN,ZnO,HfO2。。更多材料),键合(石英石英键合,蓝宝石蓝宝石键合)光刻,高精度掩模版,外延,掺杂,电子束直写等产品及加工服务(请找小编领取我们晶圆标品库存列表,为您的科学实验加速。
激光器芯片/探测器芯片/PIC芯片封装耦合服务"
请联系小编免费获取原文,也欢迎交流半导体行业,工艺,技术,市场发展!

合集
金刚石半导体--金刚石和氮化镓的集成和键合--干货满满
金刚石半导体--在大气条件下磷化铟与金刚石衬底的低温直接键合
碳化硅+PIC--用于碳化硅集成光子学的高品质碳化硅薄膜的制备及损耗测量
干活满满-表面活化键合技术--用于低温键合的表面活化键合方法
室温下对 GaAs 和 SiC 晶片进行表面活化键合,以改善高功率半导体激光器的散热
Eiji Higurashi*, Ken Okumura, Kaori Nakasuji, and Tadatomo Suga
Department of Precision Engineering, School of Engineering, The University of Tokyo, Bunkyo, Tokyo 113-8656, Japan
1. 简介
紧凑型高功率半导体激光器是各种科学和工业仪器的关键部件,包括激光投影显示和荧光分析系统,如共聚焦显微镜和流式细胞仪。最近,垂直外腔面发射激光器 (VECSEL)1,2) 也称为光泵浦半导体激光器 (OPSL) 或半导体盘激光器 (SDL),由于其高输出功率、高效率和出色的光束质量而备受关注。图 1 显示了 VECSEL 的典型结构。由增益区和分布式布拉格反射镜 (DBR) 组成的半导体薄膜安装在散热器上。半导体增益区由由屏障区隔开的量子阱组成,并由二极管激光器光泵浦。激光谐振器形成在 DBR 和外部镜子之间。这种结构通过调整半导体材料的成分,实现了从近紫外到中红外区域的宽光谱范围内的激光发射。然而,高功率半导体激光器的热管理至关重要,因为其性能受增益区温度的影响。高温会降低激光输出功率(热翻转)。因此,对于高功率半导体激光器来说,通过改善散热来抑制温度上升非常重要。
为了最大限度地降低增益区的温度,将半导体薄膜(例如 5-7µm)的镜面朝下通过焊料键合2,3)或亲水键合(例如液体毛细管键合4))安装到散热器上。然而,
焊料芯片粘接材料的热导率不是很高,例如 AgSn(3.5wt% Ag,熔化温度:221°C)和 AuSn(80wt% Au,熔化温度:280°C)。
亲水键合通常需要在晶圆初次接触后进行高温退火步骤,以确保形成牢固的键合。由于热膨胀系数 (CTE) 不匹配,这会产生高热应力。亲水键合还会产生薄的界面氧化层,从而增加界面热阻。表面活化键合 (SAB) 是一种很有前途的传统键合方法的替代方法。SAB 是一种室温键合方法,已被证明可用于多种半导体材料,如 Si/Si、5) Si/GaAs、6–8) Si/InP、6,7) 和其他组合。9,10) 最近,SAB 已用于形成用于功率器件应用的直接键合 Si/SiC11–15) 和 SiC/SiC16,17) 接口。
在本研究中,我们展示了通过室温 SAB 方法在晶圆级制造 GaAs/SiC 结构,以实现直接键合在 SiC 基板上的薄膜半导体激光器。SiC 的热导率是 Si 的三倍,并且在室温下高于铜。首先,通过有限元法评估焊料材料及其厚度对热阻的影响。然后,通过实验研究了 GaAs 和 SiC 的晶圆键合。
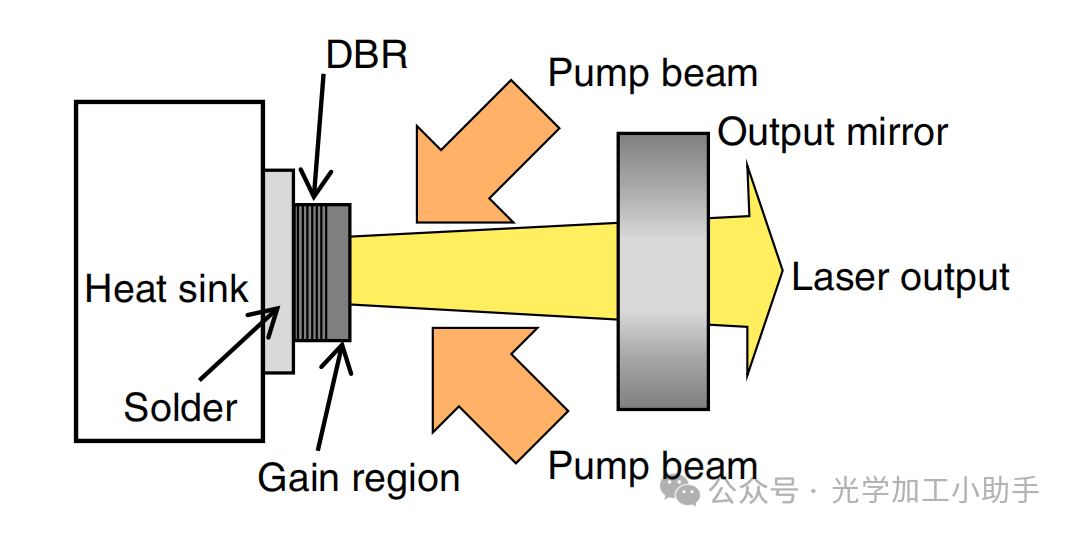
图 1. (在线彩色)典型 VECSEL 的示意图。
2. 热阻的有限元模拟
VECSEL 的热分析已在先前的一些研究中进行了。18,19) 热阻 Rth 是决定有效增益区温度的关键参数,它被定义为增益区温升 ¦T (K) 与产生的热功率 Pheat (W) 之比:
Rth = (1)
由于增益区的温度随热阻的增加而增加,因此应尽量减小热阻。
热阻已通过有限元模拟进行了评估。MemsONE 软件20) 用于执行二维 (2D) 有限元热分析。
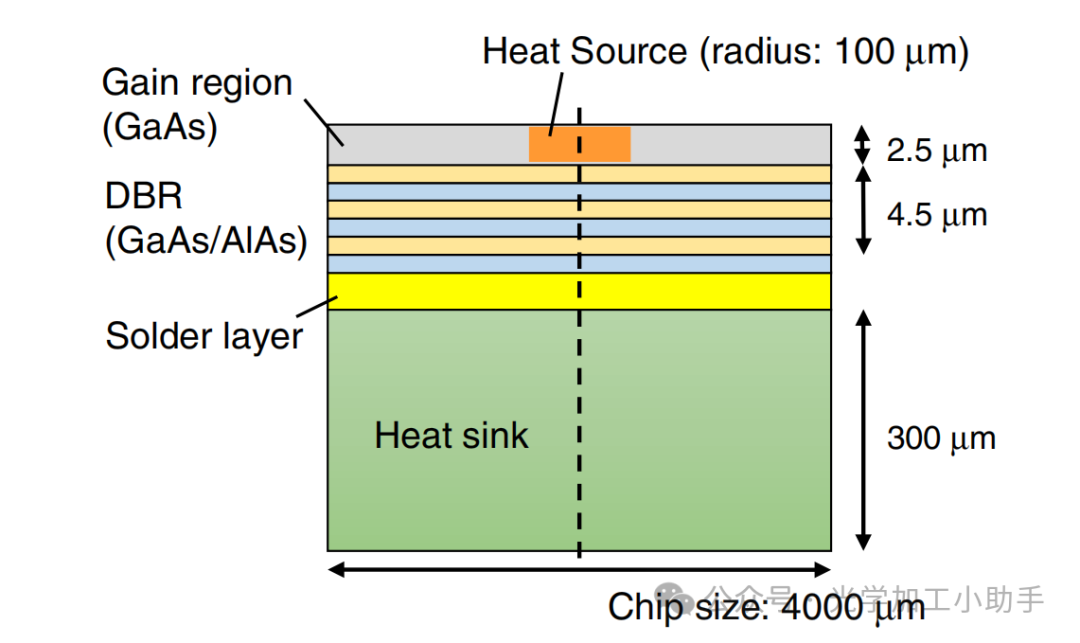
图 2. (在线彩色)用于热模拟的 2D 建模结构示意图(不按比例)。

图 2 显示了用于热模拟的简化 2D 建模结构。假设在有源增益区域中心有一个均匀的圆柱形热源(半径:100µm,高度:2.5µm)。假设与外部区域的热交换仅通过 DBR、键合层和散热器进行。由于对流冷却可以忽略不计,因此在结构的侧壁和顶面上施加了绝热边界条件(无热流)。SiC 散热器底面的边界条件是温度保持恒定(25°C)。模拟中使用的材料参数总结在表 I 中。21,22)
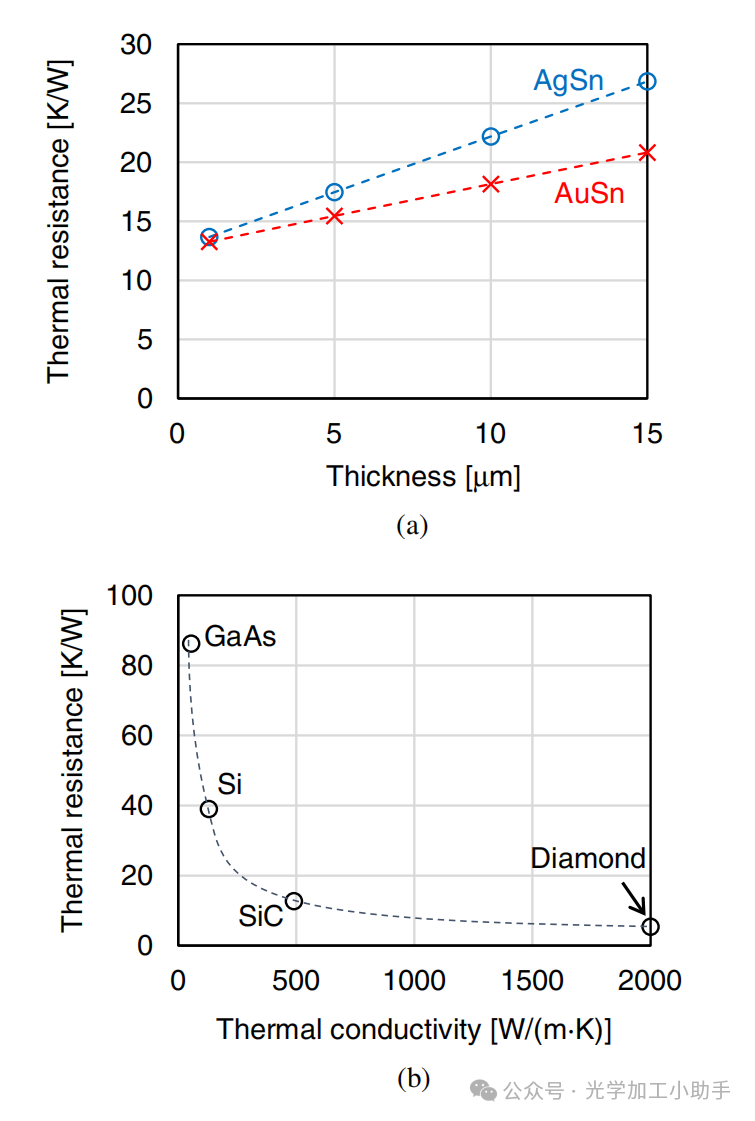
图 3. (在线颜色) 模拟热阻。(a) 热阻与焊料层厚度的关系。(b) 热阻与不同散热器材料热导率的关系(无焊料层)。
模拟结果如图 3 所示。图 3(a) 显示了焊料层厚度对不同焊料材料(AgSn、AuSn)热阻的影响。由于 GaAs 和 DBR 的热导率相对较低,半导体薄膜本身会引起很大的热阻。焊料厚度增加,总热阻随之增加。虽然 AuSn 而非 AgSn 可以提高热阻,但在直接键合配置 (12.7K/W) 中,热阻可以显著降低。当分别去除 10 µm 厚的 AgSn 和 AuSn 层时,热阻可以降低约 43% 和 30%。
为了了解不同散热器材料热导率的影响,绘制了热阻与各种散热器热导率(无焊料层)的关系图 [图 3(b)]。要使用散热器显著提高热阻,需要热导率高于约 500W/(m.K)。但是,对于高于约 500W/(m.K) 的高热导率,热阻的下降率会变小。实际上,SiC 已被证明可作为 VECSEL 应用的有效散热材料。23)
3. GaAs/SiC 晶片键合实验研究
3.1 实验步骤
键合实验采用 2 英寸化学机械抛光 SiC(0001) 晶片(多型:4H 或 6H,厚度:350µm)和 2 英寸或 3 英寸 GaAs(100) 晶片(厚度:350–450µm)。使用原子力显微镜 (AFM) 扫描键合晶片上 1.0 × 1.0µm2 的表面积来测量晶片的表面粗糙度。
SAB 程序从在超高真空键合设备中用氩快原子束 (Ar-FAB) 轰击激活晶片表面开始。当真空度达到 5 × 10¹6Pa 时,用 Ar-FAB 源同时激活两个晶片表面 200–600 秒,电压为 1.5kV,电流为 60mA。在 Ar-FAB 辐射后,晶圆在室温下与真空中施加 2.45kN 的力接触,但不暴露于环境压力下。
键合后,将键合晶圆切成 10 × 10mm2 大小的芯片,并使用万能材料试验机 (Tensilon RTG-1225) 测量拉伸键合强度。
使用在 300kV 下运行的透射电子显微镜 (TEM;Hitachi H-9000NAR) 观察键合界面的微观结构。界面中的空隙会导致局部热点,但直接键合的好处是可以通过没有任何空隙的高质量键合界面实现。
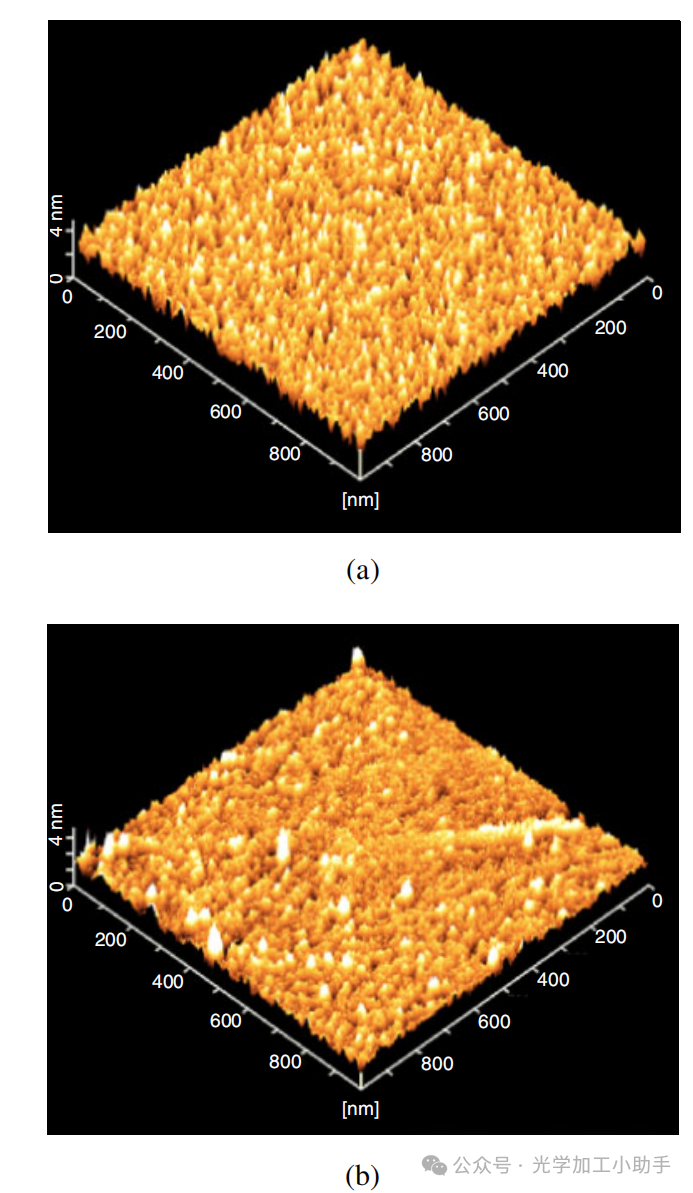
图 4. (在线彩色) 原子力显微镜测量的表面形貌。(a) GaAs 晶片,(b) SiC 晶片。均方根粗糙度小于 0.5nm,适合直接键合。
3.2 实验结果
图 4 显示了 (a) GaAs 和 (b) SiC 表面的典型 AFM 图像。测得的 GaAs 和 SiC 晶片的表面粗糙度 (Rrms) 分别为 0.45 和 0.22nm。这些值足以实现直接晶片键合。在 Ar 束蚀刻 400 秒之前 (GaAs:0.45nm,SiC:0.22nm) 和之后 (GaAs:0.40nm,SiC:0.39nm),表面粗糙度 (Rrms) 的变化并不明显。
GaAs 和 SiC 晶片通过 SAB 成功键合,无需任何热处理。图 5(a) 显示了在室温下通过 SAB 制备的 2 英寸 SiC/3 英寸 GaAs 晶片对的照片。在界面处观察到一些空隙 (未键合区域),这可能是由键合晶片上存在的颗粒引起的。将键合晶圆切成 10 × 10mm2 块,如图 5(b) 所示。界面能足够高,可以切割键合晶圆对。样品对 (10 × 10mm2) 的两侧都粘在拉力试验机的附件上,并增加拉力直到样品分离。键合强度是通过将断裂时记录的力除以样品面积得到的。GaAs/SiC 的估计平均键合强度为 4.6MPa,高于之前报道的键合晶圆 (GaAs/Si: 0.6MPa8))。断裂主要发生在键合界面上,但有时也发生在块体 GaAs 内部。
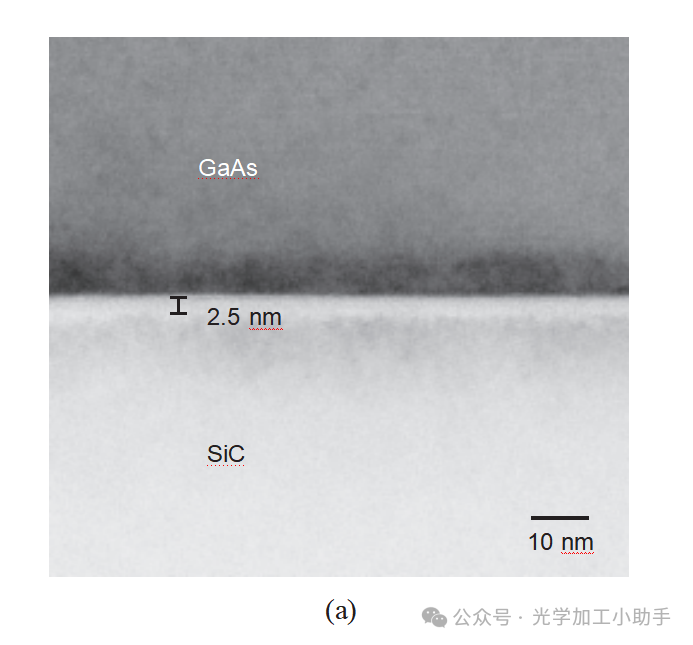
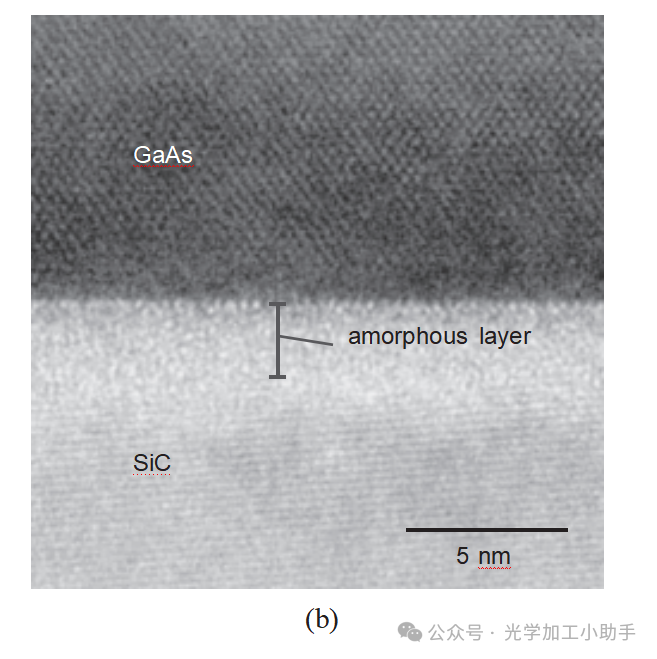
图 6 显示了室温下通过 SAB 键合的 GaAs/SiC 界面的横截面 TEM 图像。TEM 观察表明,大部分界面光滑且无微孔,实现了原子级直接键合。观察到 GaAs/SiC 界面具有无序的非晶态中间层(厚度:约 2.5nm),这可能是由 Ar-FAB 辐射形成的。对于通过 SAB 键合的 Si/SiC 晶片,还报道了键合界面处的非晶层。11,13)
4. 结论
我们研究了 GaAs 和 SiC 晶片的 SAB,以改善高功率半导体激光器的散热。有限元建模结果表明,直接键合是实现有效散热的首选。在室温下以晶片级制造了直接键合的 GaAs/SiC 结构。SAB 方法有望成为未来高功率激光应用的有用技术。