本文主要分享一篇文章主要是介绍低温状态下利用原子层沉积镀膜技术沉积氧化物等薄膜的文章。小编看到这篇文章的出处后,就理解了前面浦项大学用原子层低温沉积氧化物做到超透镜上面的原因,因为都是一个大学的。本文重点介绍了,实现低温ALD沉积TiO2 Al2O3 ZnO等薄膜的实现细节,适合ALD镀膜工程师等阅读
这个技术有极其重要的应用背景,原子层镀膜 分为 thermal ald 和peald,在一定高温度下进行原子层沉积,膜层的质量会相对较好,但是 在一些半导体比如 超高精度半导体复杂结构加工 ,或者微纳光学纳米压印等,这些应用场景,高温会带来一定的风险。
因此低温 ald沉积就应运而生。
划重点:
我们为客户提供晶圆(硅晶圆,玻璃晶圆,SOI晶圆,GaAs,蓝宝石,碳化硅,金刚石),镀膜方式(PVD,cvd,Ald,PLD)和材料(Au Cu Ag Pt Al Cr Ti Ni Sio2 Tio2 Ti3O5,Ta2O5,AlN,ZnO,TiN,HfO2,ZrO2,SrTaO3,MgF2,MgO,BaTiO3等),光刻,高精度掩模版,外延,掺杂,电子束光刻等产品及加工服务(请找小编领取我们晶圆标品库存列表,为您的科学实验加速。
EBL代工,母版制作,铬版销售,纳米压印,DUV光刻超结构服务,
ALD沉积 Al2O3,Ta2O3 HfO2,ZrO2,SiO2,TiO2,Si3N4,AlN,TaN等材料,TiO2沉积温度低至75摄氏度,8寸晶圆Uniformity1.5以内
优点:超优越的膜厚控制,超优越的保形性
PLD沉积SrTiO3,BaTiO3,MgO
面向头部企业,研究单位等单位的可见光近红外波段超透镜仿真设计(从仿真设计到demo样品,国内前五设计团队,经验丰富,算法超前)
请联系小编免费获取原文,也欢迎交流半导体行业,工艺,技术,市场发展!
我们研究了 Ti02、 AI203和 Zn0 薄膜在室温以下的低温原子层沉积(LT-ALD),主要关注薄膜的生长特性和性能。这里介绍了两种 ALD 沉积系统。最初,对干使用商用 ALD 系统的热 ALD(T-ALD) 工艺,由于体积大且内部复杂,需要长达 300s的很长的吹扫时间才能在室温下完全排空剩余的H20蒸气,商业 ALD 室的结构。为了在短时间内实现 LT-ALD,我们采用了使用02等离子体的等离子体增强 ALD(PE-ALD) 工艺,这使我们能够在低至室温的温度下有效去除残留反应物。作为另一种方法,我们专门设计了一种体积小,内部结构简单的自制ALD系统,从而能够使用T-ALD利用H20以非常短的H20吹扫时间合成Ti02、AI203和ZnO薄膜,甚至在室温下,这表明腔室尺寸和设计是实现,LT-ALD 工艺时间短的关键因素。LT-ALD 工艺通过完全消除配体,生产出高纯度的AI203、 Ti02和 Zn0 薄膜,不含任何C和 N 杂质,并在3维纳米级通孔中表现出优异的共形性。
一、简介
随着现代集成设备的尺寸不断缩小,对生产具有原子厚度可控性的高质量薄膜的沉积技术的需求是巨大的。
在各种薄膜沉积方法中,原子层沉积(ALD)被认为是一种有前途的沉积方法,具有良好的共形性、良好的均匀性、原子级厚度可控性以及即使在低生长条件下杂质污染也低等优点。由于其生长机制受自限表面反应控制,因此温度较低[1,2]。
由于其多种优点,ALD 因其在柔性电子产品(如柔性显示器、可穿戴计算机和便携式太阳能电池)应用中发挥重要作用的潜力而受到广泛关注[3,4]。特别是各种 ALD 氧化物(如 TiO2、 Al203和 ZnO)的低温沉积,
使它们能够应用于基于塑料基板的透明柔性薄膜晶体管的电介质、沟道和 TCO接触层 [3,5,6]。此外,ALD AI203已被用来钝化表面缺陷,充当太阳能电池上优异的电荷复合屏障[7,8]。除了传统的电子设备应用之外,热脆性基材的功能涂层对于 ALD 氧化物(例如 Ti02、 Al203和 Zn0)在不同领域(包括食品包装、光催化剂和生物材料)的新应用变得有趣[9-11],对于所有这些应用,低于 150°C的低生长温度的 ALD 工艺是研究的关键先决条件。
尽管在以前的出版物中可以找到低生长温度下氧化物薄膜的ALD[4,10,12],但据我们所知,仍然没有对各种氧化物薄膜进行全面、系统的研究,尽管他们的潜在重要性。特别是,处理室和沉积方法对短处理时间应用的有效 LT-ALD 的影响Ti02、 Al203和 Zn0 薄膜的低温原子层沉积-Taewook Nam 等人。
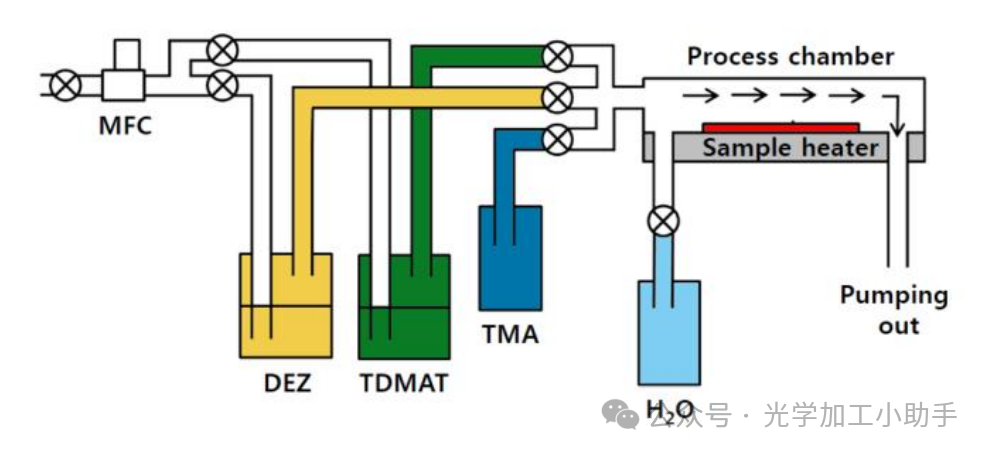
图一(网上彩色)我们家的示意图制作了ALD系统。
电缆行业尚未见报道。所以,全面调查是有价值的各种氧化物薄层的低温原子层沉积(LT-ALD)Ti02、 AI203和 Zn0等薄膜可发挥潜力不同领域的应用。
在这项研究中,我们系统地调查了LT-ALD的生长特性和薄膜特性Ti02、 Al203和 Zn0,主要集中在腔室设计及工艺方法。因此,我们聘请了两种 ALD 系统和沉积方法有效实现LT-ALD工艺。研究了生长特性与关键生长参数的关系,包括生长温度反应物暴露和吹扫时间。此外,LT-ALD TiO2 的结晶度、化学成分和共形性通过使用多种方法对AI203和 Zn0 薄膜进行了检查分析技术。
二.实验细节
在这项工作中,采用了两种 ALD 系统对于 LT-ALD。最初,商业 PE-ALD 室(SNTEK CO,ALD5008)大体积(8晶圆水平)被利用。该系统有一个垂直双喷头系统具有等离子功能,具有良好的均匀性,由折看放置的两部分组成上面的一项用于前体剂量,下面的一项用于反应物暴露。下部淋浴喷头部分是连接到射频(RF)等离子体发生器与匹配网络。因此,基板加热器上的样本直接暴露于反应物脉冲期间产生的等离子体。更多信息相同类型的腔室配置可以在我们之前的出版物[13,14]。另一个系统是我们自己自制的 ALD 室,具有简单的层流气流,专为 LT-ALD 设计。
自制ALD系统示意图为如图1所示。腔室容积较小(80cc)足以防止任何残留反应,即使有非常大的反应吹扫时间短,通过在ALD 过程。这里,四(二甲氨基)钛(TDMAT),三甲基铝(TMA)和二乙基锌(DEZ)用作 ALD TiO2、 Al203和 Zno 的前体:分别。对于热和等离子体增强ALD(分别为T-ALD和 PE-ALD)、H20和O2使用等离子体反应物作为氧化剂。不锈钢中含有的 TD-MAT 和 DEZ 蒸气使用 Ar 载气以 10 sccm 将起泡器输送至反应室;使用质量流量控制器:(MFC)对流量进行精细控制。
将含有 TDMAT 的起泡器加热至 50°C产生足够高的蒸气压,而含 TMA 的起泡器保持在室温(RT)。然而,含有 DEZ 的起泡器被冷却至 0'℃ 以抑制蒸气压。成长温度在不同范围内变化300°C 降至室温。对于 T-ALD,水容器中的H20蒸气直接蒸发并输送至主室没有任何载气。在另-手,对于 PE-ALD,氧气,由 MFC 控制,流入喷头,等离子体在那里仅在02暴露步骤期间以 300 W 的恒定等离子体功率打开。使用椭圆光谱仪测量氧化物薄膜的厚度和折射率。薄膜的形貌和共形性为使用场发射扫描电子显微镜(FE-SEM)观察。薄膜的微观结构为使用 X射线衍射 (XRD)进行分析。通过以下方法分析化学成分和杂质含量使用 X射线光电子能谱(XPS)Al ka 单色源,1486.6 eV。
三.结果与讨论
作为 Ti02和LT-ALD 的初步研究Al203,我们使用了商业 ALD 系统,如上所述多于。图2 显示了每个周期的增长率Ti02和Al203 生长温度的函数。对于这两种情况,在 100 至 200°℃ 的生长温度下都观察到良好的饱和度和线性。这Ti02和Al203的饱和生长速率使用 T-ALD 的电流分别为 1.35 和 1.5 /周期。然而,随着生长温度降低至室温,使用 T-ALD 生长Ti02 的速率突然增加饱和条件下的七倍以上图2(a)。同样,Al203的增长率使用 T-ALD 在低于 100'℃ 的低温下大大增加,与图2(b)中的Ti02 .这些结果表明,足够由于残留的H20,无法保证吹扫时间T-ALD 工艺反应室中的蒸气。对此,豪斯曼等人。报道称H20蒸汽在生长过程中需要很长的吹扫时间温度低于 100°C[15,16]。因此,我们将吹扫时间增加到 300 秒,以完全消除残留的H20蒸气。尽管如此,剩余的H20蒸气导致增长率略高,因为
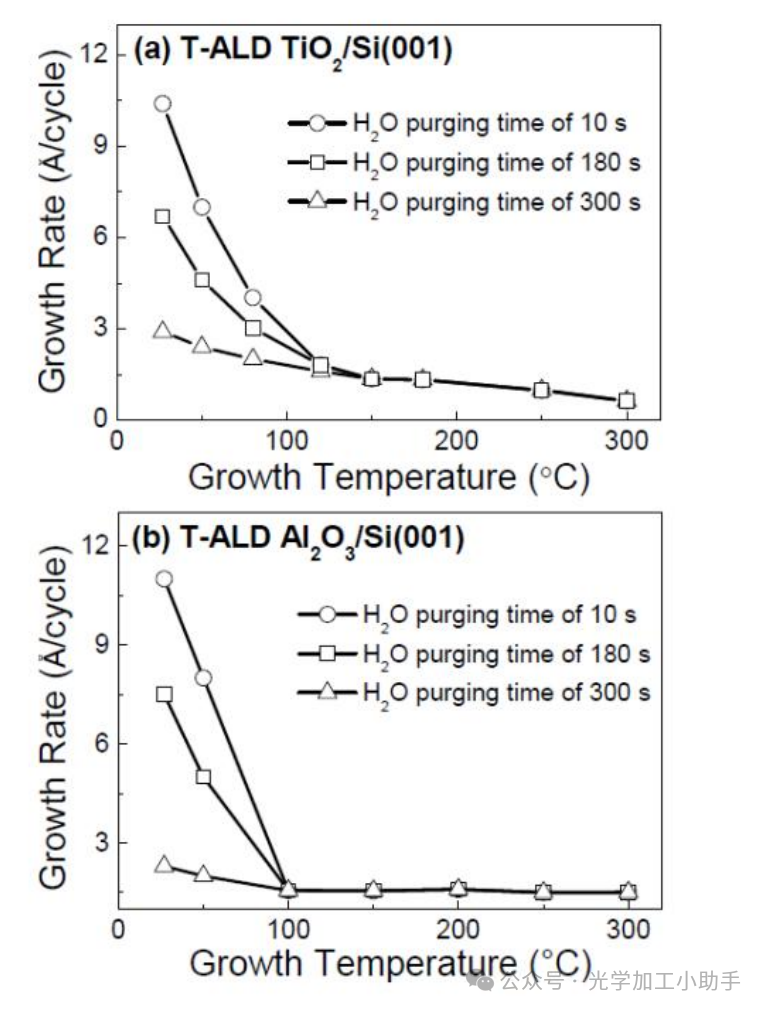
图2.每个周期的增长率作为增长的函数使用 T-ALD 生长(a) Ti02和(b) Al203的温度。
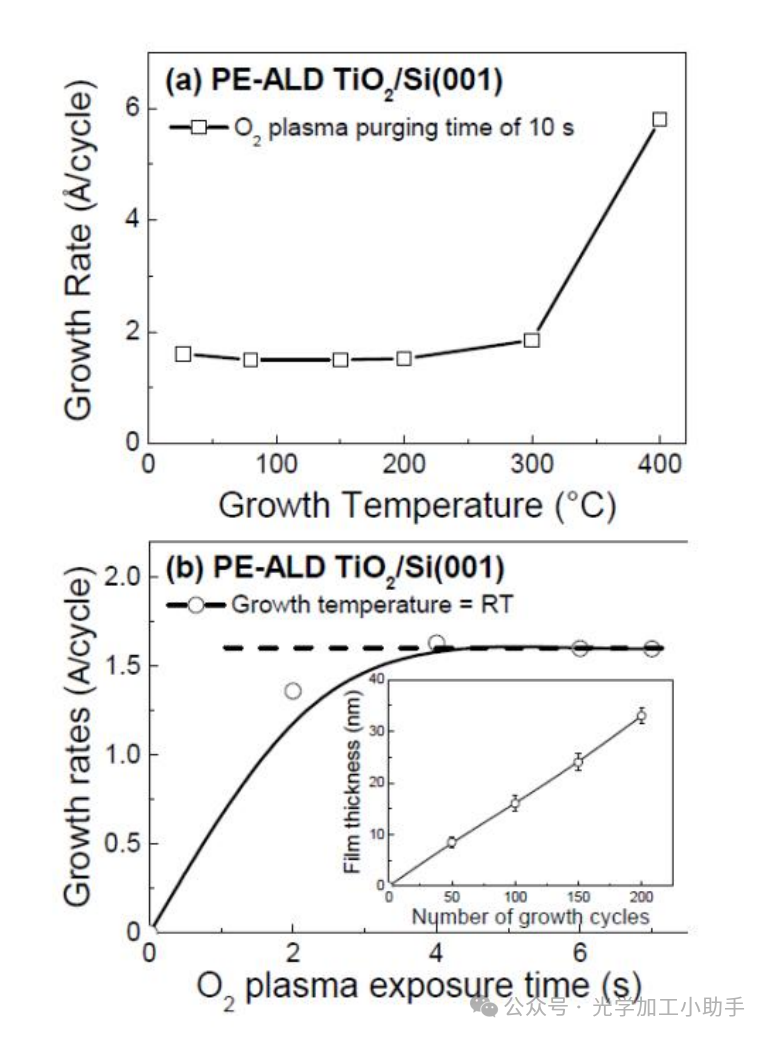
图 3.每个周期的增长率作为(a)生长的函数Ti02的温度和 (b) 02等离子体暴露时间[插图:Ti02薄膜厚度对沉积周期的依赖性]使用 PE-ALD 生长。
类似化学气相沉积(CVD)的反应。据信需要很长的吹扫时间是由于体积大、内部结构复杂商业 ALD 系统。这个问题可以通过使用其他反应来缓解裤子代替水。例如,使用适当的等离子体反应物是一种很好的解决方案。所以,我们使用氧等离子体进行 PE-ALD 工艺具有相同的工艺设备。图3(a)显示了使用 PE-ALD 和O2等离子体,每个周期的生长速率与 Ti02 生长温度的函数关系反应物吹扫时间为10秒。几乎持续增长在 RT 至 300°℃ 的温度范围内观察到 1.5 1.6°A/cycle 的速率,这类似于之前关于使用 PE-ALD 生长 Ti02 的报道[17]。特别值得注意的是,与图2中的T-ALD相比,增长率没有显着增加在低温下观察,即使吹扫时间很短。此外,在图3(b)中,饱和增长即使在RT的生长温度低。对于通过使用生长的A203也观察到类似的生长特征。这表明,与使用水的 T-ALD 相比,当前PE-ALD(数据未显示)的 PE-ALD 工艺具有非常高的反应物净化效率。然而,在一定温度下,生长速度会急剧增加超过300°C,这是由于干扰TDMAT 热分解的自限性前体,导致部分类似 CVD 的生长 [1,18]。同时,我们专门开发了自己的自制ALD系统 ,体积小,内部结构简单结构作为一种有前途的解决方案,使 LT-ALD 甚至与水。图4显示了每个周期的增长率Ti02、 Al203和 Zn0 通过使用 T-ALD 在低 RT 生长温度下生长,作为吹扫时间的函数。虽然 Zn0 的生长速率几乎恒定吹扫时间超过 10 秒,Ti02 的吹扫时间Al203足以满足 ALD 生长模式超过6秒。这表明我们的迷你 ALD 室与上面的商会有效相比即使用很短的时间也能排出残留的水蒸气吹扫时间。在这种条件下,增长饱和三个 ALD 过程出现了一些特征。它值得注意的是,腔室的尺寸和设计是实现短工艺时间的基于 H20 的 LT-ALD的关键因素。
在目前的ALD条件下,增长率针对 Ti02、 Al203和 ZnO ,在从 RT 到 200'℃ 的不同生长温度下研究了每个周期的利用T-ALD生长,如图5所示。
使用 T-ALD 轻微生长Al203和 Zn0的速率随着生长温度降低至室温而降低。事实上,在大多数情况下,增长率会随着将生长温度降低至低生长温度。这主要是因为前驱体吸附或前体与表面物质之间的反应是一种热激活过程[1]。此前,其他地方也报道过类似的趋势[4,10]。上另一方面 ,使用 T-ALD 生长的 Ti02 生长速率在低温下略有增加至 RT。这似乎与浓度有关表面 OH 基团。表面OH基团变成
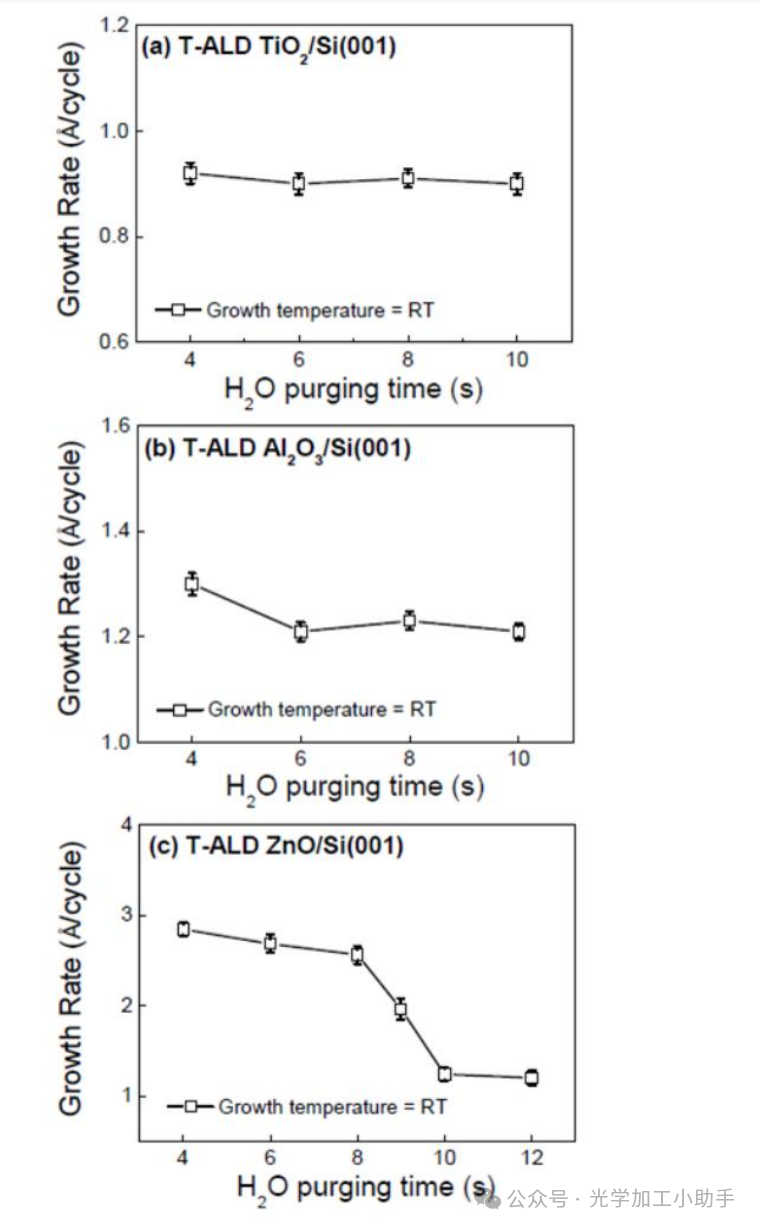
图 4.使用 T-ALD 生长的(a) Ti02、(b)Al203和(c)Zn0 的每个循环的生长速率与H20净化时间的关系。
随着生长温度的降低,活性位点增多,从而导致在低生长温度下生长速率略高[19,20]。此外,谢等人。报道了类似的结果,在低温下表现出高生长率[12]。根据他们基于密度泛函理论计算的能量模型,低温下每个循环的增长率由反应能垒决定。
最初吸附的 TDMAT 前体在室温下容易与H20发生高反应,这意味着即使在非常低的温度下,能量势垒也足够小,足以取代配体,从而诱导高生长速率。尽管两者之间的反应活性随着生长温度的升高而增加,但在这种情况下,中间产物的解吸以及表面OH基团的减少变得更加严重因此,生长温度的进一步升高会导致生长速率略有下降。因此,我们发现,在低生长温度下,沉积特性存在差异,具体取决于前体配体(烷基酰胺或烷基)。

图 5.使用 T-ALD 生长的(a) Ti02、(b) Al203和(c) Zno 的每个周期的生长速率与生长温度的函数关系。

图 6.(a) 80'C 和(b) 使用 T-ALD 在室温下进行。
使用 XRD 检查了使用 T-ALD 在室温下生长的Ti02、 Al203和Zno 薄膜的结晶度。此处,Ti02和AI203薄膜显示出不存在任何显着的衍射特征,表明其具有类非晶结构(数据未显示),这与之前的报道非常吻合[10,21]。与两者相比如图。7.(a) Ti02(Ti2p、01s 和 N)的 XPS 光谱1s)和(b)Al203(Al2p、0 1s 和 C 1s)在室温下生长使用 T-ALD 测量温度。
Zno 薄膜有很强的生长趋势垂直于 Si(001)的c轴晶格取向即使在低至 RT 的极低温度下也可作为基材如图 6所示。换句话说,Zn0 薄膜使用 LT-ALD在低于 100'℃ 的温度下生长表现出(002)面的单相,识别出六方纤锌矿结构。此前,氧化锌
使用 LT-ALD 在低至 100°C的温度下生长表现出晶体衍射图案,取决于沉积温度和其他工艺参数例如脉冲和吹扫时间[4]。通过考虑半高全宽(FWHM)值,我们使用 Scherrer 公式计算了两个样品的平均微晶尺寸(D):D=0.9λ/Bcos0其中入是X射线波长(CuKa=1.54 A),并且B和θ是 FWHM 和衍射角(002)峰值分别。估计沿c轴的平均晶粒尺寸约为 27 nm,这不是
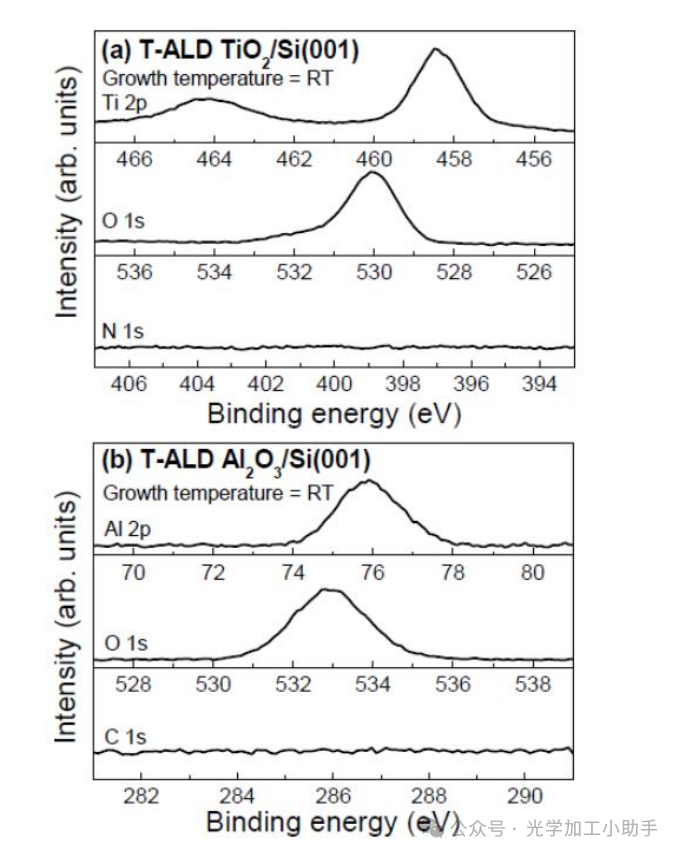
至少在温度范围内发生了显着变化低于 100'C。为了检验其化学成分和杂质水平,我们使用 XPS 来分析 30 nm 厚的室温下生长的TiO2和Al203薄膜,如图7 所示。Ti 2p3/2 (458.5 eV,两个峰之间的自旋轨道分裂:5.7 eV) 和 O1s(530.1 ev)的峰位置图7(a)中的结果与XPS手册和以前的出版物中的一致[22,23]。无 N 信号在 Ti02薄膜中观察到,表明 TDMAT 前驱体中的 Ti-N 键完全断裂。此外Al2p(75.8 eV)和 O 1s(532.7 ev)的结合能eV)在图7 (b)与之前重新匹配很好
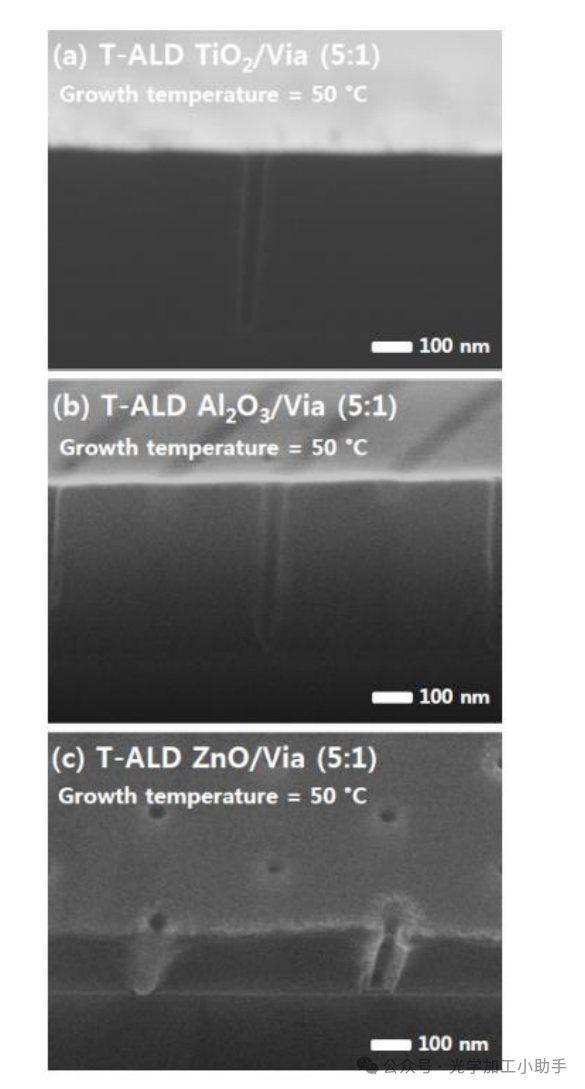
图 8.(a) Ti02、(b)的截面 FE-SEM 图像Al203和(c)Zno 在 50°C 下以纳米级接触生长纵横比为 5:1 的过孔(深度为 450 nm,直径90 nm)通过使用T-ALD。移植值[24]。表面经溅射清洗后,AI203薄膜中没有检测到C信号,这表明碳浓度至少低于XPS 的检测限。因此,当前的 LT-ALD 工艺可生产非常高纯度的薄膜,而无需任何杂质污染。
图8显示了截面 FE-SEM 图像50°C 下生长的纳米级Ti02、 Al203和 Zn0 薄膜深宽比为 5:1 的接触孔过孔(深度450 nm 和直径 90 nm)通过使用 T-ALD。所有三个都实现了超过 90% 的出色保形性氧化膜。因此,目前的LT-ALD设想适用于功能性涂层,以及未来具有三维复合体的电子器件结构。
四.结论
在这项研究中,我们系统地调查了Ti02的生长特性和薄膜特性,采用 LT-ALD 两种方法生长的Al203和 ZnOALD 系统和沉积方法。T-ALD 工艺使用商业化生长 Ti02和AI203ALD 室需要很长的H20吹扫时间长达 300 秒以避免在生长温度低于 100°℃ 时发生类似 CVD 的反应,这是由于大ALD的体积和复杂的内部结构